Downstream Electric Field Effects during Film Deposition with a Radio Frequency Plasma and Observations of Carbon Reduction
Abstract
1. Introduction
2. Materials and Methods
3. Results
3.1. Gallium-Rich Film Growth Experiments
3.2. Less Gallium-Rich Film Growth Experiments
3.3. Stoichiometric GaN Film Growth
4. Discussion
- (1)
- New precursors have been developed with lower decomposition temperatures and/or with no direct hydrocarbon bonds to the metal cation species [51].
- (2)
- Prolonged plasma exposure can be used to reduce the concentration of hydrocarbons and carbon species. This can be effective to a point, though plasma etching of the main material being deposited may also result if plasma exposure occurs for too long. Often, multiple processes are present in a plasma, involving UV light emission, ions and various radical reactions, so these processes can be quite complicated. Because of the complexity of these processes, results are best obtained by empirical experimentation, though the complete removal of carbon-based species is rarely obtained by these means alone; more often, plasma exposure with a reactive species is more effective (method 5, below). For plasma by itself, the work of Knoops et al. [39] is indicative of the effectiveness of this process. For silicon nitride, they saw a reduction in carbon from about 20% to about 7% when increasing plasma exposure time from 1 to 15 s (see their Figure 4).
- (3)
- In a variation of method 2, Shih et al. [52] used an argon ion bombardment to remove hydrogen and hydrocarbons during the PEALD of AlN, resulting in the growth of high-quality epitaxial material.
- (4)
- (5)
- Hydrogen or ammonia, and in some cases, oxygen-bearing species, are sometimes used to reduce metalorganics used during deposition. For instance, Deminskyi et al. [53] recently reported the use of an ammonia plasma to decrease the carbon content for InN grown by ALD. However, at very low temperatures, hydrogen retention can be problematic when using hydrogen or ammonia. Butcher et al. [45] found that AlN and Al grown by laser induced CVD and RPECVD at near-room temperature retained so much hydrogen when using hydrogen or ammonia gas that the films were pyrophoric when exposed to air. Semiconductor doping can also become difficult if too much hydrogen is present in the lattice. P-type doping of GaN with Mg often requires a rapid thermal anneal step to remove hydrogen and activate the dopants [54]; however, this can only be achieved if the hydrogen content of the films is low to begin with.
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Pearton, S.J.; Zolper, J.C.; Shul, R.J.; Ren, F. GaN: Processing, defects, and devices. J. Appl. Phys. 1999, 86, 1–78. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Afifuddin; Chen, P.P.-T.; Godlewski, M.; Szcerbakow, A.; Goldys, E.M.; Tansley, T.L.; Freitas, J.A., Jr. Recrystallization prospects for freestanding low-temperature GaN grown using ZnO buffer layers. J. Crystal Growth 2002, 246, 237–243. [Google Scholar] [CrossRef]
- Lawrence, D.J.; Eastman, L.F. Electric current controlled liquid phase epitaxy of GaAs on N+ and semi-insulating substrates. J. Electron. Mat. 1977, 6, 1–24. [Google Scholar] [CrossRef]
- Jastrzebski, L.; Lagowski, J.; Gatos, H.C.; Witt, A.F. Liquid-phase electroepitaxy: Growth kinetics. J. Appl. Phys. 1978, 49, 5909–5919. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Terziyska, P.T.; Gergova, R.; Georgiev, V.; Georgieva, D.; Binsted, P.W.; Skerget, S. DC voltage fields generated by RF plasmas and their influence on film growth morphology through static attraction to metal wetting layers: Beyond ion bombardment effects. J. Appl. Phys. 2017, 121, 013301. [Google Scholar] [CrossRef]
- Li, S.Q.; Liang, Y.X.; Guo, T.L.; Lin, Z.X.; Wang, T.H. Synthesis of vertically electric-field-aligned In2O3 nanowires. Mater. Lett. 2006, 60, 1492–1495. [Google Scholar] [CrossRef]
- Nozaki, T.; Okazaki, K. Carbon Nanotube Synthesis in Atmospheric Pressure Glow Discharge: A Review. Plasma Process. Polym. 2008, 5, 300–321. [Google Scholar] [CrossRef]
- Bower, C.; Zhu, W.; Jin, S.; Zhou, O. Plasma-induced alignment of carbon nanotubes. Appl. Phys. Lett. 2000, 77, 830–832. [Google Scholar] [CrossRef]
- Gosh, S.; Polaki, S.R.; Kamruddin, M.; Jeong, S.M.; Ostrikov, K. Plasma-electric field controlled growth of oriented graphene for energy storage applications. J. Phys. D Appl. Phys. 2018, 51, 145303. [Google Scholar] [CrossRef]
- Qi, Y.; Deng, B.; Guo, X.; Chen, S.; Gao, J.; Li, T.; Dou, Z.; Ci, H.; Sun, J.; Chen, Z.; et al. Switching Vertical to Horizontal Graphene Growth Using Faraday Cage-Assisted PECVD Approach for High-Performance Transparent Heating Device. Adv. Mater. 2018, 30, 1704839. [Google Scholar] [CrossRef]
- Terziyska, P.T.; Butcher, K.S.A.; Alexandrov, D. Investigation of the presence of metal droplets after pulsed InN and GaN epitaxial growth using atomic force microscopy and nanoindentation. Appl. Surf. Sci. 2012, 258, 9997–10001. [Google Scholar] [CrossRef]
- Terziyska, P.T.; Butcher, K.S.A.; Gogova, D.; Alexandrov, D.; Binsted, P.; Wu, G. InN nanopillars grown from In-rich conditions by migration enhanced afterglow technique. Mater. Lett. 2013, 106, 155–157. [Google Scholar] [CrossRef]
- Terziyska, P.T.; Butcher, K.S.A.; Rafailov, P.; Alexandrov, D. Growth of vertically oriented InN nanorods from In-rich conditions on unintentionally patterned sapphire substrates. Appl. Surf. Sci. 2015, 353, 103–105. [Google Scholar] [CrossRef]
- Terziyska, P.T.; Butcher, K.S.A. Self-Catalytic Growth of InN Nanowires. Bulg. J. Phys. 2016, 43, 54–63. Available online: http://www.bjp-bg.com/paper1.php?id=801 (accessed on 6 October 2022).
- Butcher, K.S.A.; Alexandrov, D.; Terziyska, P.; Georgiev, V.; Georgieva, D.; Binsted, P.W. InN grown by migration enhanced afterglow (MEAglow). Phys. Status Solidi A 2012, 209, 41–44. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Alexandrov, D.; Terziyska, P.; Georgiev, V.; Georgieva, D. Initial Experiments in the Migration Enhanced Afterglow Growth of Gallium and Indium Nitride. Phys. Status Solidi C 2012, 9, 1070–1073. [Google Scholar] [CrossRef]
- Binsted, P.W.; Butcher, K.S.A.; Alexandrov, D.; Terziyska, P.; Georgieva, D.; Gergova, R.; Georgiev, V. InN on GaN Heterostructure Growth by Migration Enhanced Epitaxial Afterglow (MEAglow). Mat. Res. Soc. Sym. Proc. 2012, 1396, 255–260. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Kemp, B.W.; Hristov, I.B.; Terziyska, P.; Binsted, P.W.; Alexandrov, D. Gallium Nitride Film Growth Using a Plasma Based Migration Enhanced Afterglow Chemical Vapor Deposition System. Jpn. J. Appl. Phys. 2012, 51, 01AF02. [Google Scholar] [CrossRef]
- Tran, N.H.; Le, B.H.; Fan, S.; Zhao, S.; Mi, Z.; Schmidt, B.A.; Savard, M.; Gervais, G.; Butcher, K.S.A. Optical and structural characterization of nitrogen-rich InN: Transition from nearly intrinsic to strongly n-type degenerate with temperature. Appl. Phys. Lett. 2013, 103, 262101. [Google Scholar] [CrossRef]
- Gergova, R.; Butcher, K.S.A.; Binstead, P.W.; Gogova, D. Initial results for epitaxial growth of InN on gallium oxide and improved Migration-Enhanced Afterglow Epitaxy growth on gallium nitride. J. Vac. Sci. Technol. B 2014, 32, 031207. [Google Scholar] [CrossRef]
- Togtema, G.; Georgiev, V.; Georgieva, D.; Gergova, R.; Butcher, K.S.A.; Alexandrov, D. GaN–InGaN LED efficiency reduction from parasitic electron currents in p-GaN. Solidi State Electron. 2015, 103, 44–48. [Google Scholar] [CrossRef]
- Ozgit-Akgun, C.; Goldenberg, E.; Okyay, A.K.; Biyikli, N. Hollow cathode plasma-assisted atomic layer deposition of crystalline AlN, GaN and AlxGa1−xN thin films at low temperatures. J. Mater. Chem. 2014, 2, 2123–2136. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Georgiev, V.; Georgieva, D. Recent Advances in Hollow Cathode Technology for Plasma-Enhanced ALD—Plasma Surface Modifications for Aluminum and Stainless-Steel Cathodes. Coatings 2021, 11, 1506. [Google Scholar] [CrossRef]
- Boris, D.R.; Wheeler, V.D.; Nepal, N.; Qadri, S.B.; Walton, S.G.; Eddy, C.R. The role of plasma in plasma-enhanced atomic layer deposition of crystalline films. J. Vac. Sci. Technol. A 2020, 38, 040801. [Google Scholar] [CrossRef]
- Boris, D.R.; Johnson, M.J.; Eddy, C.R.; Walton, S.G. Hollow cathode enhanced capacitively coupled plasmas in Ar/N2/H2 mixtures and implications for plasma enhanced ALD. J. Vac. Sci. Technol. B 2022, 40, 044002. [Google Scholar] [CrossRef]
- Boris, D.R.; Johnson, M.J.; Eddy, C.R.; Walton, S.G. Erratum: ‘‘Hollow cathode enhanced capacitively coupled plasmas in Ar/N2/H2 mixtures and implications for plasma enhanced ALD” [J. Vac. Sci. Technol. B 40, 044002 (2022)]. J. Vac. Sci. Technol. B 2022, 40, 057001. [Google Scholar] [CrossRef]
- Kim, J.-H.; Shin, Y.-H.; Chung, K.-H. Study on self-bias voltage induced on the substrate by r.f. bias power in a high-density plasma. Thin Solid Films 2003, 435, 288–292. [Google Scholar] [CrossRef]
- Mohammad, A.; Shukla, D.; Ilhom, S.; Willis, B.; Johs, B.; Kemal Okyay, A.; Biyikli, N. Real-time in situ ellipsometric monitoring of aluminum nitride film growth via hollow-cathode plasma-assisted atomic layer deposition. J. Vac. Sci. Technol. A 2019, 37, 020927. [Google Scholar] [CrossRef]
- Cui, J.; Sun, A.; Reshichkov, M.; Yun, F.; Baski, A.; Morkoç, H. Preparation of Sapphire for High Quality III-Nitride Growth. MRS Internet. J. Nitride Semicond. Res. 2000, 5, e7. [Google Scholar] [CrossRef]
- Morkoc, H. Handbook of Nitride Semiconductors and Devices, Volume 1: Materials Properties, Physics and Growth; Wiley-VCH Verlag Gmbh & Co.: Weinheim, Germany, 2008; pp. 346–350. [Google Scholar]
- Zatsepin, D.A.; Boukhvalov, D.W.; Buntov, E.A.; Zatsepin, A.F.; Batalov, R.I.; Novikov, H.A.; Bayazitov, R.M. Effect of pulsed ion-beam treatment on the electronic and optical properties of GaN epitaxial films on sapphire. Appl. Surf. Sci. 2020, 590, 153023. [Google Scholar] [CrossRef]
- Trybus, E.; Doolittle, W.A.; Moseley, M.; Henderson, W.; Billingsely, D.; Namkoong, G.; Look, D.C. Extremely high hole concentrations in c-plane GaN. Phys. Status Solidi C 2009, 6, S788–S791. [Google Scholar] [CrossRef]
- MacKenzie, J.D.; Abemathy, C.R.; Stewart, J.D.; Muhr, G.T. Growth of Group III nitrides by chemical beam epitaxy. J. Cryst. Growth 1996, 164, 143–148. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Timmers, H.; Afifuddin Chen, P.P.-T.; Weijers, T.D.M.; Goldys, E.M.; Tansley, T.L.; Elliman, R.G.; Freitas, J.A., Jr. Crystal size and oxygen segregation for polycrystalline GaN. J. Appl. Phys. 2002, 92, 3397–3403. [Google Scholar] [CrossRef]
- Burnham, S.D.; Henderson, W.; Doolittle, W.A. Closed-loop MBE growth of droplet-free GaN with very metal rich conditions using Metal Modulated Epitaxy with Mg and In. Phys. Status Solidi C 2008, 5, 1855–1858. [Google Scholar] [CrossRef]
- Eddy, C.R., Jr.; Neepal, N.; Hite, J.K.; Maestro, M.A. Perspectives on future directions in III-N semiconductor research. J. Vac. Sci. Technol. A 2013, 31, 058501. [Google Scholar] [CrossRef]
- Musschoot, J.; Xie, Q.; Deduytsche, D.; Van den Berghe, S.; Van Meirhaeghe, R.L.; Detavernier, C. Atomic layer deposition of titanium nitride from TDMAT precursor. Microelectron. Eng. 2009, 86, 72–77. [Google Scholar] [CrossRef]
- Burke, M.; Blake, A.; Povey, I.M.; Schmidt, M.; Petkov, N.; Carolan, P.; Quinn, A.J. Low sheet resistance titanium nitride films by low-temperature plasma-enhanced atomic layer deposition using design of experiments methodology. J. Vac. Sci. Technol. A 2014, 32, 031506. [Google Scholar] [CrossRef]
- Knoops, H.C.M.; Braeken, E.M.J.; de Peuter, K.; Potts, S.E.; Haukka, S.; Pore, V.; Kessels, W.M.M. Atomic Layer Deposition of Silicon Nitride from Bis(tert-butylamino)silane and N2 Plasma. ACS Appl. Mater. Interfaces 2015, 7, 19857–19862. [Google Scholar] [CrossRef]
- Gordon, P.G.; Kurek, A.; Barry, S.T. Trends in Copper Precursor Development for CVD and ALD Applications. ECS J. Solidi State Sci. Technol. 2015, 4, N3188–N3917. Available online: https://iopscience.iop.org/article/10.1149/2.0261501jss (accessed on 6 October 2022). [CrossRef]
- Lee, Y.J.; Kang, S.-W. Atomic Layer Deposition of Aluminum Thin Films Using an Alternating Supply of Trimethylaluminum and a Hydrogen Plasma. Electrochem. Sol. State Lett. 2002, 5, C91–C93. Available online: https://iopscience.iop.org/article/10.1149/1.1503204 (accessed on 6 October 2022). [CrossRef]
- Jin, H.S.; Kim, D.H.; Kim, S.K.; Wallace, R.M.; Kim, J.; Park, T.J. Strategic Selection of the Oxygen Source for Low Temperature-Atomic Layer Deposition of Al2O3 Thin Film. Adv. Electron. Mater. 2019, 5, 1800680. [Google Scholar] [CrossRef]
- Leskela, M.; Mattinen, M.; Ritala, M. Review Article: Atomic layer deposition of optoelectronic materials. J. Vac. Sci. Technol. B 2019, 37, 030801. [Google Scholar] [CrossRef]
- Knoops, H.C.M.; Faraz, T.; Arts, K.; Kessels, W.M.M. Status and prospects of plasma-assisted atomic layer deposition. J. Vac. Sci. Technol. A 2019, 37, 030902. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Tansley, T.L.; Li, X.; Zhou, B. Photolytic Absorbate Removal During the Growth of Aluminum Nitride by Remote Microwave Plasma Chemical Vapour Deposition. Sol. State Electron. 1997, 41, 305–314. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Tansley, T.L. Ultrahigh resistivity aluminum nitride grown on mercury cadmium telluride. J. Appl. Phys. 2001, 90, 6217. [Google Scholar] [CrossRef]
- Butcher, K.S.A.; Tansley, T.L.; Prince, K.; Leech, P.W. Predeposition ultraviolet treatment for adhesion improvement of thin films on mercury cadmium telluride. J. Vac. Sci. Technol. A 2001, 19, 90–96. [Google Scholar] [CrossRef]
- Meikle, S.; Nomura, H.; Nakanishi, Y.; Hatanaka, Y. Reactions of atomic nitrogen and trimethyl aluminum downstream from a nitrogen microwave plasma. J. Appl. Phys. 1990, 67, 483–486. [Google Scholar] [CrossRef]
- Sone, S.; Kim, M.H.; Kim, H.J.; Yoon, E. Effects of hydrogen on carbon incorporation in GaN grown by remote plasma-enhanced metal-organic chemical vapor deposition. J. Crystal Growth 1998, 189–190, 321–324. [Google Scholar] [CrossRef]
- Danielsson, O.; Li, X.; Ojamae, L.; Janzen, E.; Pedersen, H.; Forsberg, U. A model for carbon incorporation from trimethyl gallium in chemical vapor deposition of gallium nitride. J. Mater. Chem. C 2016, 4, 863–871. [Google Scholar] [CrossRef]
- Rouf, P.; Samii, R.; Rönnby, K.; Bakhit, B.; Buttera, S.C.; Martinovic, I.; Ojamäe, L.; Hsu, C.-W.; Palisaitis, J.; Kessler, V.; et al. Hexacoordinated Gallium(III) Triazenide Precursor for Epitaxial Gallium Nitride by Atomic Layer Deposition. Chem. Mater. 2021, 33, 3266–3275. [Google Scholar] [CrossRef]
- Shih, H.-Y.; Lee, W.-H.; Kao, W.-C.; Chuang, Y.-C.; Lin, R.-M.; Lin, H.-C.; Shiojiri, M.; Chen, M.-J. Low-temperature atomic layer epitaxy of AlN ultrathin films by layer-by-layer, in-situ atomic layer annealing. Sci. Rep. 2017, 7, 39717. [Google Scholar] [CrossRef] [PubMed]
- Deminskyi, P.; Rouf, P.; Ivanov, I.G.; Pedersen, H. Atomic layer deposition of InN using trimethylindium and ammonia plasma. J. Vac. Sci. Technol. A 2019, 37, 020926. [Google Scholar] [CrossRef]
- Gotz, W.; Johnson, N.M.; Walker, J.; Bour, D.P.; Street, R.A. Activation of acceptors in Mg-doped GaN grown by metalorganic chemical vapor deposition. Appl. Phys. Lett. 1996, 68, 667–669. [Google Scholar] [CrossRef]
- Blant, A.V.; Novikov, S.V.; Cheng, T.S.; Flannery, L.B.; Harrison, I.; Campion, R.P.; Korakakis, D.; Larkins, E.C.; Kribes, Y.; Foxon, C.T. Ga-metal inclusions in GaN grown on sapphire. J. Crystal Growth 1999, 203, 349–354. [Google Scholar] [CrossRef]
- Kim, Y.; Shapiro, N.A.; Feick, H.; Armitage, R.; Weber, E.R.; Yang, Y.; Cerrina, F. Elastic strain relief in nitridated Ga metal buffer layers for epitaxial GaN growth. Appl. Phys. Lett. 2001, 78, 895–897. [Google Scholar] [CrossRef]
- Kim, Y.; Subramanya, S.G.; Siegle, H.; Kruger, J.; Perlin, P.; Weber, E.R.; Ruvimov, S.; Liliental-Weber, Z. GaN thin films by growth on Ga-rich GaN buffer layers. J. Appl. Phys. 2000, 88, 6032–6036. [Google Scholar] [CrossRef]
- Lam, H.-T.; Vohs, J.M. Surface reactions of trimethylgallium on MOVPE-grown GaN(0001). Surf. Sci. 1999, 426, 199–211. [Google Scholar] [CrossRef]
- Aquino, A.A.; Hill, J.J.; Jones, T.S. Evidence for a surface methylene species in the decomposition of trimethylgallium on GaAs(100)-(4 × 1): A high resolution electron energy loss spectroscopy study. Surf. Sci. 1995, 327, 74–80. [Google Scholar] [CrossRef]
- Bahlawane, N.; Reilmann, F.; Salameh, L.-C.; Kohse-Höinghaus, K. Mass-spectrometric monitoring of the thermally induced decomposition of trimethylgallium, tris(tert-butyl)gallium, and triethylantimony at low pressure conditions. J. Am. Soc. Mass. Spectrum 2008, 19, 947–954. [Google Scholar] [CrossRef][Green Version]
- Van de Walle, C.G.; Neugebauer, J. First-principles calculations for defects and impurities: Applications to III-nitrides. J. Appl. Phys. 2004, 95, 3851–3879. [Google Scholar] [CrossRef]
- Tang, H.; Fang, Z.Q.; Rolfe, S.; Bardwell, J.A.; Raymond, S. Growth kinetics and electronic properties of unintentionally doped semi-insulating GaN on SiC and high-resistivity GaN on sapphire grown by ammonia molecular-beam epitaxy. J. Appl. Phys. 2010, 107, 103701. [Google Scholar] [CrossRef]
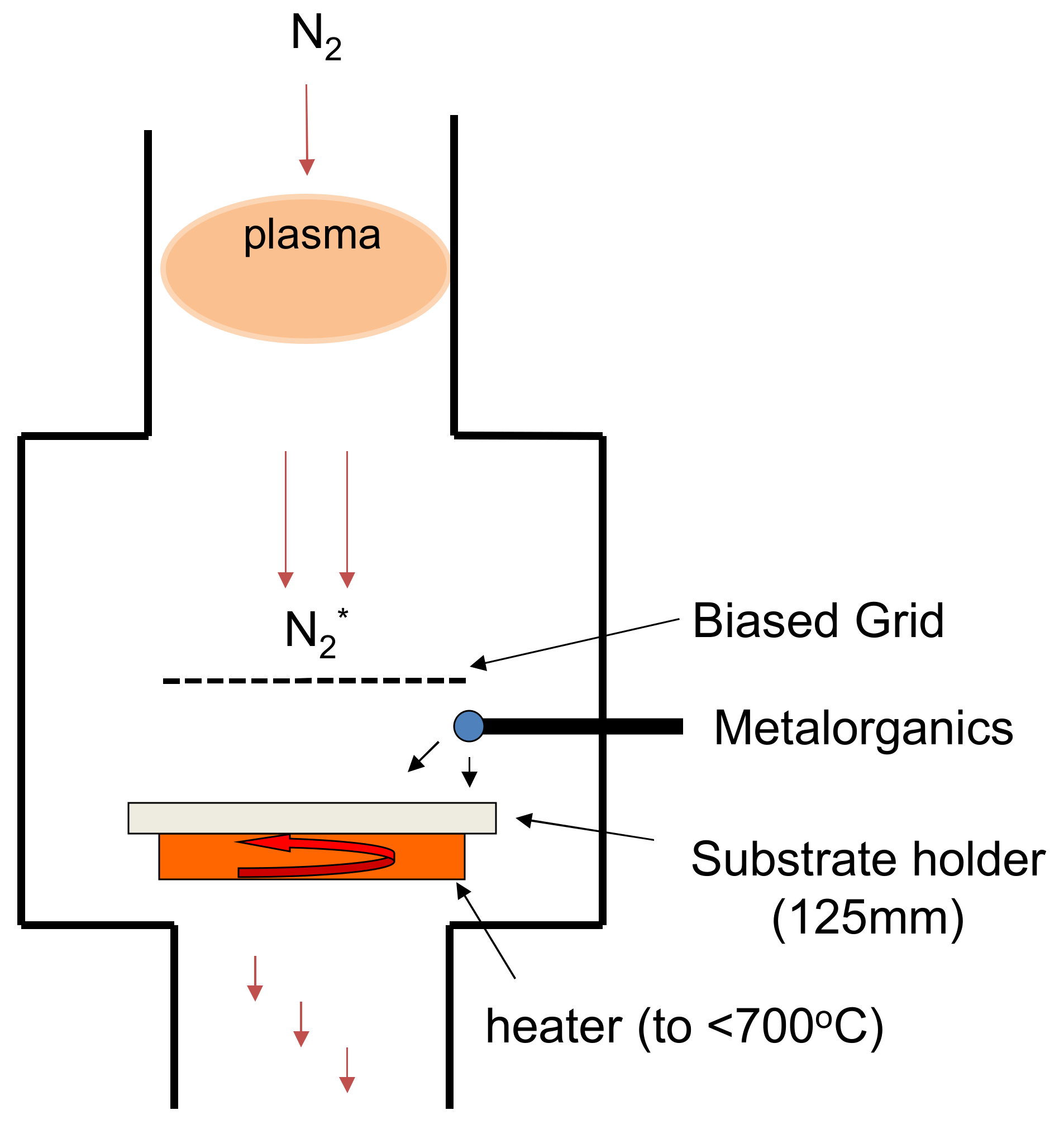

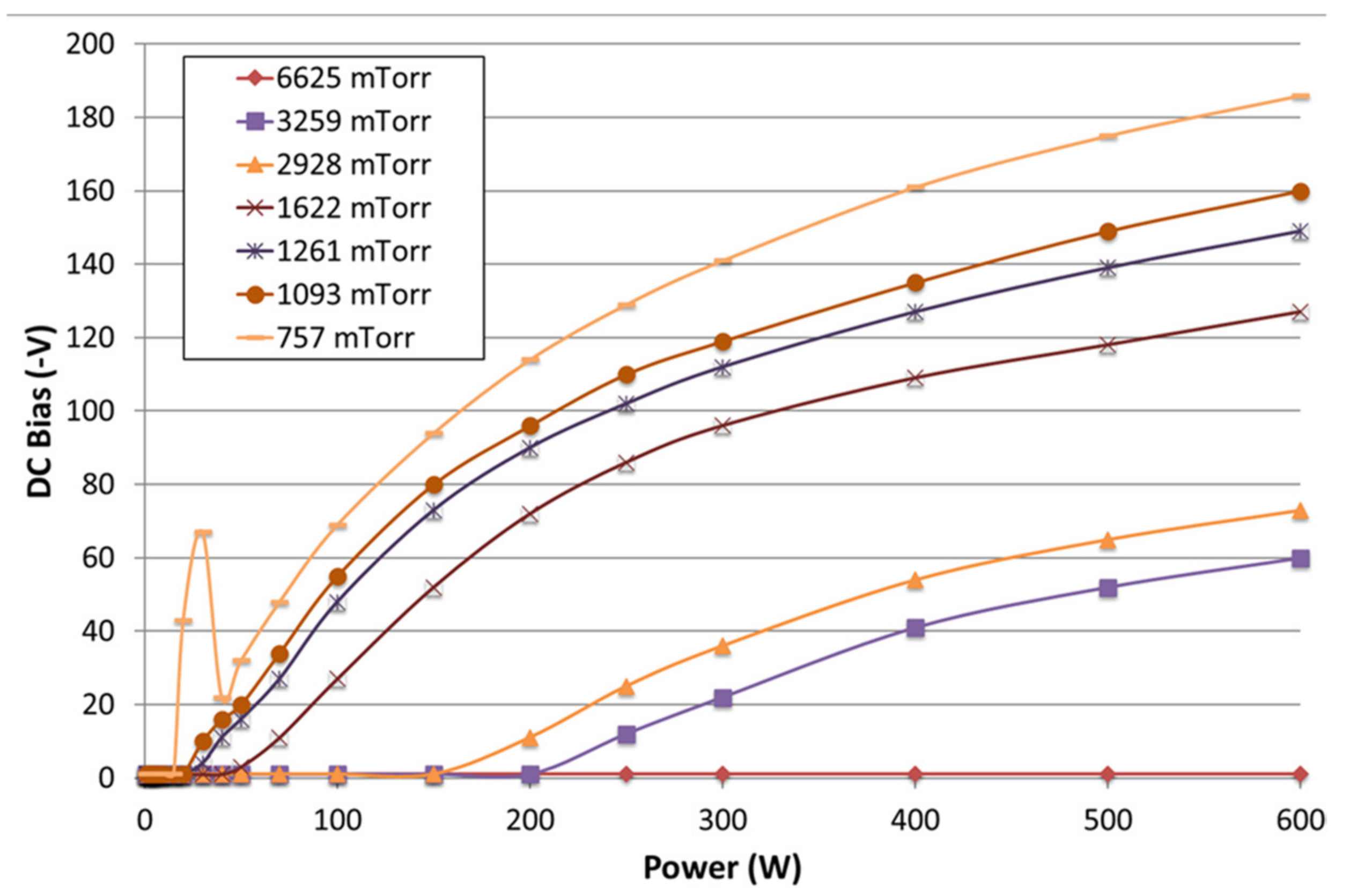

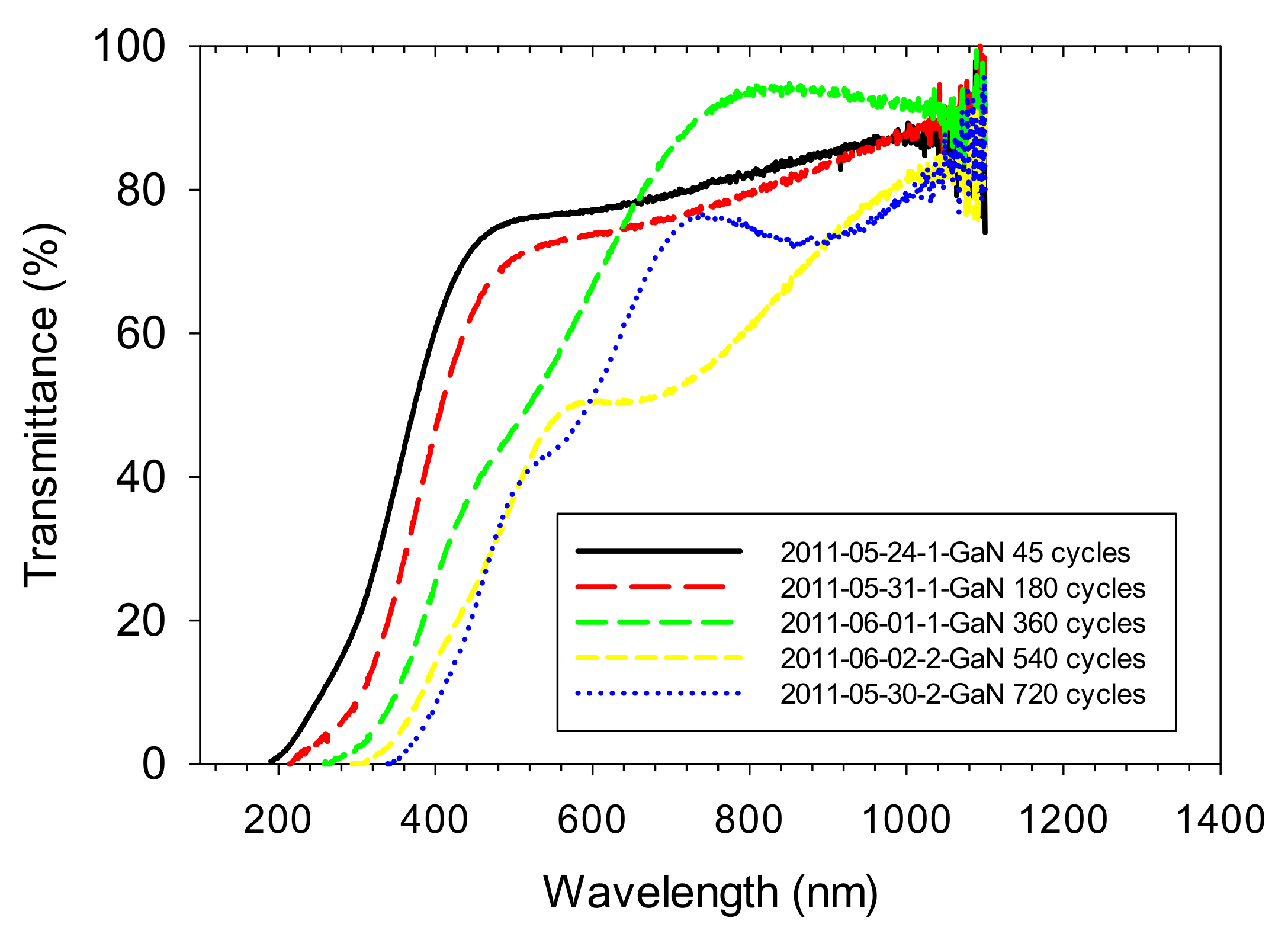


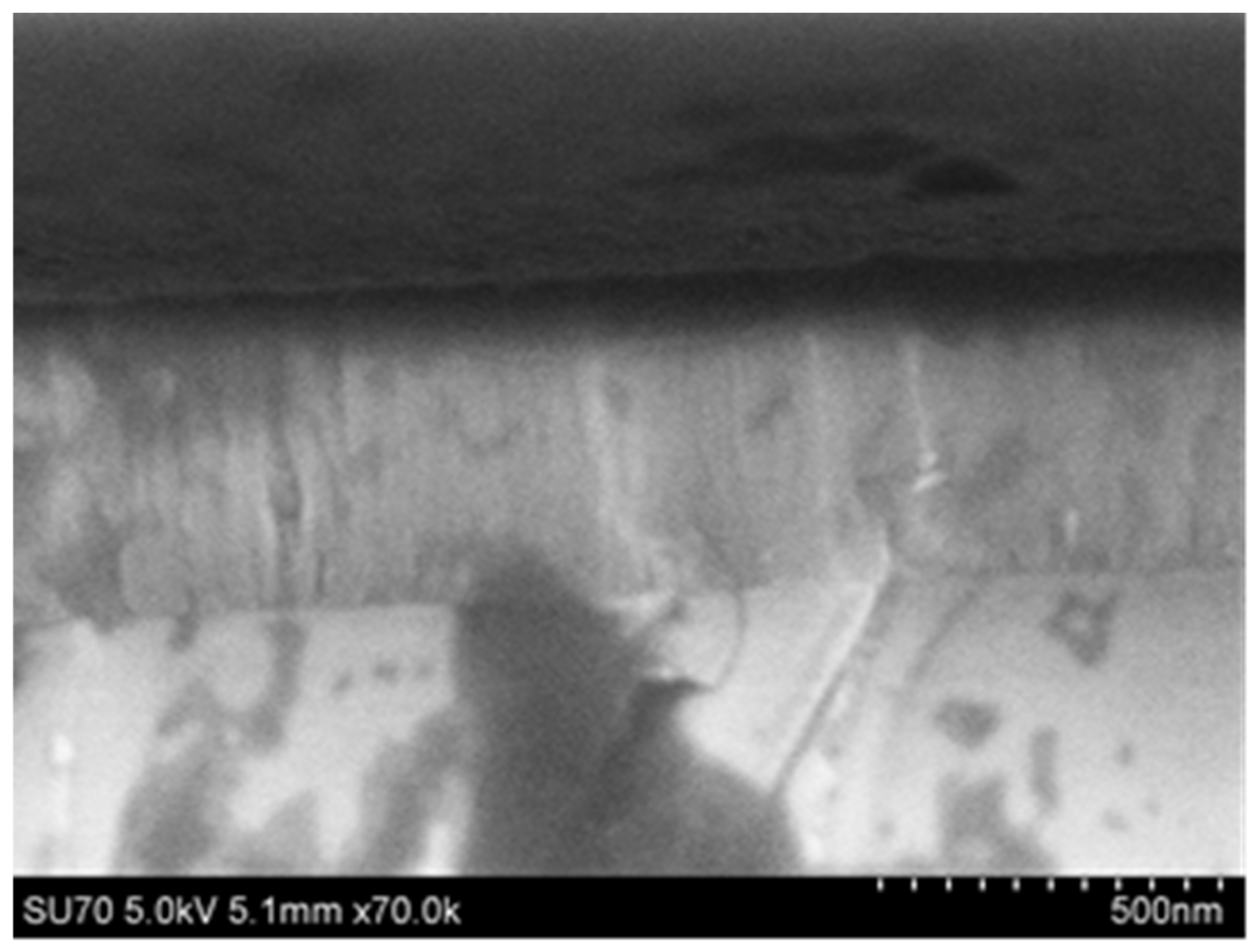

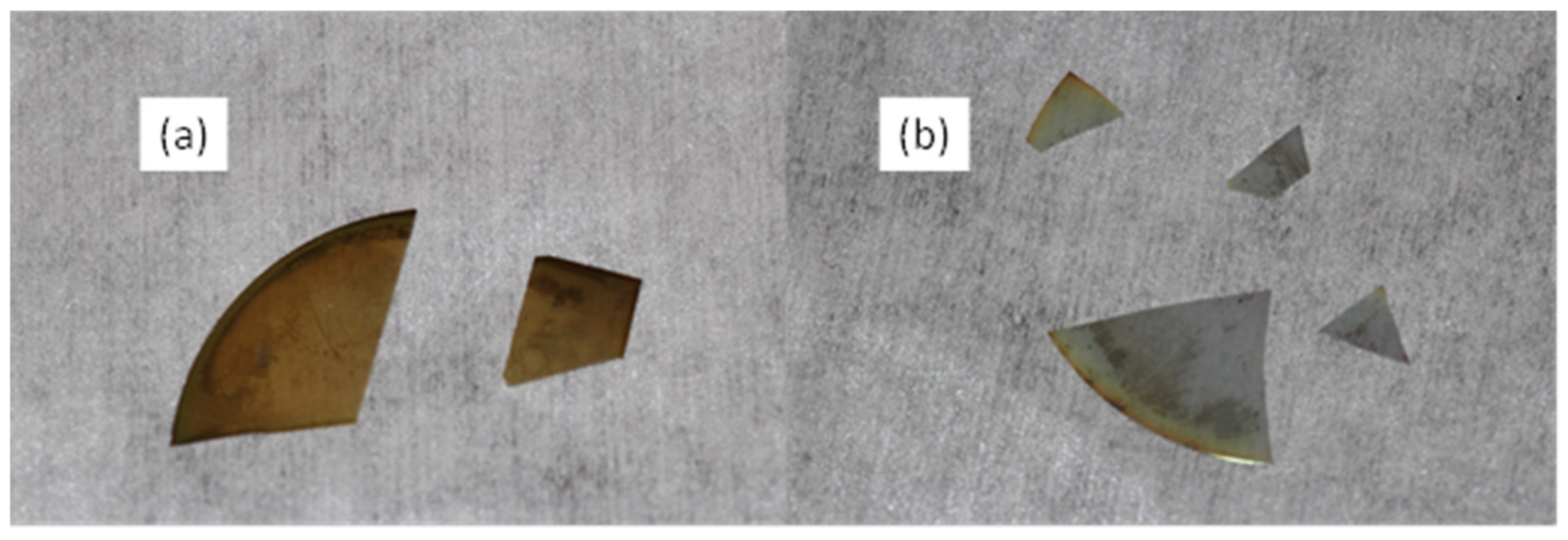
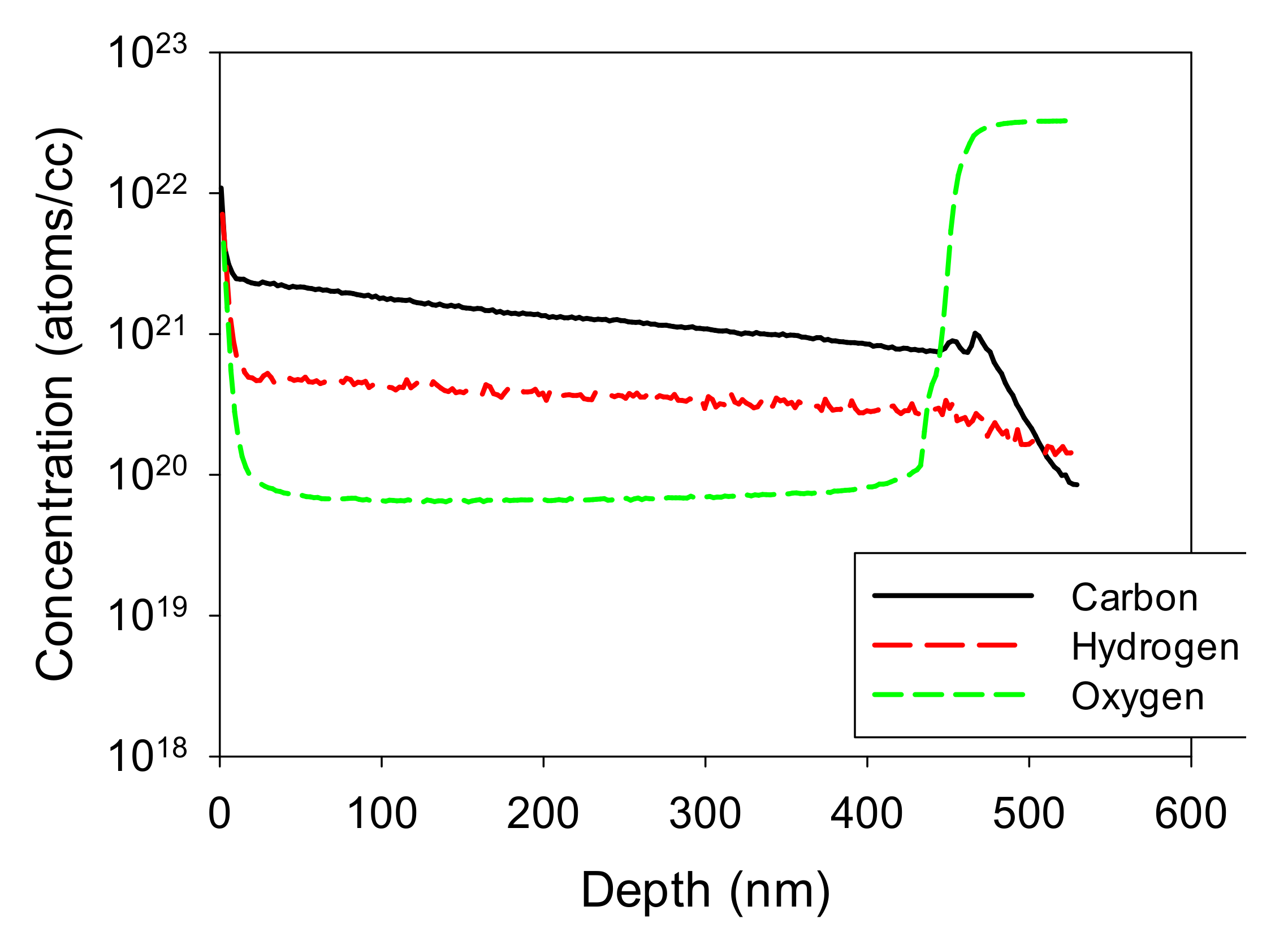
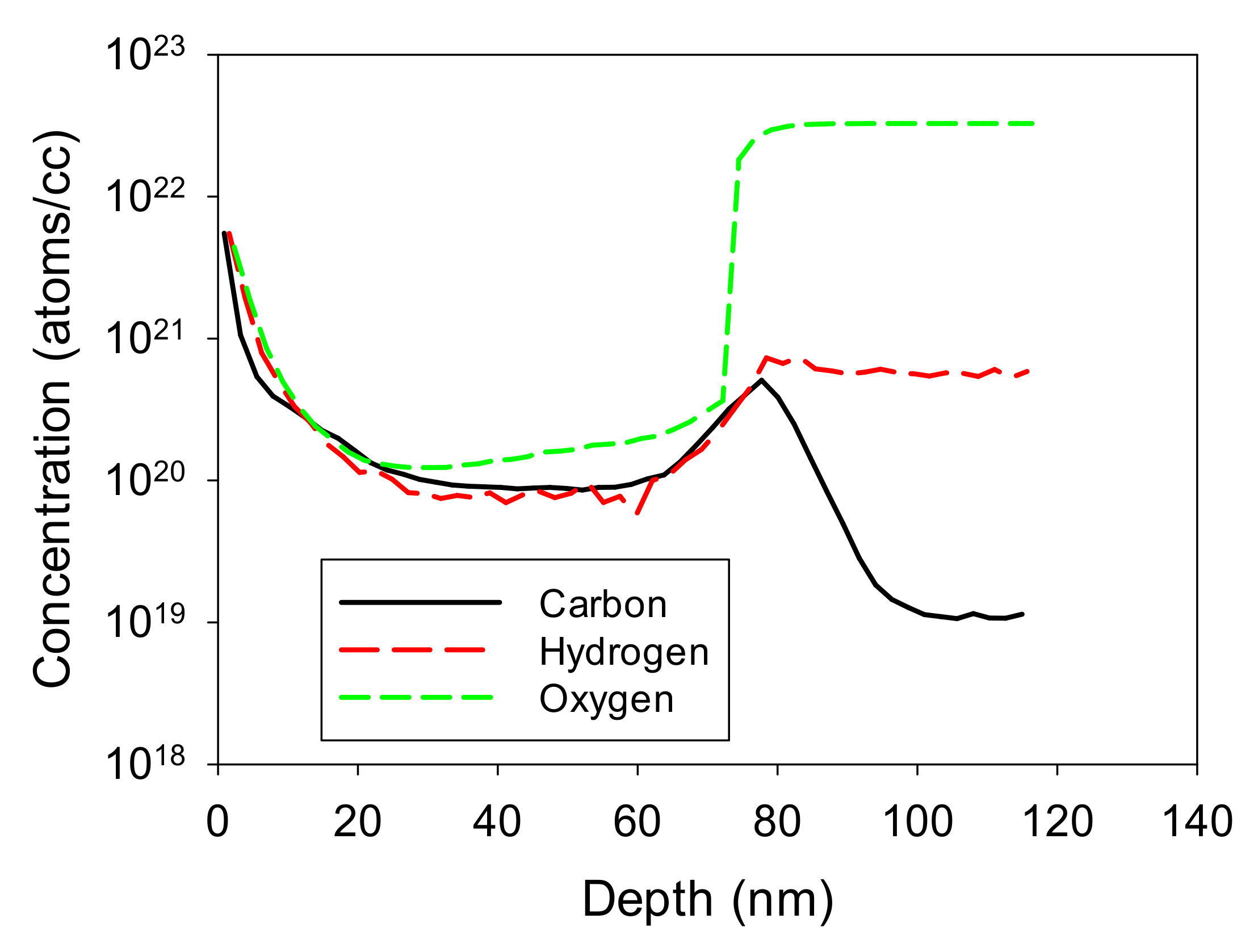
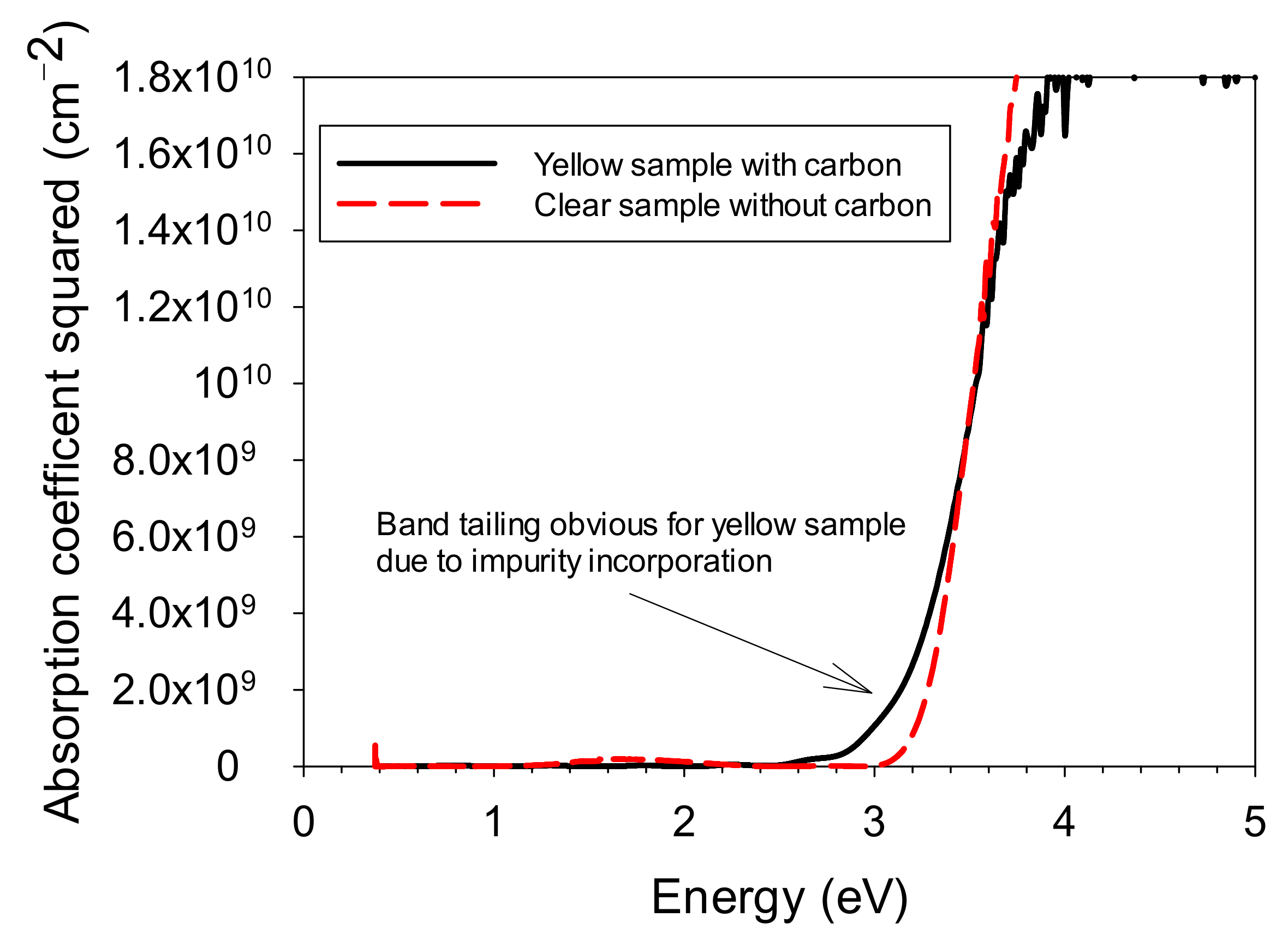
| Sample | Cycles | Thickness (nm) | GPC (nm/cycle) | Absorption Edge Position (eV) |
|---|---|---|---|---|
| 2011-05-24-1-GaN | 45 | - | - | 3.40 |
| 2011-05-31-1-GaN | 180 | 210 | 1.17 | 3.32 |
| 2011-06-01-1-GaN | 360 | 245 | 0.68 | 3.26 |
| 2011-06-02-2-GaN | 540 | 290 | 0.54 | 3.14 |
| 2011-05-30-2-GaN | 720 | 370 | 0.51 | 2.98 |
| Sample | Plasma Flow (sccm) | Thickness (nm) | GPC (nm/cycle) | Absorption Edge Position (eV) |
|---|---|---|---|---|
| 2012-03-28-2-GaN | 1400 | 192 | 0.187 | 3.35 |
| 2012-04-09-1-GaN | 1600 | 168 | 0.163 | 3.38 |
| 2012-04-24-1-GaN | 1700 | 264 | 0.257 | 3.30 |
| 2012-04-24-2-GaN | 1750 | 250 | 0.243 | 3.27 |
| 2012-04-10-1-GaN | 1800 | 140 | 0.136 | 3.25 |
| 2012-04-16-2-GaN | 1900 | 110 | 0.107 | 3.18 |
| 2012-04-10-2-GaN | 2000 | 69 | 0.067 | 3.20 |
| Sample | TMG Flow (sccm) | Thickness (nm) | GPC (nm/cycle) | Absorption Edge Position (eV) |
|---|---|---|---|---|
| 2013-07-11-1-GaN | 0.35 | 147 | 0.098 | 3.23 |
| 2013-07-12-1-GaN | 0.40 | 161 | 0.107 | 3.30 |
| 2013-07-30-1-GaN | 0.43 | - | - | 3.35 |
| 2013-08-05-1-GaN | 0.44 | 264 | 0.176 | 3.38 |
| 2013-07-25-2-GaN | 0.45 | 256 | 0.171 | 3.38 |
| 2013-08-04-1-GaN | 0.46 | 263 | 0.175 | 3.32 |
| 2013-08-01-1-GaN | 0.47 | 137 | 0.091 | 3.32 |
| 2013-08-03-1-GaN | 0.48 | 144 | 0.096 | 3.35 |
| 2013-07-26-1-GaN | 0.50 | 190 | 0.126 | 3.28 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Butcher, K.S.A.; Georgiev, V.; Georgieva, D.; Gergova, R.; Terziyska, P.; Binsted, P.W. Downstream Electric Field Effects during Film Deposition with a Radio Frequency Plasma and Observations of Carbon Reduction. Coatings 2022, 12, 1581. https://doi.org/10.3390/coatings12101581
Butcher KSA, Georgiev V, Georgieva D, Gergova R, Terziyska P, Binsted PW. Downstream Electric Field Effects during Film Deposition with a Radio Frequency Plasma and Observations of Carbon Reduction. Coatings. 2022; 12(10):1581. https://doi.org/10.3390/coatings12101581
Chicago/Turabian StyleButcher, Kenneth Scott Alexander, Vasil Georgiev, Dimka Georgieva, Rositsa Gergova, Penka Terziyska, and Peter W. Binsted. 2022. "Downstream Electric Field Effects during Film Deposition with a Radio Frequency Plasma and Observations of Carbon Reduction" Coatings 12, no. 10: 1581. https://doi.org/10.3390/coatings12101581
APA StyleButcher, K. S. A., Georgiev, V., Georgieva, D., Gergova, R., Terziyska, P., & Binsted, P. W. (2022). Downstream Electric Field Effects during Film Deposition with a Radio Frequency Plasma and Observations of Carbon Reduction. Coatings, 12(10), 1581. https://doi.org/10.3390/coatings12101581





