32 × 32 Pixelated High-Power Flip-Chip Blue Micro-LED-on-HFET Arrays for Submarine Optical Communication
Abstract
1. Introduction
2. Device Structure and Measurement Setup
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Conflicts of Interest
References
- Pimputkar, S.; Speck, J.S.; DenBaars, S.P.; Nakamura, S. Prospects for LED lighting. Nat. Photon. 2009, 3, 180–182. [Google Scholar] [CrossRef]
- Lee, Y.-J.; Yang, Z.-P.; Chen, P.-G.; Hsieh, Y.-A.; Yao, Y.-C.; Liao, M.-H.; Lee, M.-H.; Wang, M.-T.; Hwang, J.-M. Monolithic integration of GaN-based light-emitting diodes and metal-oxide-semiconductor field-effect transistors. Opt. Express 2014, 22, A1589–A1595. [Google Scholar] [CrossRef]
- Li, Z.; Waldron, J.; Detchprohm, T.; Wetzel, C.; Karlicek, R.F.; Chow, T.P. Monolithic integration of light-emitting diodes and power metal-oxide-semiconductor channel high-electron-mobility transistors for light-emitting power integrated circuits in GaN on sapphire substrate. Appl. Phys. Lett. 2013, 102, 192107. [Google Scholar] [CrossRef]
- Liu, Z.J.; Huang, T.; Ma, J.; Liu, C.; Lau, K.M. Monolithic integration of AlGaN/GaN HEMT on LED by MOCVD. IEEE Electron Device Lett. 2014, 35, 330–332. [Google Scholar] [CrossRef]
- Kalaitzakis, F.G.; Iliopoulos, E.; Konstantinidis, G.; Pelekanos, N.T. Monolithic integration of nitride-based transistor with Light Emitting Diode for sensing applications. Microelectron. Eng. 2012, 90, 33–36. [Google Scholar] [CrossRef]
- Leite, D.P.V.; Paolillo, F.R.; Parmesano, T.N.; Fontana, C.R.; Bagnato, V.S. Effects of photodynamic therapy with blue light and curcumin as mouth rinse for oral disinfection: A randomized controlled Trial. Photomed. Laser Surg. 2014, 32, 627–632. [Google Scholar] [CrossRef] [PubMed]
- Zhu, S.; Chen, X.; Liu, X.; Zhang, G.; Tian, P. Recent progress in and perspectives of underwater wireless optical communication. Prog. Quantum. Electron. 2020, 73, 100274. [Google Scholar] [CrossRef]
- Tian, P.; Liu, X.; Yi, S.; Huang, Y.; Zhang, S.; Zhou, X.; Hu, L.; Zheng, L.; Liu, R. High-speed underwater optical wireless communication using a blue GaN-based micro-LED. Opt. Express 2017, 25, 1193–1201. [Google Scholar] [CrossRef] [PubMed]
- Spagnolo, G.S.; Cozzella, L.; Leccese, F. Underwater optical wireless communications: Overview. Sensors 2020, 20, 2261. [Google Scholar] [CrossRef]
- Lu, X.; Liu, C.; Jiang, H.; Zou, X.; Lau, K.M. High performance monolithically integrated GaN driving VMOSFET on LED. IEEE Trans. Electron Devices 2017, 38, 752–755. [Google Scholar] [CrossRef]
- Lau, K.M.; Choi, H.W.; Lee, S.-W.R.; Mok, P.K.T.; Sin, J.K.O.; Yue, C.P.; Ki, W.-H. In Proceedings of the 10th China International Forum Solid State Lighting, Beijing Kuntai Hotel, Beijing, China, 10–12 November 2013.
- Liu, C.; Cai, Y.; Liu, Z.; Ma, J.; Lau, K.M. Metal-interconnection-free integration of InGaN/GaN light emitting diodes with AlGaN/GaN high electron mobility transistors. Appl. Phys. Lett. 2015, 106, 181110. [Google Scholar] [CrossRef]
- Lee, H.-S.; Piedra, D.; Sun, M.; Gao, X.; Guo, S.; Palacios, T. 3000-V 4.3-mΩ·cm2 InAlN/GaN MOSHEMTs with AlGaN back barrier. IEEE Electron Device Lett. 2012, 33, 982–984. [Google Scholar] [CrossRef]
- Herfurth, P.; Maier, D.; Lugani, L.; Carlin, J.F.; Roesch, R.; Men, Y.; Grandjean, N.; Kohn, E. Ultrathin body InAlN/GaN HEMTs for high-temperature (600 °C) electronics. IEEE Electron Device Lett. 2013, 34, 496–498. [Google Scholar] [CrossRef]
- Chung, J.W.; Hoke, W.E.; Chumbes, E.M.; Palacios, T. AlGaN/GaN HEMT with 300-GHz fmax. IEEE Electron Device Lett. 2010, 31, 195–197. [Google Scholar] [CrossRef]
- Kuzuhara, M.; Tokuda, M. Low-loss and high-voltage III-Nitride transistors for power switching applications. IEEE Trans. Electron Devices 2015, 62, 405–413. [Google Scholar] [CrossRef]
- Liu, Z.; Ma, J.; Huang, T.; Liu, C.; Lau, K.M. Selective epitaxial growth of monolithically integrated GaN-based light emitting diodes with AlGaN/GaN driving transistors. Appl. Phys. Lett. 2014, 104, 091103. [Google Scholar] [CrossRef]
- Tsuchiyama, K.; Yamane, K.; Utsunomiya, S.; Sekiguchi, H.; Okada, H.; Wakahara, A. Monolithic integration of Si-MOSFET and GaN-LED using Si/SiO2/GaN-LED wafer. Appl. Phys. Express 2016, 9, 104101. [Google Scholar] [CrossRef]
- Liu, C.; Cai, Y.; Zou, X.; Lau, K.M. Low-leakage high-breakdown laterally integrated HEMT-LED via n-GaN electrode. IEEE Photonics Technol. Lett. 2016, 28, 1130–1133. [Google Scholar] [CrossRef]
- Li, Z.; Waldron, J.; Chowdhury, S.; Zhao, L.; Detchprohm, T.; Wetzel, C.; Karlicek, R.F., Jr.; Chow, T.P. High temperature characteristics of monolithically integrated LED and MOS-channel HEMT in GaN using selective epi removal. Phys. Status Solidi A 2015, 212, 1110–1115. [Google Scholar] [CrossRef]
- Lu, X.; Liu, C.; Jiang, H.; Zou, X.; Zhang, A.; Lau, K.M. Monolithic integration of enhancement-mode vertical driving transistors on a standard InGaN/GaN light emitting di-ode structure. Appl. Phys. Lett. 2016, 109, 053504. [Google Scholar] [CrossRef]
- Wang, Y.; Wang, X.; Yuan, J.; Gao, X.; Zhu, B. Monolithic III–nitride photonic circuit towards on-chip optical interconnection. Appl. Phys. Express 2018, 11, 122201. [Google Scholar] [CrossRef]
- Liu, C.; Cai, Y.; Jiang, H.; Lau, K.M. Monolithic integration of III-nitride voltage controlled light emitters with dual-wavelength photodiodes by selective-area epitaxy. Opt. Lett. 2018, 43, 3401–3404. [Google Scholar] [CrossRef] [PubMed]
- Kim, T.K.; Cho, M.U.; So, J.B.; Lee, J.M.; Oh, S.K.; Cha, Y.-J.; Jang, T.; Cho, J.H.; Kwak, J.S. Realization of high-power dimmable GaN-based LEDs by hybrid integration with AlGaN/GaN HFETs. Jpn. J. Appl. Phys. 2019, 58, SCCC12. [Google Scholar]
- Liu, Z.J.; Wong, K.M.; Keung, C.W.; Tang, C.W.; Lau, K.M. Monolithic LED microdisplay on active matrix substrate using flip-chip technology. IEEE J. Sel. Top. Quantum Electron. 2009, 15, 1298–1302. [Google Scholar]
- Brammertz, G.; Mols, Y.; Degroote, S.; Leys, M.; Steenbergen, J.V.; Borghs, G.; Gaymax, M. Selective epitaxial growth of GaAs on Ge by MOCVD. J. Cryst. Growth. 2006, 297, 204–210. [Google Scholar] [CrossRef][Green Version]
- Oh, S.K.; Ko, H.-Y.; Jang, T.; Kwak, J.S. Development of chip shrink technology for lateral-type GaN based HFETs using SiO2/polyimide dual IMD layers. Electron. Mater. Lett. 2015, 11, 213–216. [Google Scholar] [CrossRef]
- Cheang, P.; Christensen, L.; Reynaga, C. Optimization of photosensitive polyimide process for cost effective packaging. In Surface Mount Technology Seminar; Ultratech Stepper, Inc.: San Jose, CA, USA, 1996. [Google Scholar]
- Lee, J.H.; Islam, A.B.M.H.; Kim, T.K.; Cha, Y.-J.; Kwak, J.S. Impact of tin-oxide nanoparticles on improving the carrier transport in the Ag/p-GaN interface of InGaN/GaN micro-light-emitting diodes by originating inhomogeneous Schottky barrier height. Photon. Res. 2020, 8, 1049–1057. [Google Scholar] [CrossRef]
- Hong, I.Y.; Islam, A.B.M.H.; Kim, T.K.; Cha, Y.-J.; Kwak, J.S. Impact of grain growth of silver reflective electrode by electron bombardment on external quantum efficiency of III-nitride micro-light-emitting diode arrays. Appl. Surf. Sci. 2020, 512, 145698. [Google Scholar] [CrossRef]
- Im, K.-S.; Ha, J.-B.; Kim, K.-W.; Lee, J.-S.; Kim, D.-S.; Hahm, S.-H.; Lee, J.-H. Normally off GaN MOSFET based on AlGaN/GaN heterostructure with extremely high 2DEG density grown on silicon substrate. IEEE Electron Device Lett. 2010, 31, 192–194. [Google Scholar]
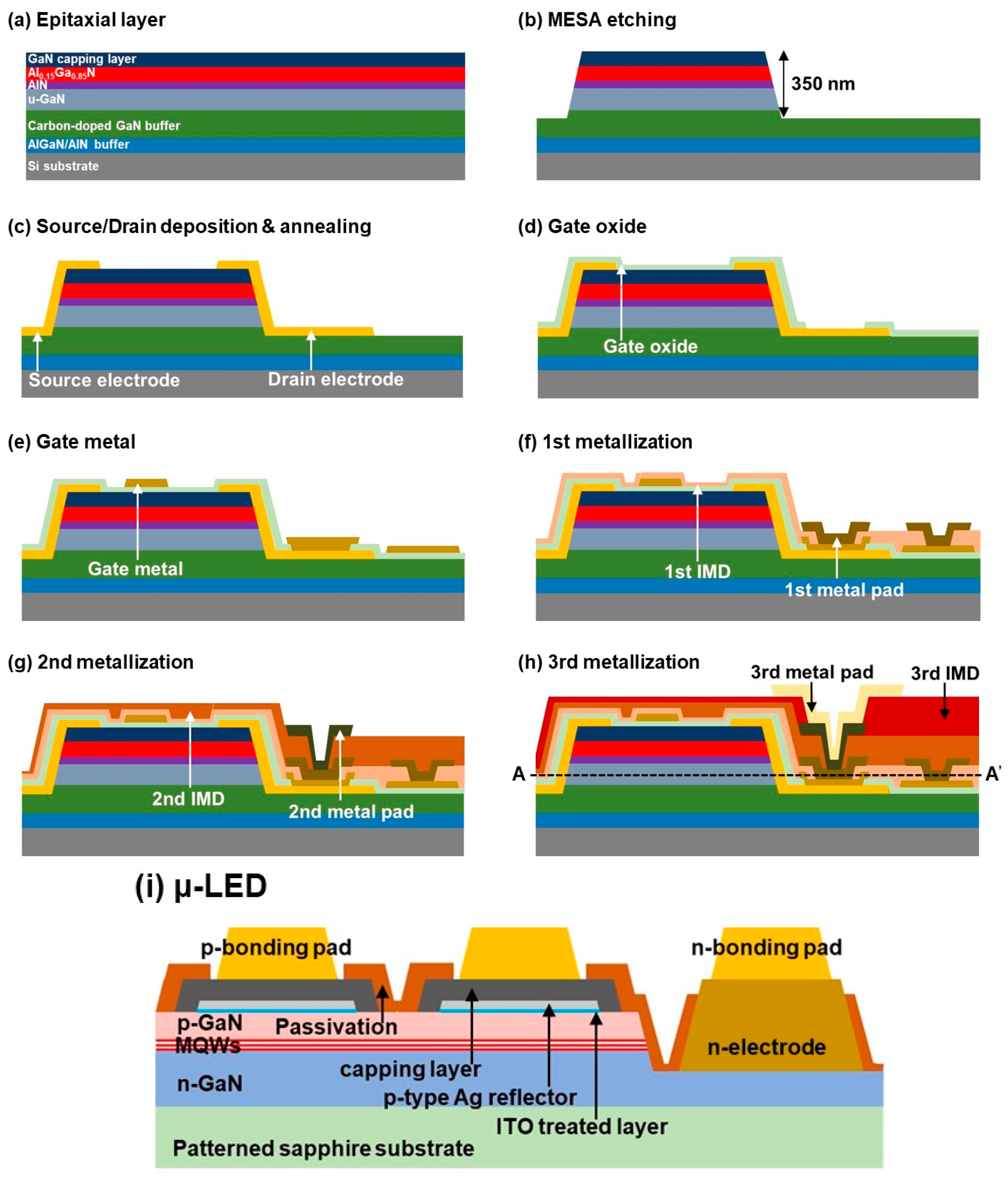
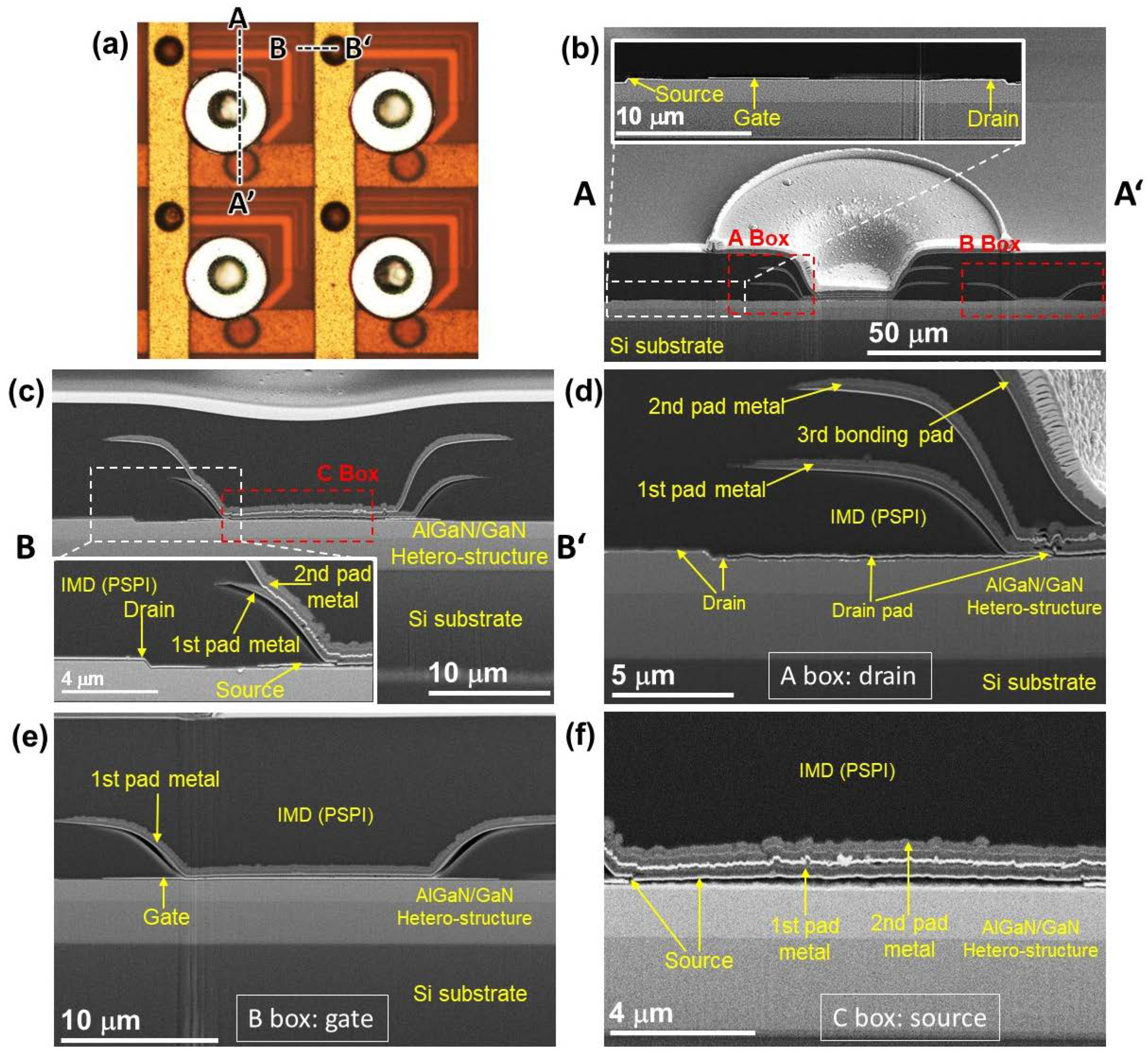

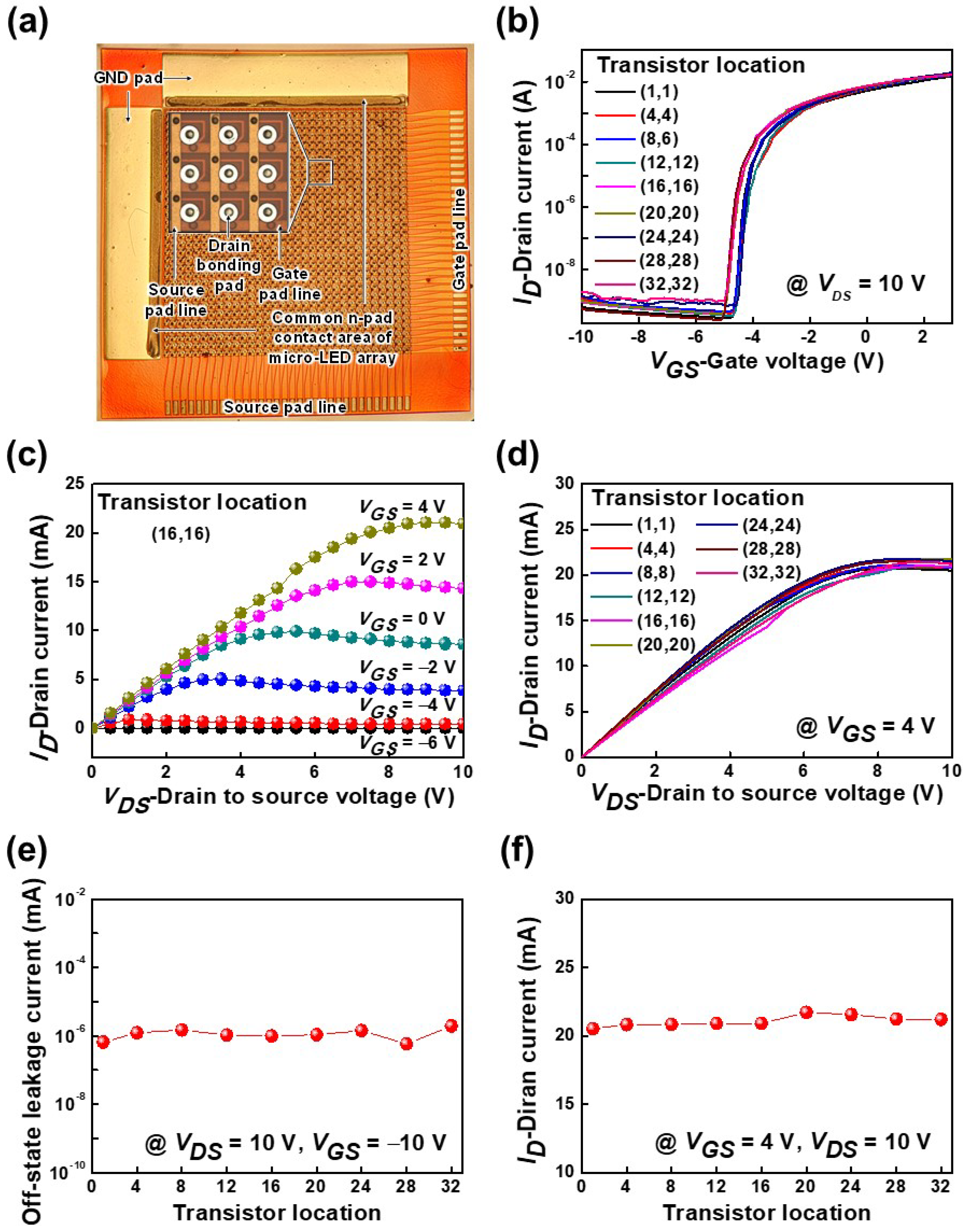
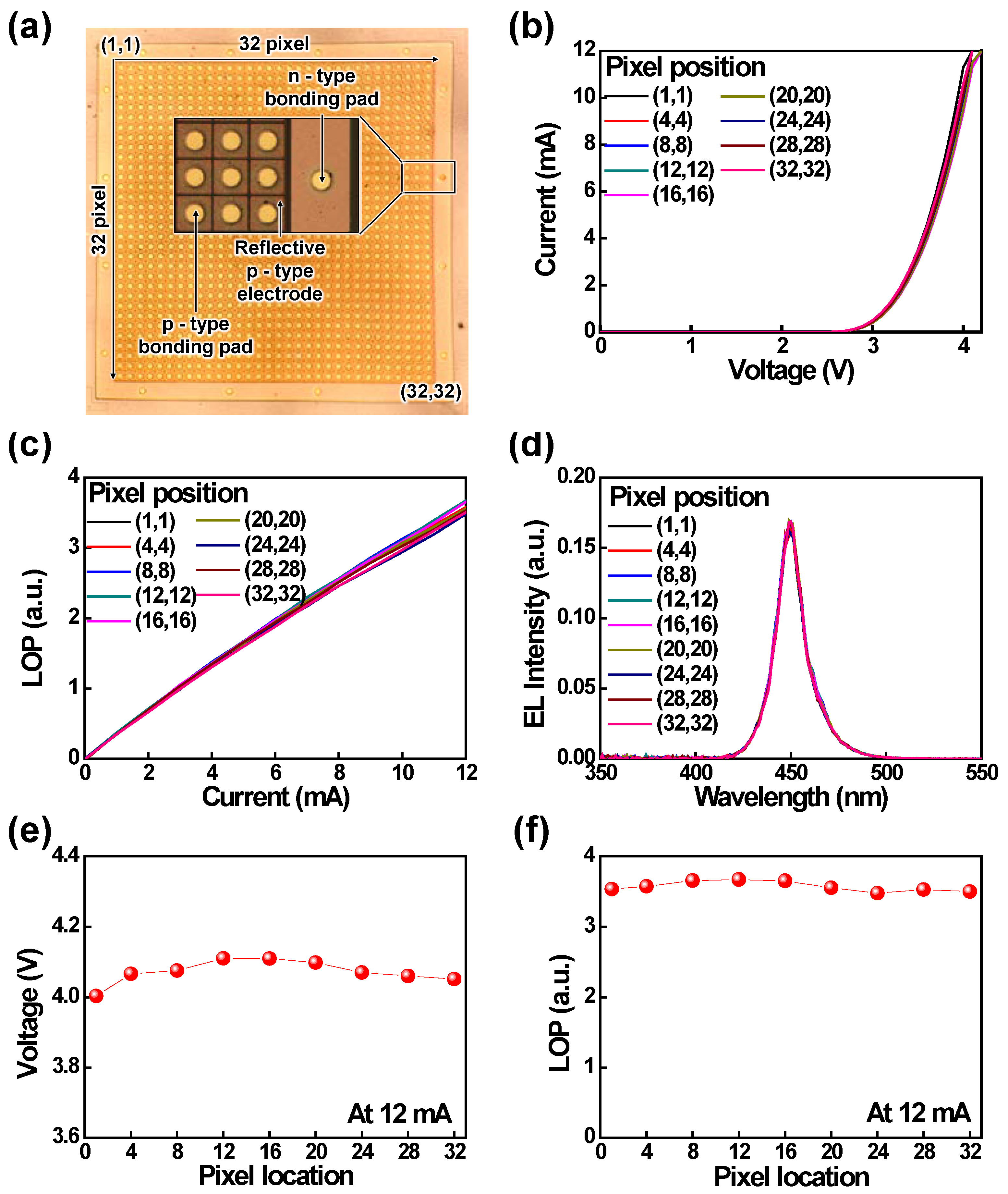
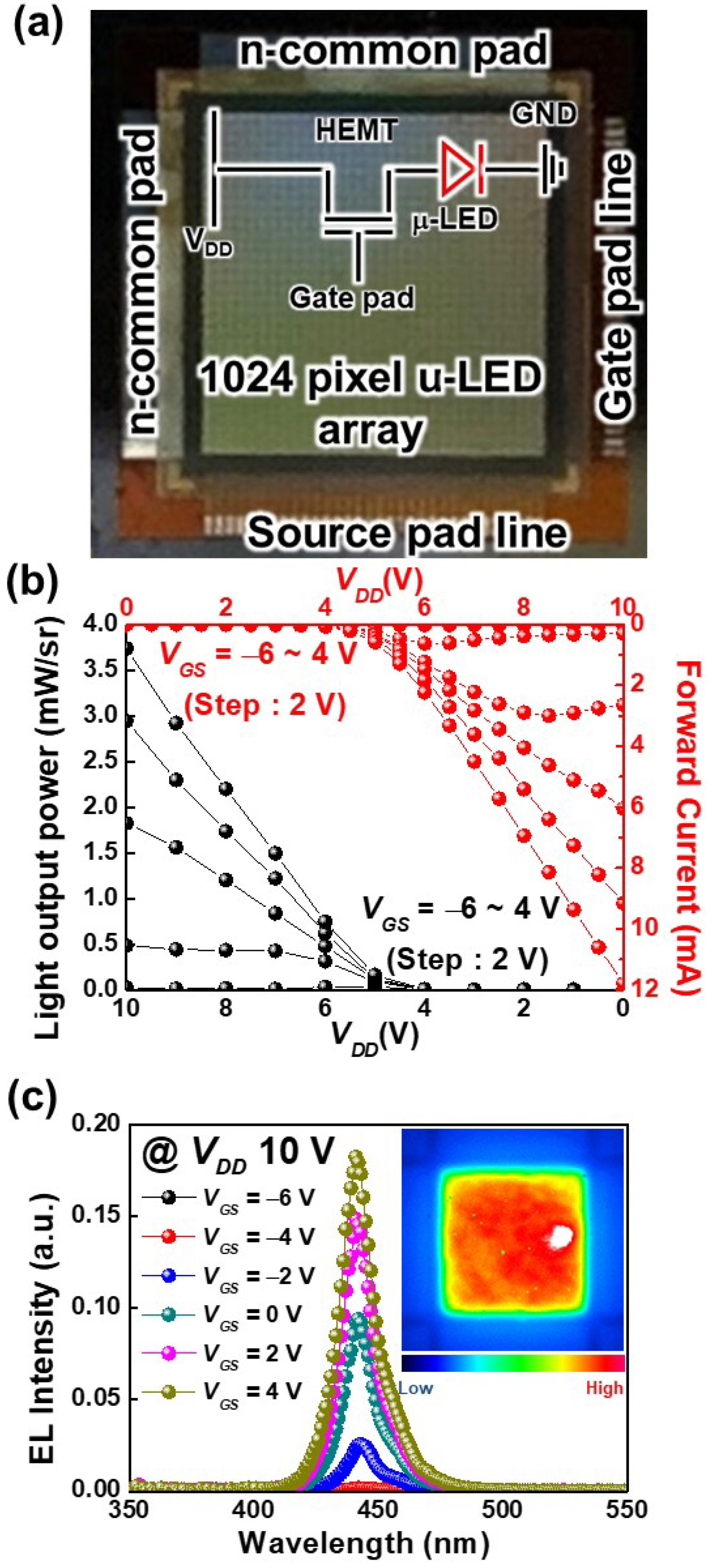
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Kim, T.K.; Islam, A.B.M.H.; Cha, Y.-J.; Kwak, J.S. 32 × 32 Pixelated High-Power Flip-Chip Blue Micro-LED-on-HFET Arrays for Submarine Optical Communication. Nanomaterials 2021, 11, 3045. https://doi.org/10.3390/nano11113045
Kim TK, Islam ABMH, Cha Y-J, Kwak JS. 32 × 32 Pixelated High-Power Flip-Chip Blue Micro-LED-on-HFET Arrays for Submarine Optical Communication. Nanomaterials. 2021; 11(11):3045. https://doi.org/10.3390/nano11113045
Chicago/Turabian StyleKim, Tae Kyoung, Abu Bashar Mohammad Hamidul Islam, Yu-Jung Cha, and Joon Seop Kwak. 2021. "32 × 32 Pixelated High-Power Flip-Chip Blue Micro-LED-on-HFET Arrays for Submarine Optical Communication" Nanomaterials 11, no. 11: 3045. https://doi.org/10.3390/nano11113045
APA StyleKim, T. K., Islam, A. B. M. H., Cha, Y.-J., & Kwak, J. S. (2021). 32 × 32 Pixelated High-Power Flip-Chip Blue Micro-LED-on-HFET Arrays for Submarine Optical Communication. Nanomaterials, 11(11), 3045. https://doi.org/10.3390/nano11113045






