Extraordinary Field Emission of Diamond Film Developed on a Graphite Substrate by Microwave Plasma Jet Chemical Vapor Deposition
Abstract
1. Introduction
2. The MPJCVD System and Its Reconditioning
3. Formulation and Numerical Modeling
3.1. Governing Equations
3.2. Numerical Methods
4. Simulation Results and Optimization
4.1. Effects of System Geometry
4.2. Effects of Microwave Power
4.3. Hydrogen Plasma
5. Experimental Results
5.1. Pretreatment
5.2. Microwave Plasma Jet Chemical Vapor Deposition of Diamond Films and Characterization
6. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Shokrieh, M.M.; Rafiee, R. A review of the mechanical properties of isolated carbon nanotubes and carbon nanotube composites. Mech. Compos. Mater. 2010, 46, 155–172. [Google Scholar] [CrossRef]
- Che, J.; Cagin, T.; Goddard, W.A., III. Thermal conductivity of carbon nanotubes. Nanotechnology 2000, 11, 65. [Google Scholar] [CrossRef]
- Hone, J.; Llaguno, M.C.; Nemes, N.M.; Johnson, A.T.; Fischer, J.E.; Walters, D.A.; Casavant, M.J.; Schmidt, J.; Smalley, R.E. Electrical and thermal transport properties of magnetically aligned single wall carbon nanotube films. Appl. Phys. Lett. 2000, 77, 666–668. [Google Scholar] [CrossRef]
- Zhou, D.; Krauss, A.R.; Qin, L.C.; McCauley, T.G.; Gruen, D.M.; Corrigan, T.D.; Chang, R.P.H.; Gnaser, H. Synthesis and electron field emission of nanocrystalline diamond thin films grown from N 2/CH4 microwave plasmas. J. Appl. Phys. 1997, 82, 4546–4550. [Google Scholar] [CrossRef]
- Bhattacharyya, S.; Auciello, O.; Birrell, J.; Carlisle, J.A.; Curtiss, L.A.; Goyette, A.N.; Gruen, D.M.; Krauss, A.R.; Schlueter, J.; Sumant, A.; et al. Synthesis and characterization of highly-conducting nitrogen-doped ultrananocrystalline diamond films. Appl. Phys. Lett. 2001, 79, 1441–1443. [Google Scholar] [CrossRef]
- Veres, M.; Tóth, S.; Koós, M. Grain boundary fine structure of ultrananocrystalline diamond thin films measured by Raman scattering. Appl. Phys. Lett. 2007, 91, 031913. [Google Scholar] [CrossRef]
- Lin, C.R.; Liao, W.H.; Wei, D.H.; Chang, C.K. Fabrication of nanogranular diamond films by MPJCVD system. Phys. Procedia. 2011, 18, 148–153. [Google Scholar] [CrossRef]
- Ginzburg, V.L. Propagation of Electromagnetic Waves in Plasmas; North Holland Publishing Company: Amsterdam, The Netherlands, 1961. [Google Scholar]
- Selwyn, G.S.; Herrmann, H.W.; Park, J.; Henins, I. Materials Processing Using an Atmospheric Pressure, RF-Generated Plasma Source. Contrib. Plasma Phys. 2001, 41, 610–619. [Google Scholar] [CrossRef]
- Schutze, A.; Jeong, J.Y.; Babayan, S.E.; Park, J.; Selwyn, G.S.; Hicks, R.F. The atmospheric-pressure plasma jet: A review and comparison to other plasma sources. IEEE Trans. Plasma Sci. 1998, 26, 1685–1694. [Google Scholar] [CrossRef]
- Kruger, C.H.; Owano, T.G.; Laux, C. Experimental investigation of atmospheric pressure nonequilibrium plasma chemistry. IEEE Trans. Plasma Sci. 1997, 25, 1042–1051. [Google Scholar] [CrossRef]
- Kim, H.J.; Hong, S.H. Comparative measurements on thermal plasma jet characteristics in atmospheric and low pressure plasma sprayings. IEEE Trans. Plasma Sci. 1995, 23, 852–859. [Google Scholar]
- Hoffmann, H. O--ion radiation in the spectrum of an oxygen arc plasma. J. Quant. Spectrosc. Radiat. Transf. 1979, 21, 163–180. [Google Scholar] [CrossRef]
- Eliasson, B.; Kogelschatz, U. Nonequilibrium volume plasma chemical processing. IEEE Trans. Plasma Sci. 1991, 19, 1063–1077. [Google Scholar] [CrossRef]
- Eliasson, B.; Kogelschatz, U. Modeling and applications of silent discharge plasmas. IEEE Trans. Plasma Sci. 1991, 19, 309–323. [Google Scholar] [CrossRef]
- Massines, F.; Rabehi, A.; Decomps, P.; Gadri, R.B.; Ségur, P.; Mayoux, C. Experimental and theoretical study of a glow discharge at atmospheric pressure controlled by dielectric barrier. J. Appl. Phys. 1998, 83, 2950–2957. [Google Scholar] [CrossRef]
- Tsai, P.P.; Wadsworth, L.C.; Roth, J.R. Surface modification of fabrics using a one-atmosphere glow discharge plasma to improve fabric wettability. Text. Res. J. 1997, 67, 359–369. [Google Scholar] [CrossRef]
- Kanazawa, S.; Kogoma, M.; Moriwaki, T.; Okazaki, S. Stable glow plasma at atmospheric pressure. J. Phys. D. Appl. Phys. 1988, 21, 838. [Google Scholar] [CrossRef]
- Moravej, M.; Yang, X.; Barankin, M.; Penelon, J.; Babayan, S.E.; Hicks, R.F. Properties of an atmospheric pressure radio-frequency argon and nitrogen plasma. Plasma Sources Sci. Technol. 2006, 15, 204. [Google Scholar] [CrossRef]
- Moon, S.Y.; Choe, W.; Kang, B.K. A uniform glow discharge plasma source at atmospheric pressure. Appl. Phys. Lett. 2004, 84, 188–190. [Google Scholar] [CrossRef]
- Han, K.H.; Kang, J.G.; Uhm, H.S.; Kang, B.K. Photo-resist ashing by atmospheric pressure glow discharge. Curr. Appl. Phys. 2007, 7, 211–214. [Google Scholar] [CrossRef]
- Woskov, P.P.; Rhee, D.Y.; Thomas, P.; Cohn, D.R.; Surma, J.E.; Titus, C.H. Microwave plasma continuous emissions monitor for trace-metals in furnace exhaust. Rev. Sci. Instrum. 1996, 67, 3700–3707. [Google Scholar] [CrossRef]
- Woskov, P.P.; Hadidi, K. Large electrodeless plasmas at atmospheric pressure sustained by a microwave waveguide. IEEE Trans. Plasma Sci. 2002, 30, 156–157. [Google Scholar] [CrossRef]
- Al-Shamma’a, A.I.; Wylie, S.R.; Lucas, J.; Yan, J.D. Atmospheric microwave plasma jet for material processing. IEEE Trans. Plasma Sci. 2002, 30, 1863–1871. [Google Scholar] [CrossRef]
- Wylie, S.R.; Al-Shamma’a, A.I.; Lucas, J. Microwave plasma system for material processing. IEEE Trans. Plasma Sci. 2005, 33, 340–341. [Google Scholar] [CrossRef]
- Song, H.; Hong, J.M.; Lee, K.H.; Choi, J.J. Stable microwave coaxial cavity plasma system at atmospheric pressure. Rev. Sci. Instrum. 2008, 79, 054702. [Google Scholar] [CrossRef]
- Harigai, T.; Ohhra, H.; Tominaga, R.; Bando, T.; Takikawa, H.; Kunitsugu, S.; Gonda, H. Ultra-high-rate deposition of diamond-like carbon films using Ar/C2H2 plasma jet CVD in combination with substrate-stage discharge. Jpn. J. Appl. Phys. 2022, 61, SI1001. [Google Scholar] [CrossRef]
- Huang, Y.; Chen, L.; Shao, S.; Huang, K.; An, K.; Zheng, Y.; Liu, J.; Wei, J.; Li, C. The 7-in. freestanding diamond thermal conductive film fabricated by DC arc Plasma Jet CVD with multi-stage magnetic fields. Diam. Relat. Mater. 2022, 122, 108812. [Google Scholar] [CrossRef]
- Huang, Y.; Chen, L.; Shao, S.; Zhu, X.; Huang, K.; An, K.; Zheng, Y.; Liu, J.; Wei, J.; Li, C. Impact of deposition temperature on microstructure and properties of erbium oxide antireflective films deposited on CVD diamond substrates. Vacuum 2021, 193, 110547. [Google Scholar] [CrossRef]
- Zheng, Y.; Li, C.; Liu, J.; Wei, J.; Ye, H. Diamond with nitrogen: States, control, and applications. Funct. Diam. 2022, 1, 63–82. [Google Scholar] [CrossRef]
- Brezmes, A.O.; Breitkopf, C. Fast and reliable simulations of argon inductively coupled plasma using COMSOL. Vacuum 2015, 116, 65–72. [Google Scholar] [CrossRef]
- Shivkumar, G.; Tholeti, S.S.; Alrefae, M.A.; Fisher, T.S.; Alexeenko, A.A. Analysis of hydrogen plasma in a microwave plasma chemical vapor deposition reactor. J. Appl. Phys. 2016, 119, 113301. [Google Scholar] [CrossRef]
- Massaro, A.; Velardi, L.; Taccogna, F.; Cicala, G. Experimental and numerical studies of microwave-plasma interaction in a MWPECVD reactor. AIP Adv. 2016, 6, 125001. [Google Scholar] [CrossRef]
- Meyyappan, M. A review of plasma enhanced chemical vapour deposition of carbon nanotubes. J. Phys. D. Appl. Phys. 2009, 42, 213001. [Google Scholar] [CrossRef]
- Hassouni, K.; Silva, F.; Gicquel, A. Modelling of diamond deposition microwave cavity generated plasmas. J. Phys. D. Appl. Phys. 2010, 43, 153001. [Google Scholar] [CrossRef]
- Hassouni, K.; Grotjohn, T.A.; Gicquel, A. Self-consistent microwave field and plasma discharge simulations for a moderate pressure hydrogen discharge reactor. J. Appl. Phys. 1999, 86, 134–151. [Google Scholar] [CrossRef]
- Füner, M.; Wild, C.; Koidl, P. Numerical simulations of microwave plasma reactors for diamond CVD. Surf. Coat. Technol. 1995, 74, 221–226. [Google Scholar] [CrossRef]
- An, K.; Yu, S.W.; Li, X.J.; Shen, Y.Y.; Zhou, B.; Zhang, G.J.; Liu, X.P. Microwave plasma reactor with conical-reflector for diamond deposition. Vacuum 2015, 117, 112–120. [Google Scholar] [CrossRef]
- Wang, Q.; Wu, G.; Liu, S.; Gan, Z.; Yang, B.; Pan, J. Simulation-Based Development of a New Cylindrical-Cavity Microwave-Plasma Reactor for Diamond-Film Synthesis. Crystals 2019, 9, 320. [Google Scholar] [CrossRef]
- Salgado-Meza, M.; Martínez-Rodríguez, G.; Tirado-Cantú, P.; Montijo-Valenzuela, E.E.; García-Gutiérrez, R. Synthesis and Properties of Electrically Conductive/Nitrogen Grain Boundaries Incorporated Ultrananocrystalline Diamond (N-UNCD) Thin Films Grown by Microwave Plasma Chemical Vapor Deposition (MPCVD). Appl. Sci. 2021, 11, 8443. [Google Scholar] [CrossRef]
- Wang, B.; Yang, D.; Zhu, X.; Zhao, Y.; Wang, S.; Zhu, J.; Zhai, M. Effect of Positive Bias and Pressure on Plasma Flow Characteristics in a Chemical Vapor Deposition Chamber. Processes 2022, 10, 2665. [Google Scholar] [CrossRef]
- Lieberman, M.A.; Lichtenberg, A.J. Principles of Plasma Discharges and Materials Processing, 2nd ed.; John Wiley & Sons, Inc.: Hoboken, NJ, USA, 2005. [Google Scholar]
- COMSOL. The COMSOL Multiphysics 5.2 Release User’s Guide; COMSOL: Burlington, MA, USA, 2016. [Google Scholar]
- Lin, C.; Liao, W.; Wei, D.; Chang, C.; Fang, W.; Chen, C.; Dong, C.; Chen, J.; Guo, J. Improvement on the synthesis technique of ultrananocrystalline diamond films by using microwave plasma jet chemical vapor deposition. J. Cryst. Growth 2011, 326, 212. [Google Scholar] [CrossRef]
- Gromov, D.; Borgardt, N.; Grishina, Y.; Dedkova, A.; Kirilenko, E.; Dubkov, S. Study of growth kinetics of amorphous carbon nanopillars formed by PECVD. Proc. SPIE 2014, 9440, 89–97. [Google Scholar]


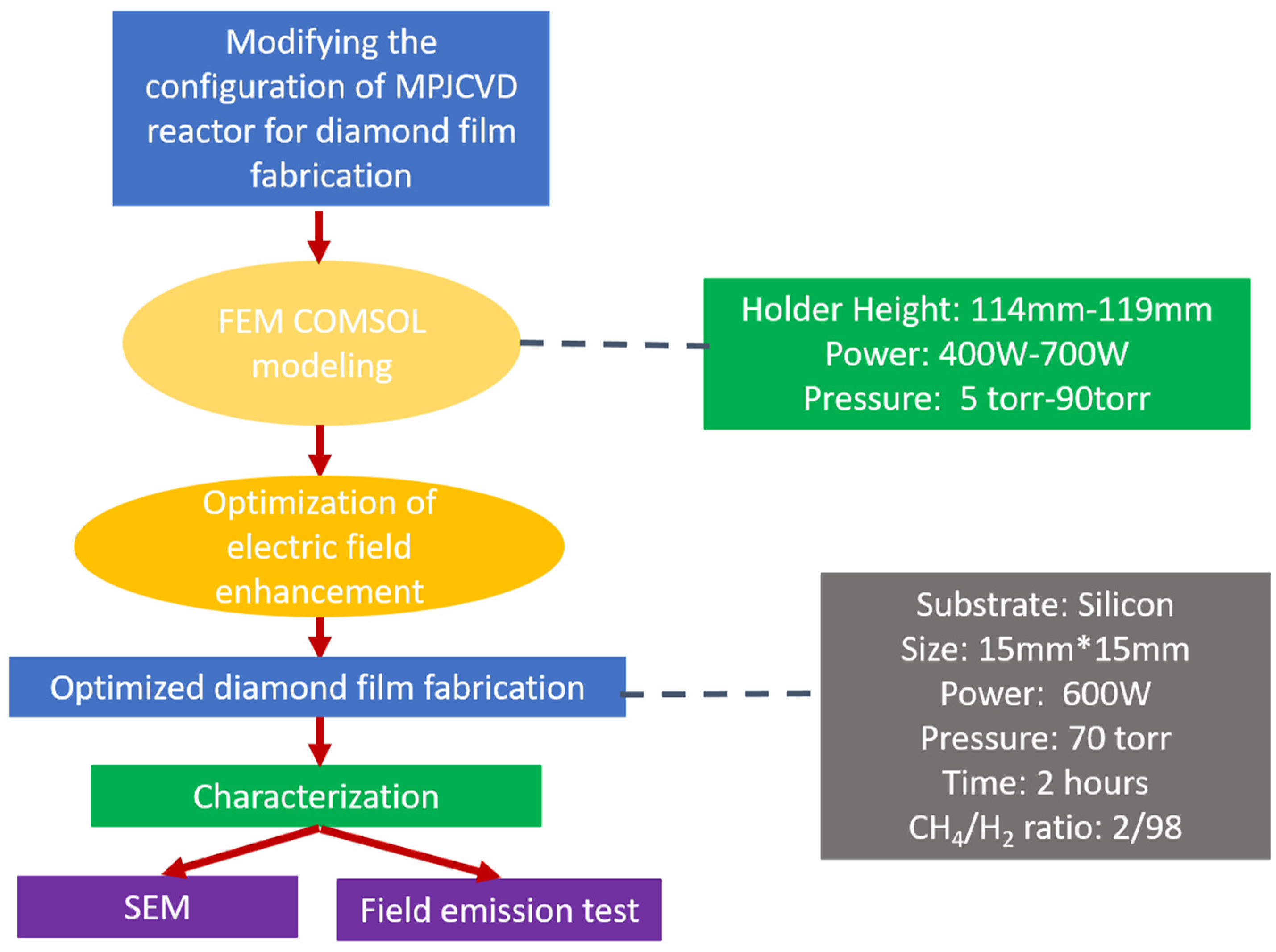


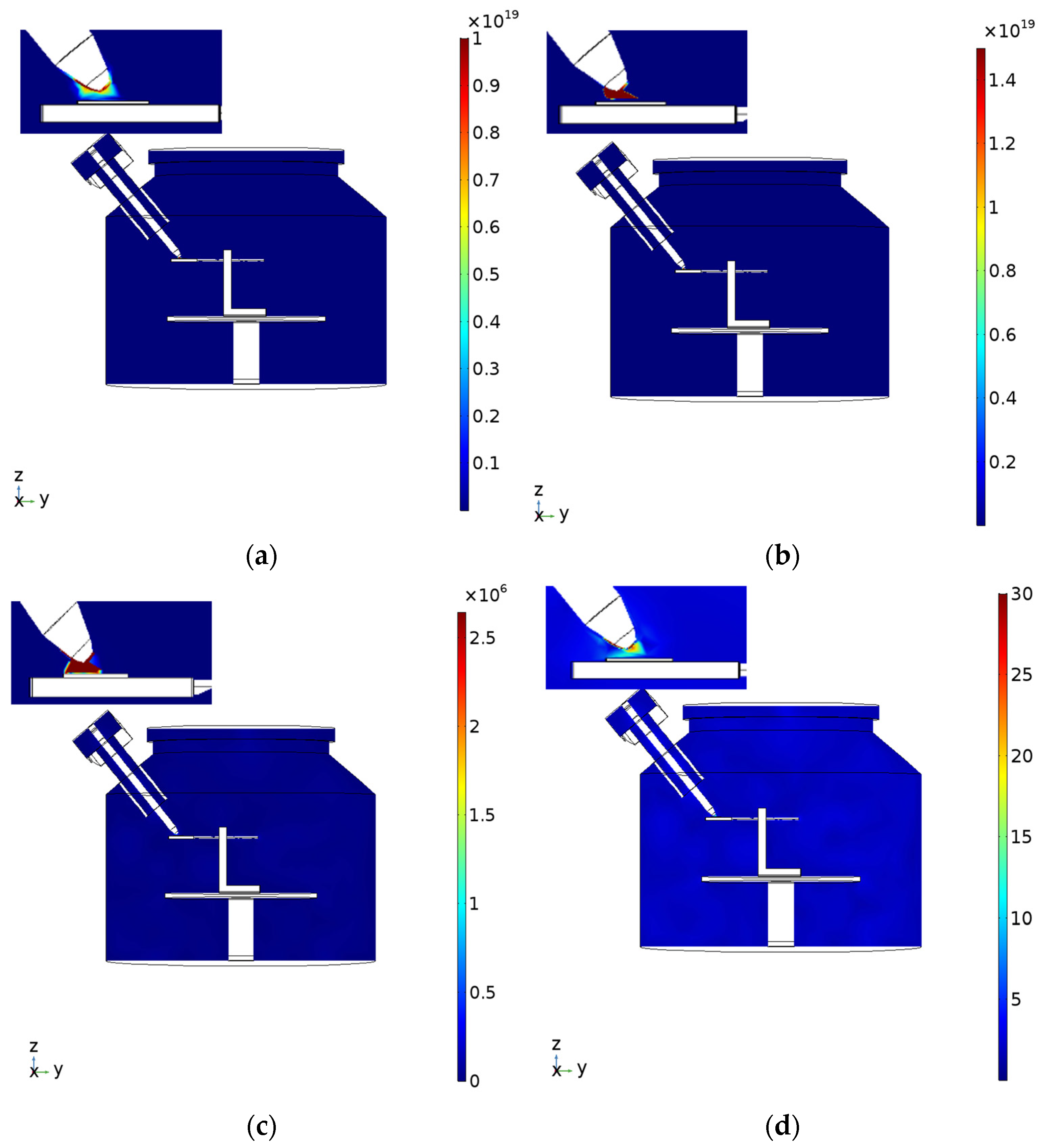
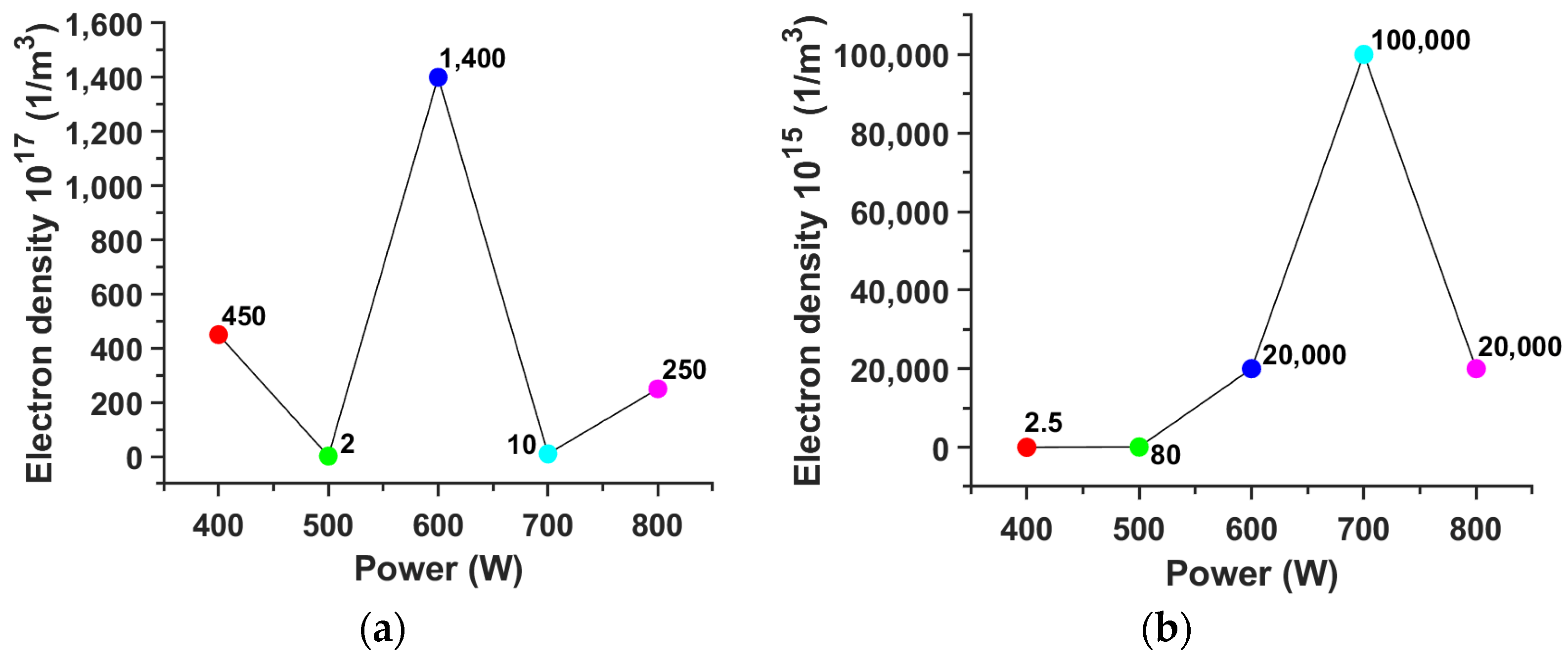
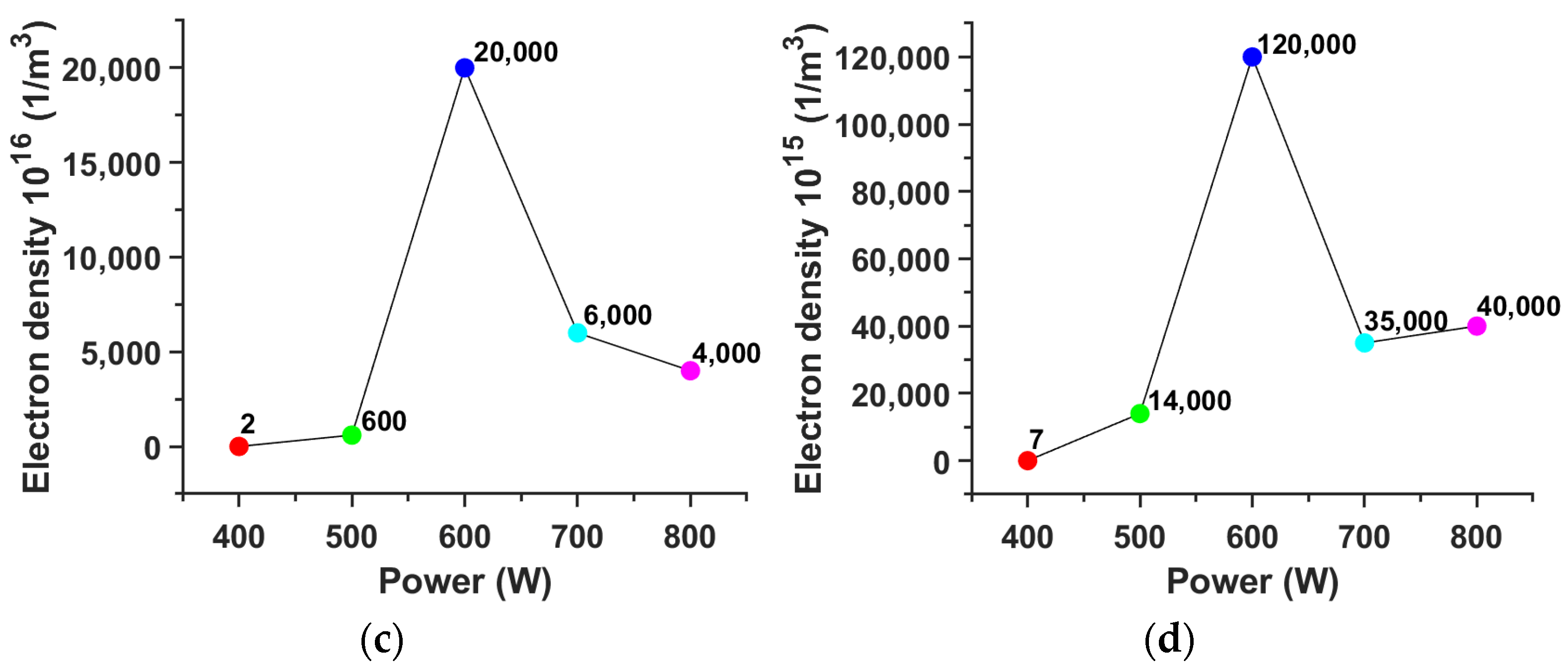

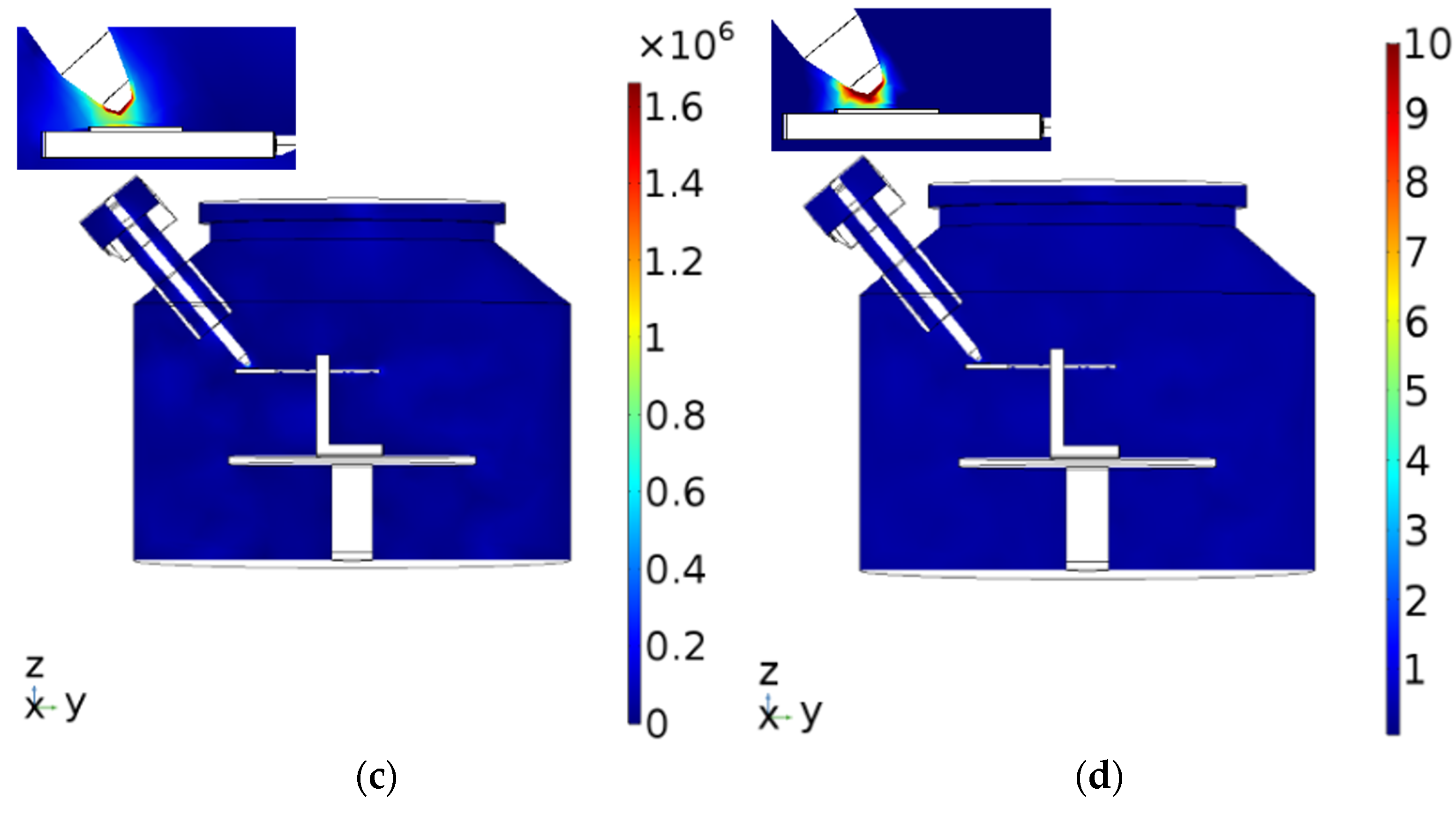

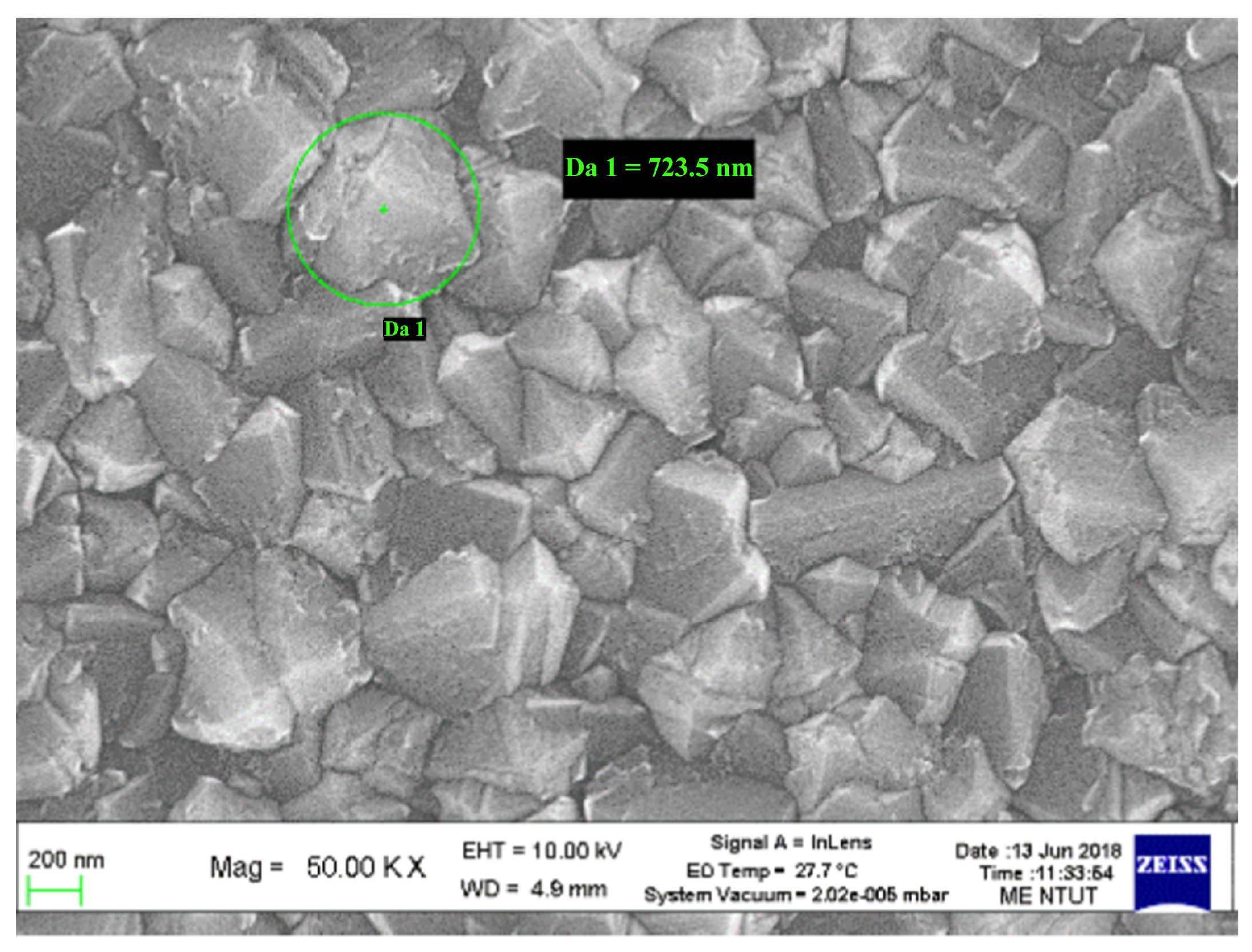
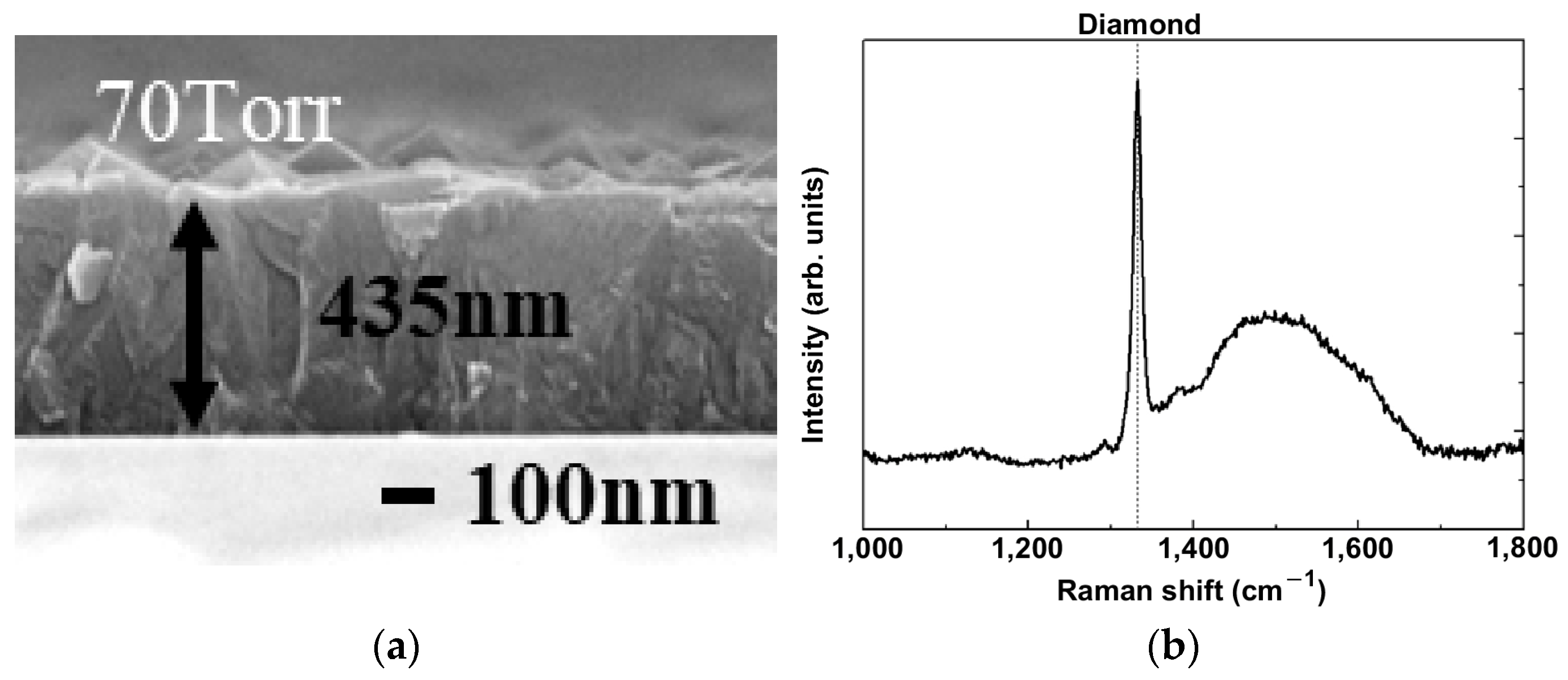
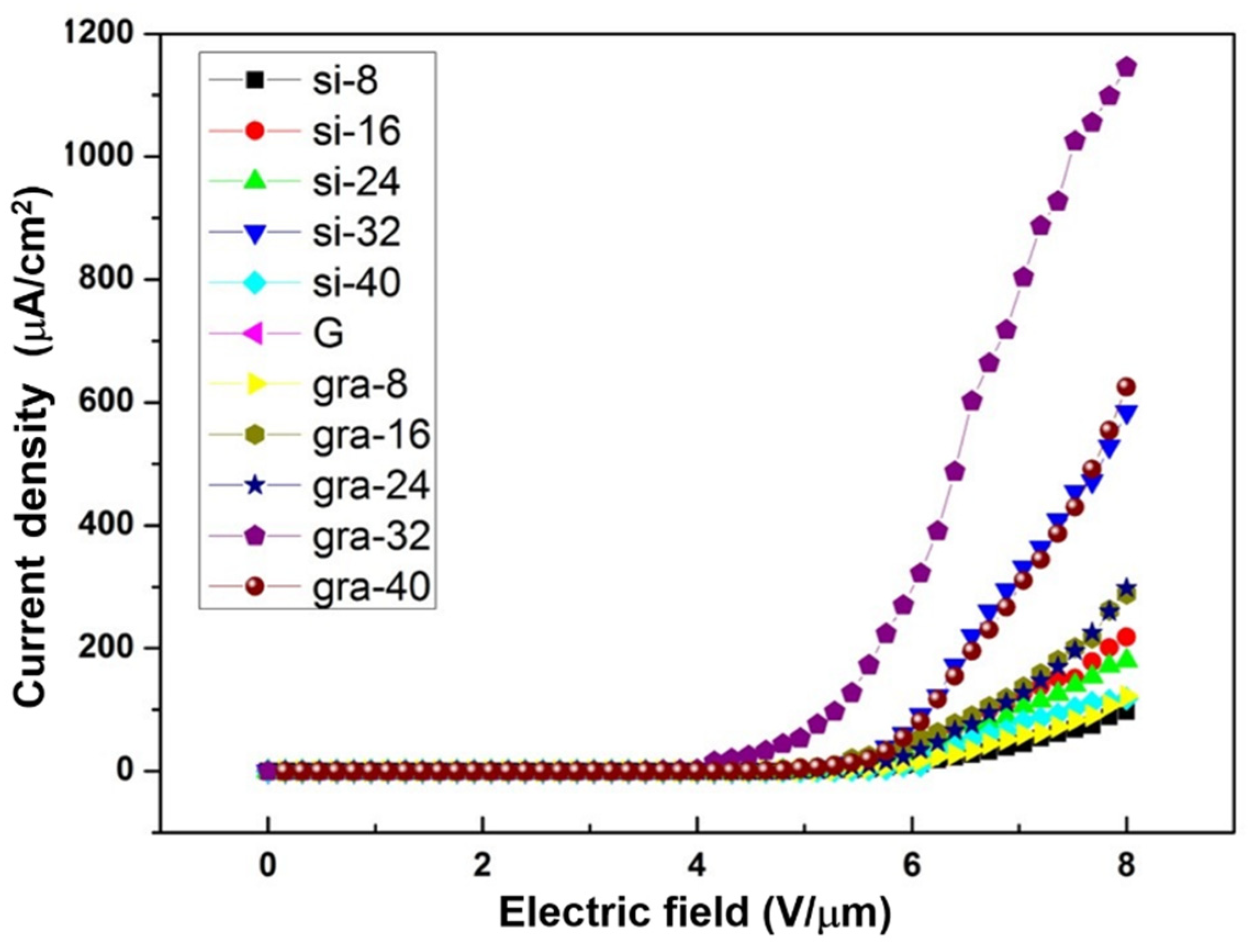

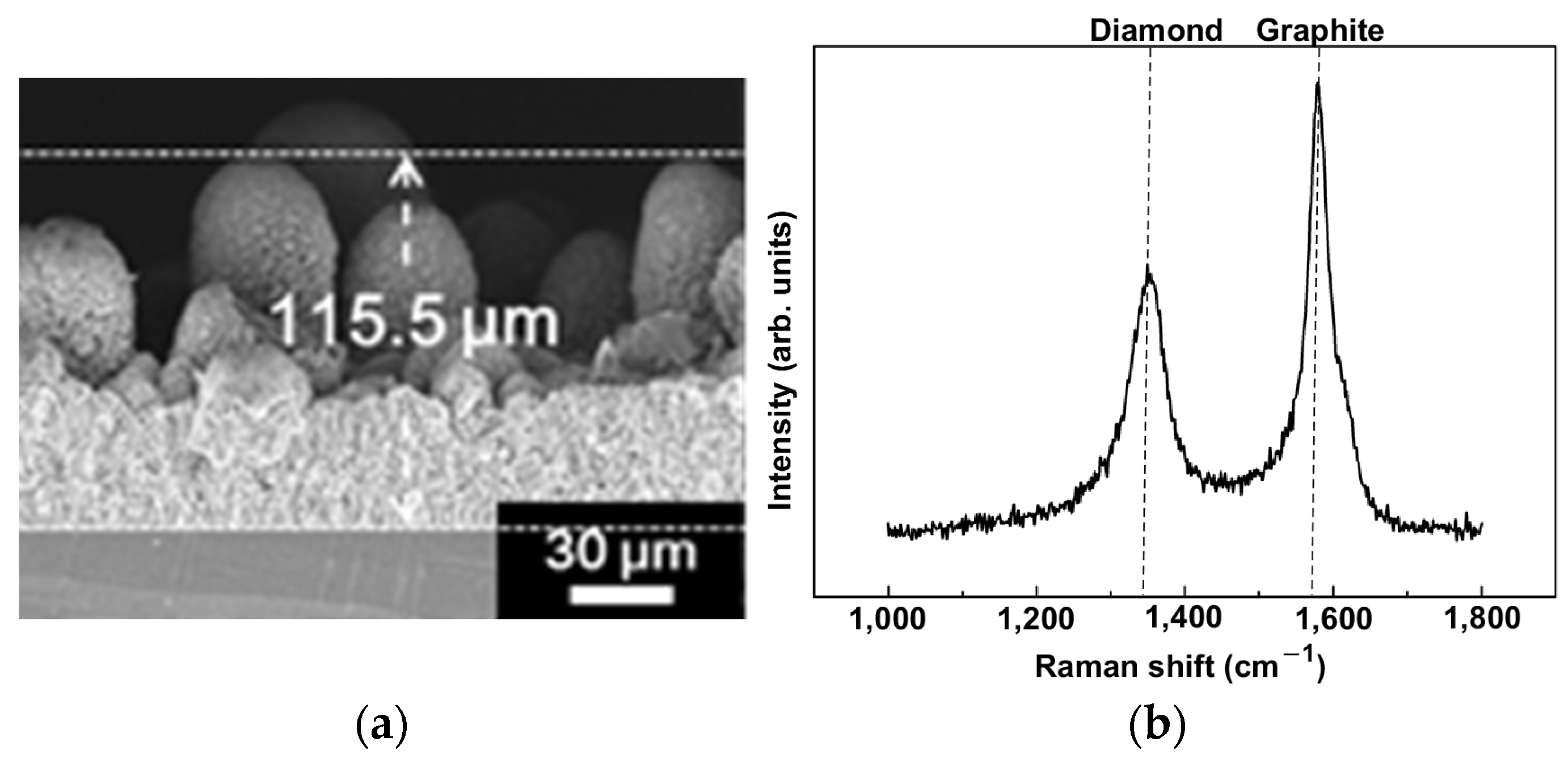
| Formulas | |
|---|---|
| 1 | |
| 2 | |
| 3 | |
| 4 | |
| 5 | |
| 6 | |
| 7 | |
| Formulas | |
|---|---|
| 1 | |
| 2 | |
| 3 | |
| 4 | |
| 5 | |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Hsu, H.-Y.; Yen, J.-S.; Lin, C.-Y.; Liu, C.-W.; Aranganadin, K.; Lin, C.-R.; Sun, J.-S.; Lin, M.-C. Extraordinary Field Emission of Diamond Film Developed on a Graphite Substrate by Microwave Plasma Jet Chemical Vapor Deposition. Appl. Sci. 2023, 13, 2531. https://doi.org/10.3390/app13042531
Hsu H-Y, Yen J-S, Lin C-Y, Liu C-W, Aranganadin K, Lin C-R, Sun J-S, Lin M-C. Extraordinary Field Emission of Diamond Film Developed on a Graphite Substrate by Microwave Plasma Jet Chemical Vapor Deposition. Applied Sciences. 2023; 13(4):2531. https://doi.org/10.3390/app13042531
Chicago/Turabian StyleHsu, Hua-Yi, Jing-Shyang Yen, Chun-Yu Lin, Chi-Wen Liu, Kaviya Aranganadin, Chii-Ruey Lin, Jwo-Shiun Sun, and Ming-Chieh Lin. 2023. "Extraordinary Field Emission of Diamond Film Developed on a Graphite Substrate by Microwave Plasma Jet Chemical Vapor Deposition" Applied Sciences 13, no. 4: 2531. https://doi.org/10.3390/app13042531
APA StyleHsu, H.-Y., Yen, J.-S., Lin, C.-Y., Liu, C.-W., Aranganadin, K., Lin, C.-R., Sun, J.-S., & Lin, M.-C. (2023). Extraordinary Field Emission of Diamond Film Developed on a Graphite Substrate by Microwave Plasma Jet Chemical Vapor Deposition. Applied Sciences, 13(4), 2531. https://doi.org/10.3390/app13042531





