Creep Properties Assessment by Shear Punch Creep Test and IMC Morphology of Aged Pb-Free Solder Joint/UBM
Abstract
:1. Introduction
2. Experimental Section and Preparation of Test Specimens
2.1. Materials and Preparation of Test Specimens
2.2. Experimental Method and Conditions
3. Result and Discussion
3.1. SPCT Displacement-Time Curve
3.2. Power-Law Relationship
3.3. Monkman-Grant Relationship
3.4. Observation of IMC Behavior
4. Conclusions
- Based on the results of the SEM micro images, the thickness of the IMC increased, and the shape of the IMC morphologies changed from round to needle-like with an increase of the aging time. After isothermal aging (200 and 600 h), the IMC (Cu, Ni)6Sn5 phases and the micro voids were found on the solder joint/Cu substrate interface. This means that the brittleness of the solder increased, thus causing the deterioration of mechanical properties.
- The power-law relationship indicated that the stress exponent (n) and creep properties of solder joints decreased with the increase of aging time, and that the values (n) of Sn-4Ag-0.5Cu solder joints are higher than those of Sn-37Pb solder joints. It can thus be confirmed that the creep properties of Sn-4Ag-0.5Cu solder joints are better than those of conventional Sn-37Pb solder joints.
- The Monkman-Grant relationship shows that the exponent value (m) solder joints are close to 1. It can thus be confirmed that the SPCT method is a reliable method, which can be used to evaluate the creep properties of solder joints.
- Based on our results, the obtained mechanical properties of Pb-free Sn-4Ag-0.5Cu solder joints are greater than those of Sn-37Pb solder joints for all isothermal aging time conditions (0, 200, 600 h). In addition, the melting point temperature of Sn-4Ag-0.5Cu solder joints is similar to that of conventional Sn-37Pb solder joints. Therefore, it is possible to use Pb-free Sn-4Ag-0.5Cu solder joints in electrical applications, rather than Sn-37Pb solder joints.
Author Contributions
Funding
Conflicts of Interest
References
- Kotadia, H.R.; Howes, P.D.; Mannan, S.H. A review: On the development of low melting temperature Pb-free solders. Microelectron. Reliab. 2014, 54, 1253–1273. [Google Scholar] [CrossRef]
- Liu, C.-Y.; Hon, M.-H.; Wang, M.-C.; Chen, Y.-R.; Chang, K.-M.; Li, W.-L. Effects of aging time on the mechanical properties of Sn–9Zn–1.5Ag–xBi lead-free solder alloys. J. Alloys Compd. 2014, 582, 229–235. [Google Scholar] [CrossRef]
- Chang, S.Y.; Jain, C.C.; Chuang, T.H.; Feng, L.P.; Tsao, L.C. Effect of addition of TiO2 nanoparticles on the microstructure, microhardness and interfacial reactions of Sn3.5AgXCu solder. Mater. Des. 2011, 32, 4720–4727. [Google Scholar] [CrossRef]
- Tseng, C.-F.; Jill Lee, C.; Duh, J.-G. Roles of Cu in Pb-free solders jointed with electroless Ni(P) plating. Mater. Sci. Eng. A 2013, 574, 60–67. [Google Scholar] [CrossRef]
- Koo, J.; Lee, C.; Hong, S.J.; Kim, K.-S.; Lee, H.M. Microstructural discovery of Al addition on Sn–0.5Cu-based Pb-free solder design. J. Alloys Compd. 2015, 650, 106–115. [Google Scholar] [CrossRef]
- Khodabakhshi, F.; Sayyadi, R.; Javid, N.S. Lead free Sn-Ag-Cu solders reinforced by Ni-coated graphene nanosheets prepared by mechanical alloying: Microstructural evolution and mechanical durability. Mater. Sci. Eng. A 2017, 702, 371–385. [Google Scholar] [CrossRef]
- Sun, P.; Andersson, C.; Wei, X.; Cheng, Z.; Shangguan, D.; Liu, J. High temperature aging study of intermetallic compound formation of Sn–3.5Ag and Sn–4.0Ag–0.5Cu solders on electroless Ni(P) metallization. J. Alloys Compd. 2006, 425, 191–199. [Google Scholar] [CrossRef]
- Islam, M.N.; Chan, Y.C.; Sharif, A.; Rizvi, M.J. Effect of 9 wt.% in addition to Sn3.5Ag0.5Cu solder on the interfacial reaction with the Au/NiP metallization on Cu pads. J. Alloys Compd. 2005, 396, 217–223. [Google Scholar] [CrossRef]
- Sun, F.; Hochstenbach, P.; Van Driel, W.D.; Zhang, G.Q. Fracture morphology and mechanism of IMC in Low-Ag SAC Solder/UBM (Ni(P)-Au) for WLCSP. Microelectron. Reliab. 2008, 48, 1167–1170. [Google Scholar] [CrossRef]
- Hou, F.; Xu, H.; Wang, Y.; Zhang, L. Determination of creep property of 1.25Cr0.5Mo pearlitic steels by small punch test. Eng. Fail. Anal. 2013, 28, 215–221. [Google Scholar] [CrossRef]
- Mahmudi, R.; Maraghi, A. Shear punch creep behavior of cast lead-free solders. Mater. Sci. Eng. A 2014, 599, 180–185. [Google Scholar] [CrossRef]
- Guduru, R.K.; Darling, K.A.; Kishore, R.; Scattergood, R.O.; Koch, C.C.; Murty, K.L. Evaluation of mechanical properties using shear–punch testing. Mater. Sci. Eng. A 2005, 395, 307–314. [Google Scholar] [CrossRef]
- Dobeš, F.; Milička, K. Application of creep small punch testing in assessment of creep lifetime. Mater. Sci. Eng. A 2009, 510–511, 440–443. [Google Scholar] [CrossRef]
- Liu, L.; Zhou, W.; Li, B.; Wu, P. Interfacial reactions between Sn–8Zn–3Bi–xNi lead-free solders and Cu substrate during isothermal aging. Mater. Chem. Phys. 2010, 123, 629–633. [Google Scholar] [CrossRef]
- Komazaki, S. Evaluation of creep rupture strength of high nitrogen ferritic heat-resistant steels using small punch creep testing technique. Mater. Sci. Eng. A 2016, 676, 100–108. [Google Scholar] [CrossRef]
- Nakata, T.; Komazaki, S.; Kohno, Y.; Tanigawa, H. Development of a small punch testing method to evaluate the creep property of high Cr ferritic steel: Part I—Effect of atmosphere on creep deformation behavior. Mater. Sci. Eng. A 2016, 666, 54–60. [Google Scholar] [CrossRef]
- Chen, Y.J.; Chung, C.K.; Yang, C.R.; Kao, C.R. Single-joint shear strength of micro Cu pillar solder bumps with different amounts of intermetallics. Microelectron. Reliab. 2013, 53, 47–52. [Google Scholar] [CrossRef]
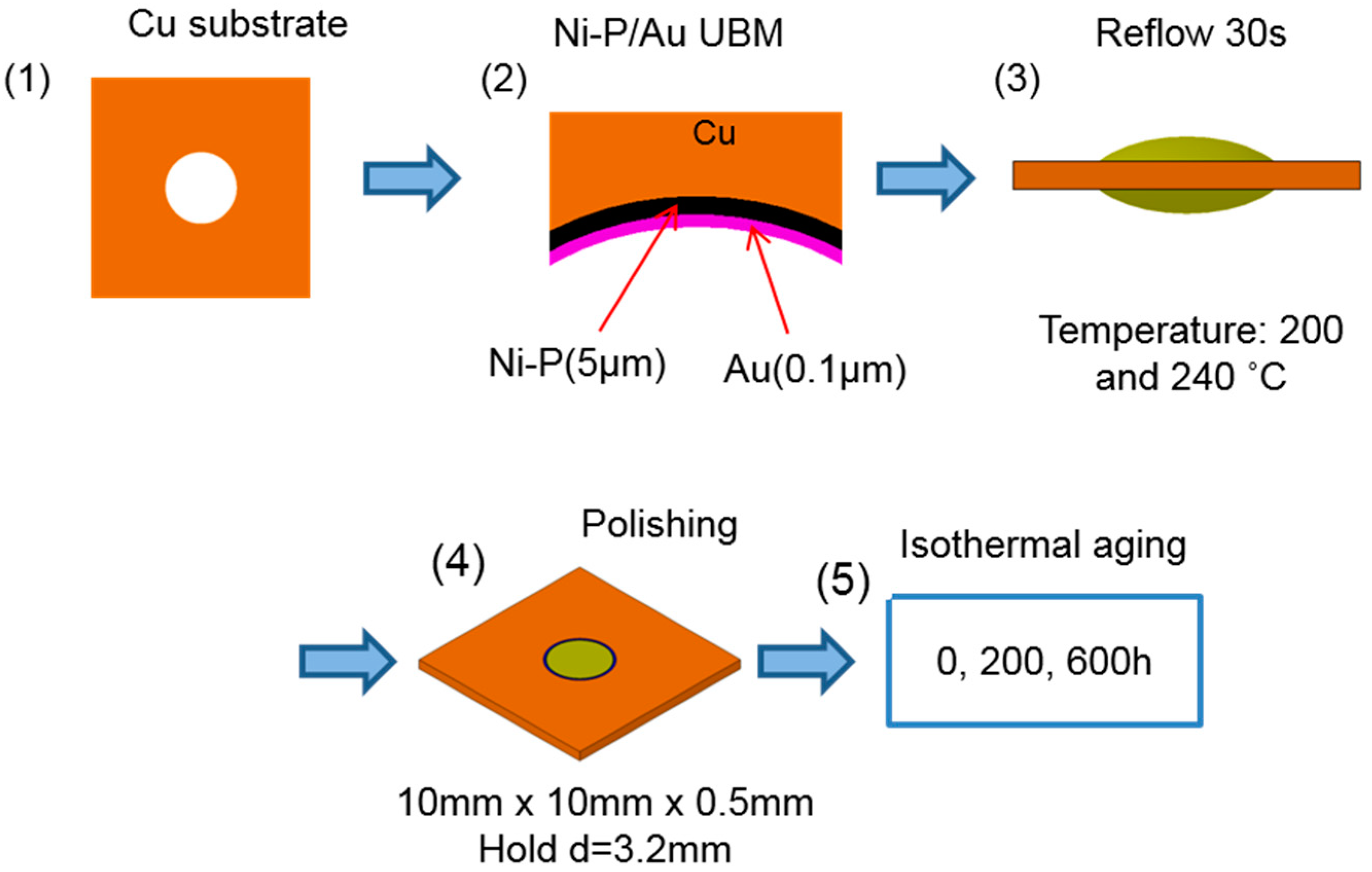
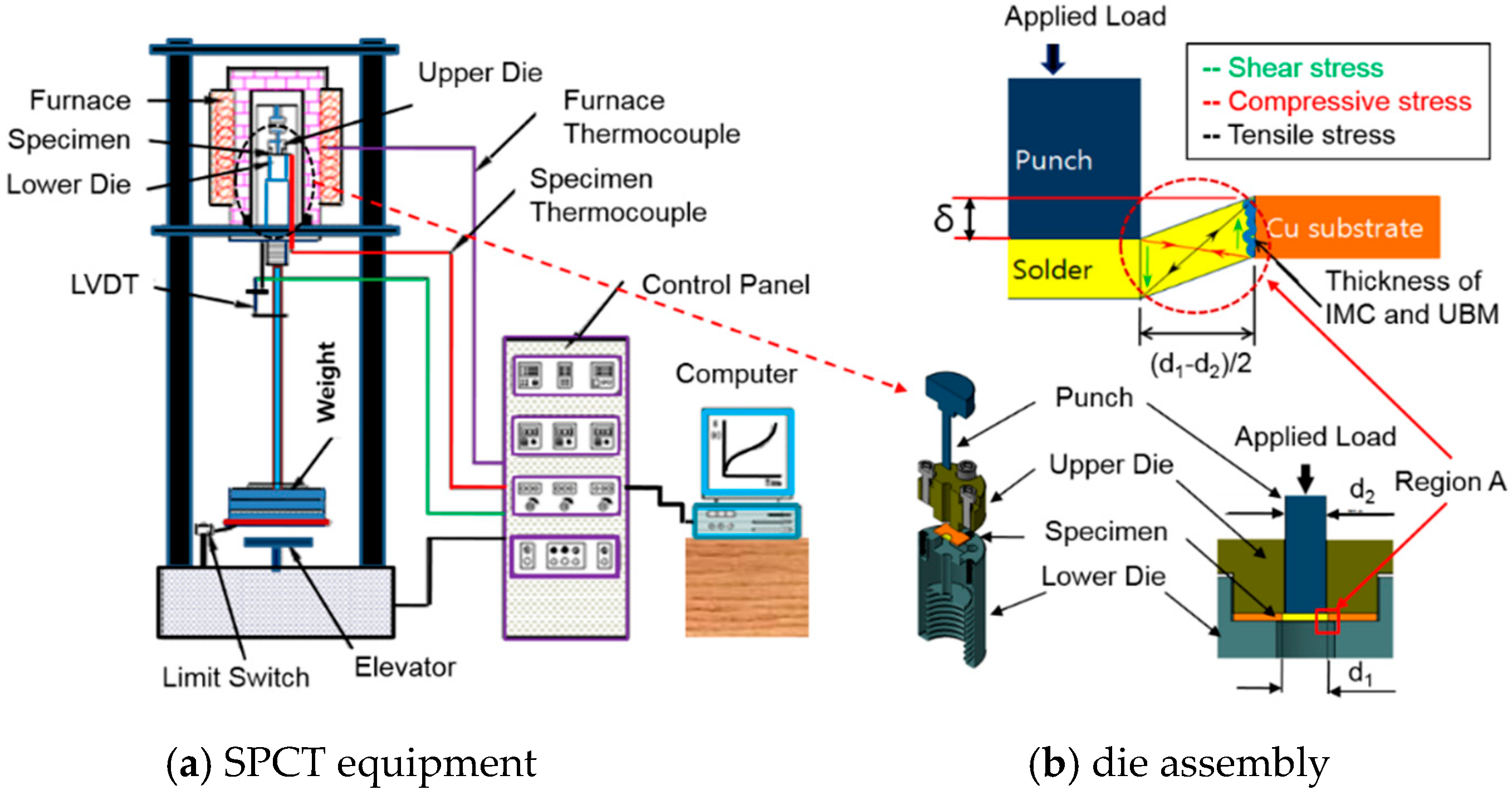

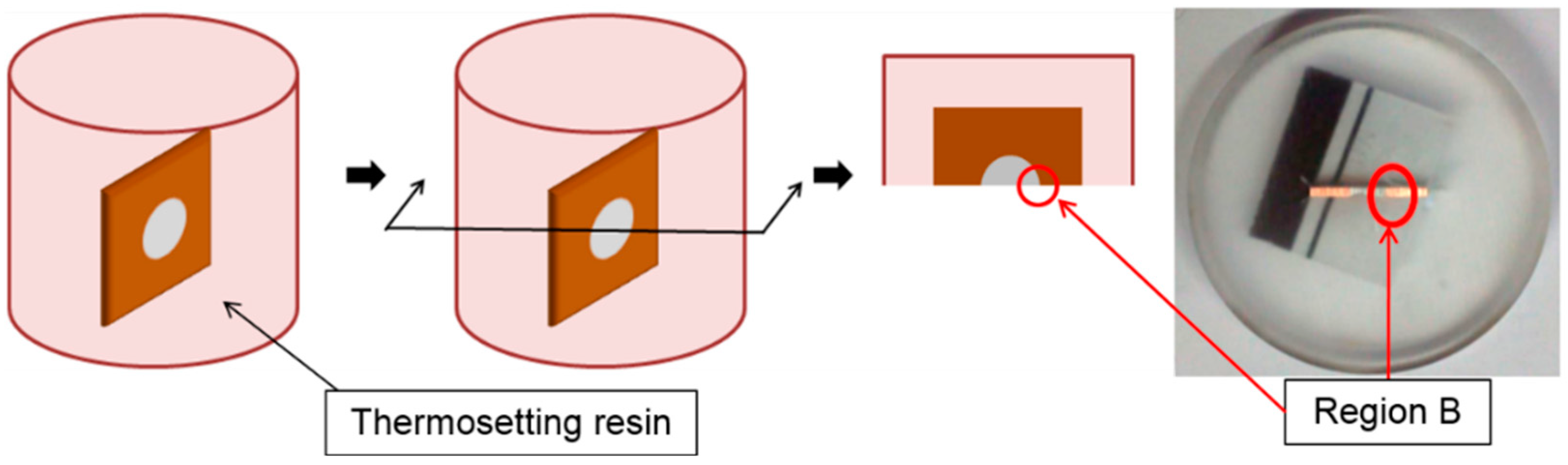


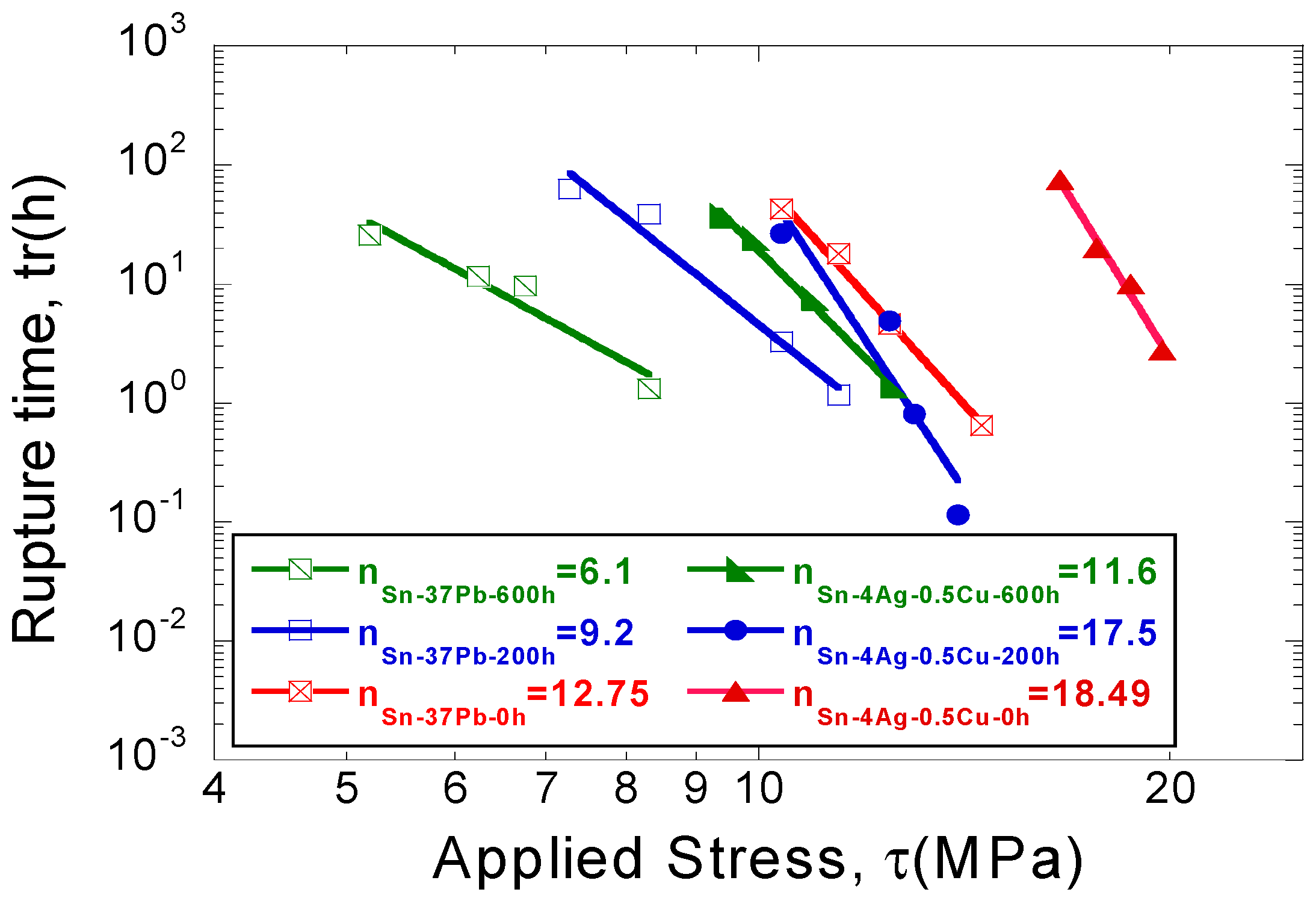



| Solder Joint | Chemical Composition (wt. %) | |||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| Sn | Pb | Sb | Cu | Bi | Zn | Fe | Al | As | Cd | Ag | Ni | |
| Sn-37Pb | 62–64 | Bal- | 0.10 | 0.03 | 0.03 | 0.002 | 0.02 | 0.002 | 0.03 | 0.002 | 0.002 | 0.01 |
| Sn-4Ag-0.5Cu | Bal- | 0.05 | 0.10 | 0.50 | 0.03 | 0.002 | 0.02 | 0.002 | 0.03 | 0.002 | 4.00 | 0.01 |
| Material | SPCT Method | ||||
|---|---|---|---|---|---|
| Solder Joint | Melting Point Temp (°C) | Reflow Condition | SPCT Temp (°C) | Aging Time (h) and Temp (°C) | |
| Reflow Temp (°C) | Reflow Time (s) | ||||
| Sn-37Pb | 183 | 200 (±5) | 30 | 30 | 0, 200, 600 (At 150 °C) |
| Sn-4Ag-0.5Cu | 223 | 240 (±5) | |||
© 2019 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Hai, S.; Yu, H.-S. Creep Properties Assessment by Shear Punch Creep Test and IMC Morphology of Aged Pb-Free Solder Joint/UBM. Metals 2019, 9, 209. https://doi.org/10.3390/met9020209
Hai S, Yu H-S. Creep Properties Assessment by Shear Punch Creep Test and IMC Morphology of Aged Pb-Free Solder Joint/UBM. Metals. 2019; 9(2):209. https://doi.org/10.3390/met9020209
Chicago/Turabian StyleHai, Sophal, and Hyo-Sun Yu. 2019. "Creep Properties Assessment by Shear Punch Creep Test and IMC Morphology of Aged Pb-Free Solder Joint/UBM" Metals 9, no. 2: 209. https://doi.org/10.3390/met9020209
APA StyleHai, S., & Yu, H.-S. (2019). Creep Properties Assessment by Shear Punch Creep Test and IMC Morphology of Aged Pb-Free Solder Joint/UBM. Metals, 9(2), 209. https://doi.org/10.3390/met9020209




