Fabrication of Vacuum-Sealed Capacitive Micromachined Ultrasonic Transducer Arrays Using Glass Reflow Process
Abstract
:1. Introduction
2. Device Structure and Working Principle
3. Experiments
3.1. Fabrication Process
3.2. Mesurement Setup
3.3. Measurement Results
4. Conclusions
Acknowledgments
Author Contributions
Conflicts of Interest
References
- Yakub, B.T.K.; Oralkan, O. Capacitive micromachined ultrasonic transducers for medical imaging and therapy. J. Micromech. Microeng. 2011, 21, 054004. [Google Scholar] [CrossRef] [PubMed]
- Cheng, X.; Chen, J.; Li, C. A miniature capacitive micromachined ultrasonic transducer array for minimally invasive photocoustic imaging. J. Microelectromech. Syst. 2010, 19, 1002–1011. [Google Scholar] [CrossRef]
- Lee, H.J.; Park, K.K.; Kupnik, M.; Oralkan, O.; Yakub, B.T.K. Highly Sensitive Detection of DMMP Using a CMUT-Based Chemical Sensor. In Proceedings of the IEEE Sensors 2010, Kona, HI, USA, 1–4 November 2010; pp. 2122–2126.
- Ladabaum, I.; Jin, X.; Soh, H.T.; Atalar, A.; Yakub, B.T.K. Surface micromachined capacitive ultrasonic transducers. IEEE Trans. Ultrason. Ferroeletr. Freq. Control 1998, 3, 678–690. [Google Scholar] [CrossRef] [PubMed]
- Bagolini, A.; Savoia, A.S.; Picciotto, A.; Boscardin, M.; Bellutti, P.; Lamberti, N.; Caliano, G. PECVD low stress silicon nitride analysis and optimization for the fabrication of CMUT devices. J. Micromech. Microeng. 2015, 25, 015012. [Google Scholar] [CrossRef]
- Huang, Y.; Ergun, A.S.; Haggstrom, E.; Badi, M.H.; Yakub, B.T.K. Fabricating capacitive micromachined ultrasonic transducers with wafer-bonding technology. J. Microelectromech. Syst. 2003, 12, 128–137. [Google Scholar] [CrossRef]
- Mukhiya, R.; Aditi; Prabakar, K.; Raghuramaiah, M.; Jayapandian, J.; Gopal, R.; Khanna, V.K.; Shekhar, C. Fabrication of capacitive micromachined ultrasonic transducer arrays with isolation trenches using anodic wafer bonding. IEEE Sens. J. 2015, 15, 5177–5184. [Google Scholar] [CrossRef]
- Haque, R.M.; Wise, K.D. A glass-in-silicon reflow process for three-dimensional microsystems. J. Microelectromech. Syst. 2013, 22, 1470–1477. [Google Scholar] [CrossRef]
- Toan, N.V.; Sangu, S.; Inomata, N.; Ono, T. Glass capillaries based on a glass reflow into nano-trench for controlling light transmission. Microsyst. Technol. 2015. [Google Scholar] [CrossRef]
- Lee, K.I.; Lim, B.; Oh, S.W.; Kim, S.H.; Lee, C.S.; Cho, J.W.; Hong, Y. Fabrication of High Aspect Ratio Insulating Nozzle Using Glass Reflow Process and its Electrohydrodynamic Printing Characteristics. In Proceedings of the IEEE 27th International Conference on Micro Electro Mechanical Systems (MEMS 2014), San Francisco, CA, USA, 26–30 January 2014; pp. 963–966.
- Beeby, S.; Ensell, G.; Kraft, M.; White, N. MEMS Mechanical Sensor; Artech House: Norwood, MA, USA, 2004. [Google Scholar]
- Allen, J.J. Micro Electro Mechanical System Design; Taylor and Francis Group: Boca Raton, FL, USA, 2005. [Google Scholar]
- Tiwari, S.K.; Satyanarayana, B.S.; Pai, A.G.; Trivedi, K.K. Circular capacitance micromachined ultrasonic transducer. Def. Sci. J. 2009, 59, 627–633. [Google Scholar] [CrossRef]
- Wygant, I.O.; Kupnik, M. Analytically Calculating Membrane Displacement and the Equivalent Circuit Model of a Circular CMUT Cell. In Proceedings of the IEEE International Ultrasonics Symposium, Beijing, China, 2–5 November 2008; pp. 2111–2114.
- Samarao, A.K.; Ayazi, F. Temperature Compensation of Silicon Micromechanical Resonator via Degenerate Doping. In Proceedings of the 2009 IEEE International Electron Devices Meeting (IEDM), Baltimore, MD, USA, 7–9 December 2009; pp. 1–4.
- Ergun, A.S.; Yaralioglu, G.G.; Yakub, B.T.K. Capacitive micromachined ultrasonic transducers: Theory and technology. J. Aerosp. Eng. 2003, 16, 76–84. [Google Scholar] [CrossRef]
- Toan, N.V.; Toda, M.; Ono, T. Investigation of processes for glass micromachining. Micromachines 2016, 7, 51. [Google Scholar] [CrossRef]
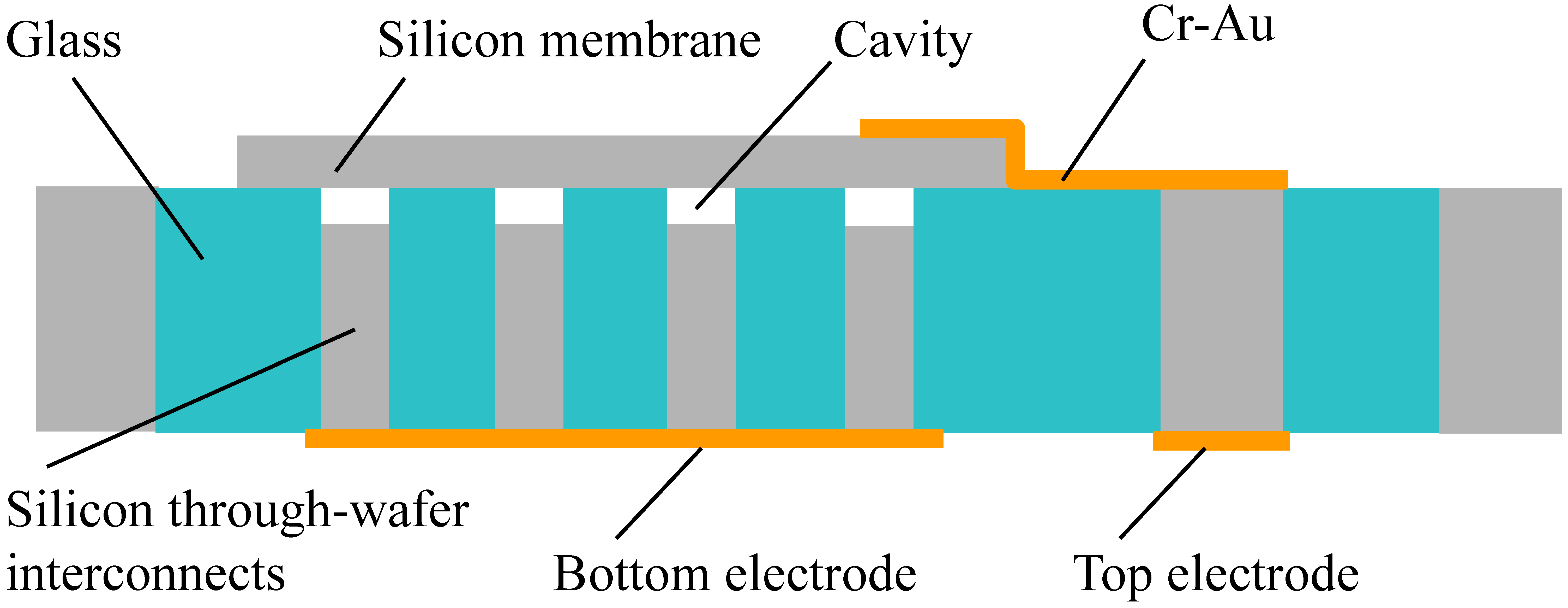
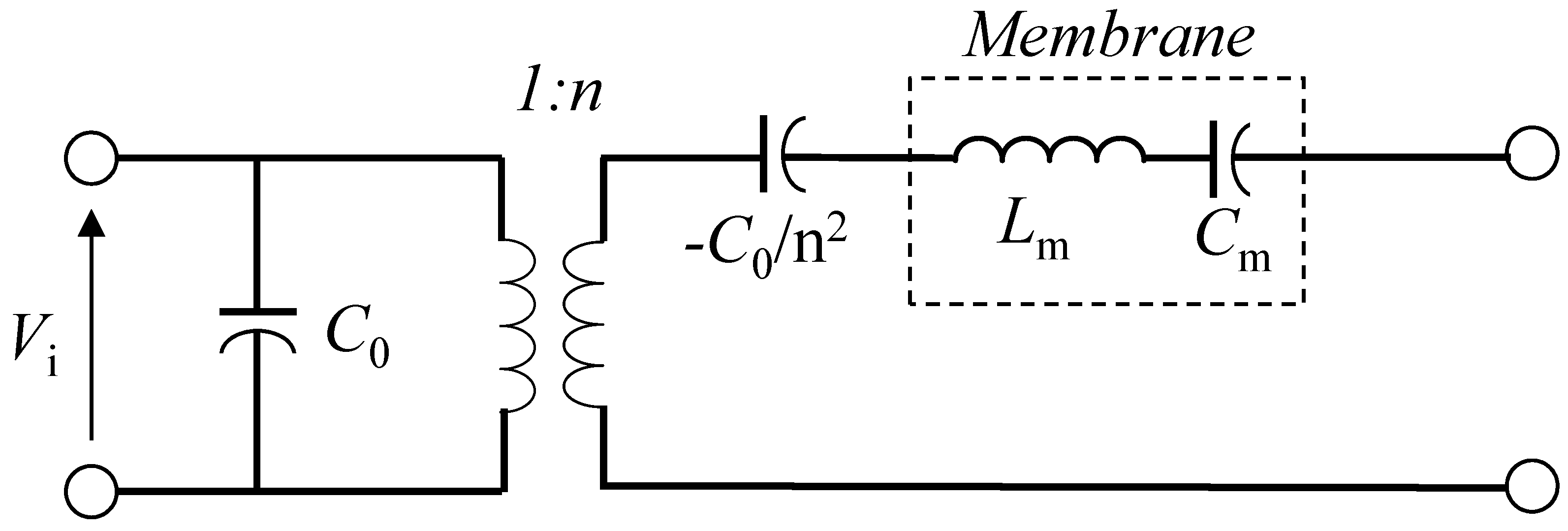
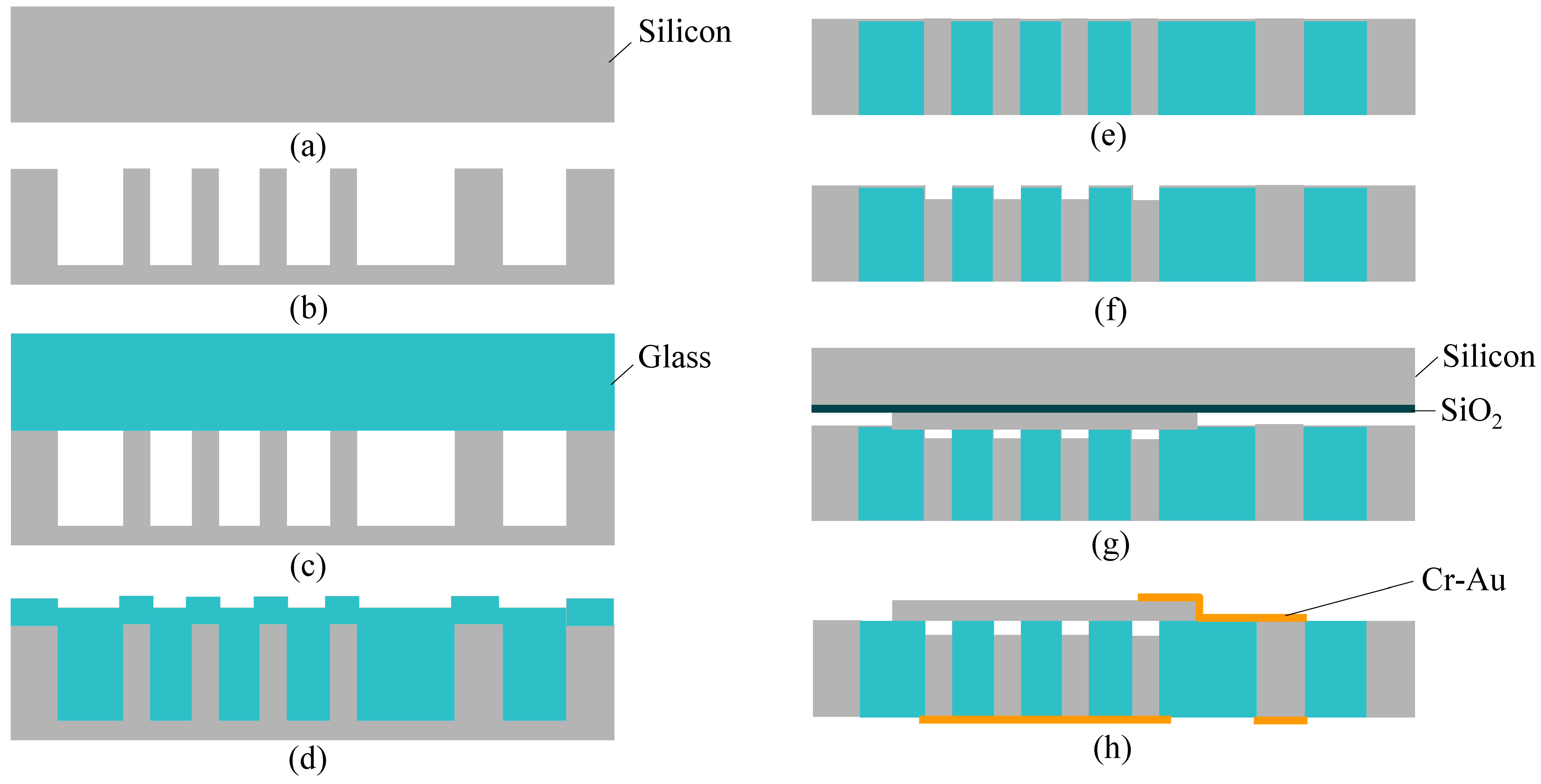
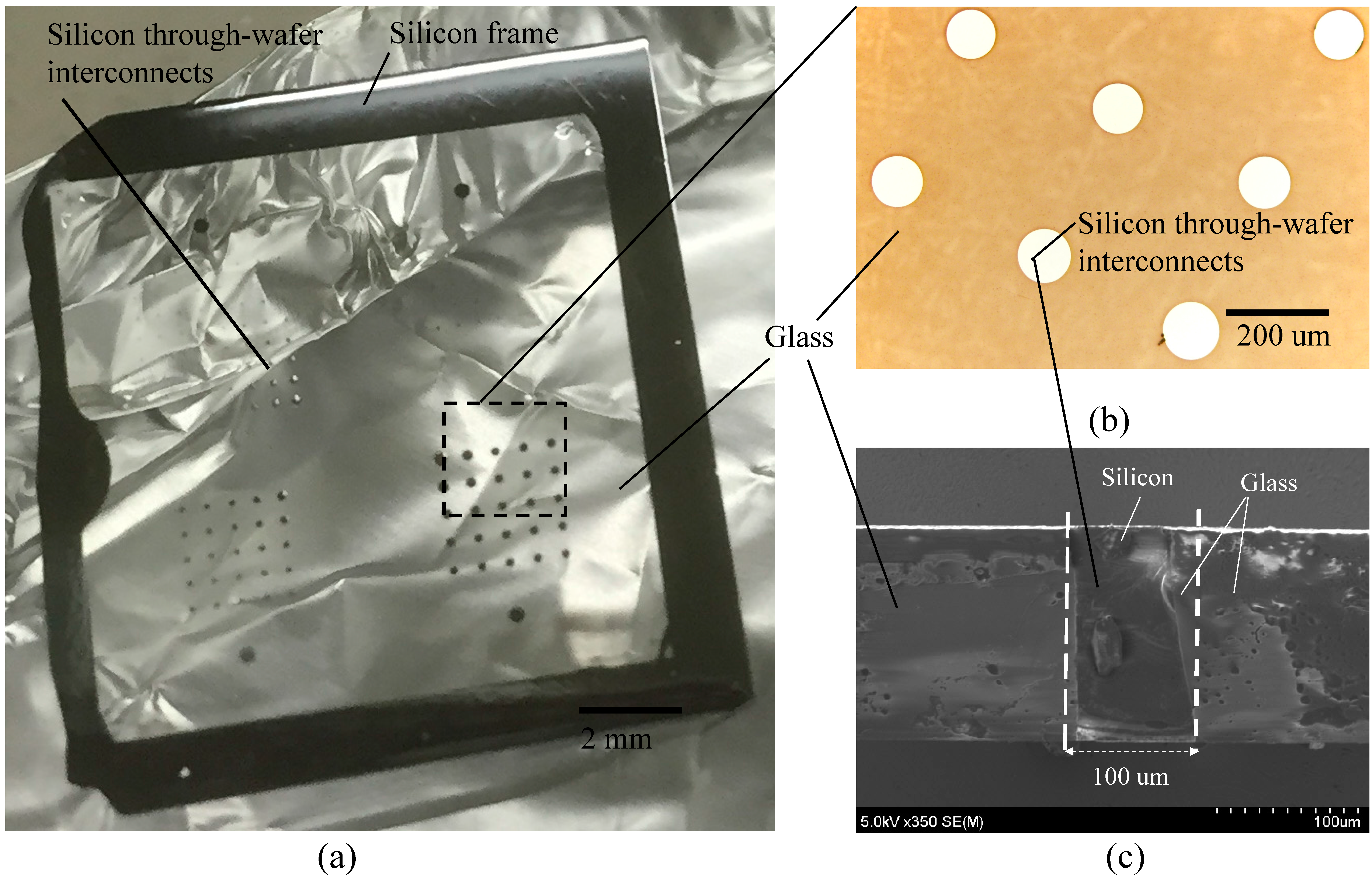

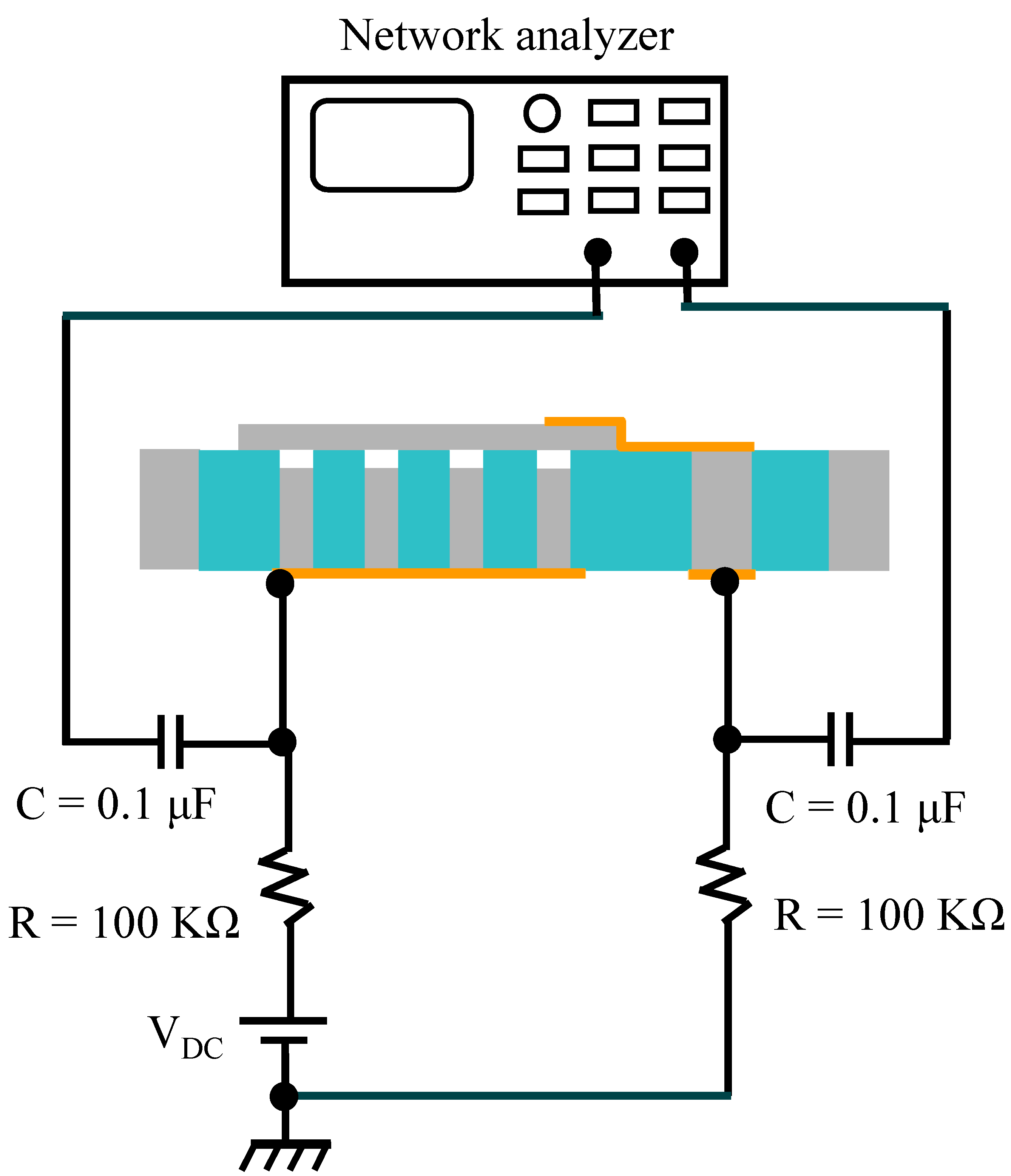
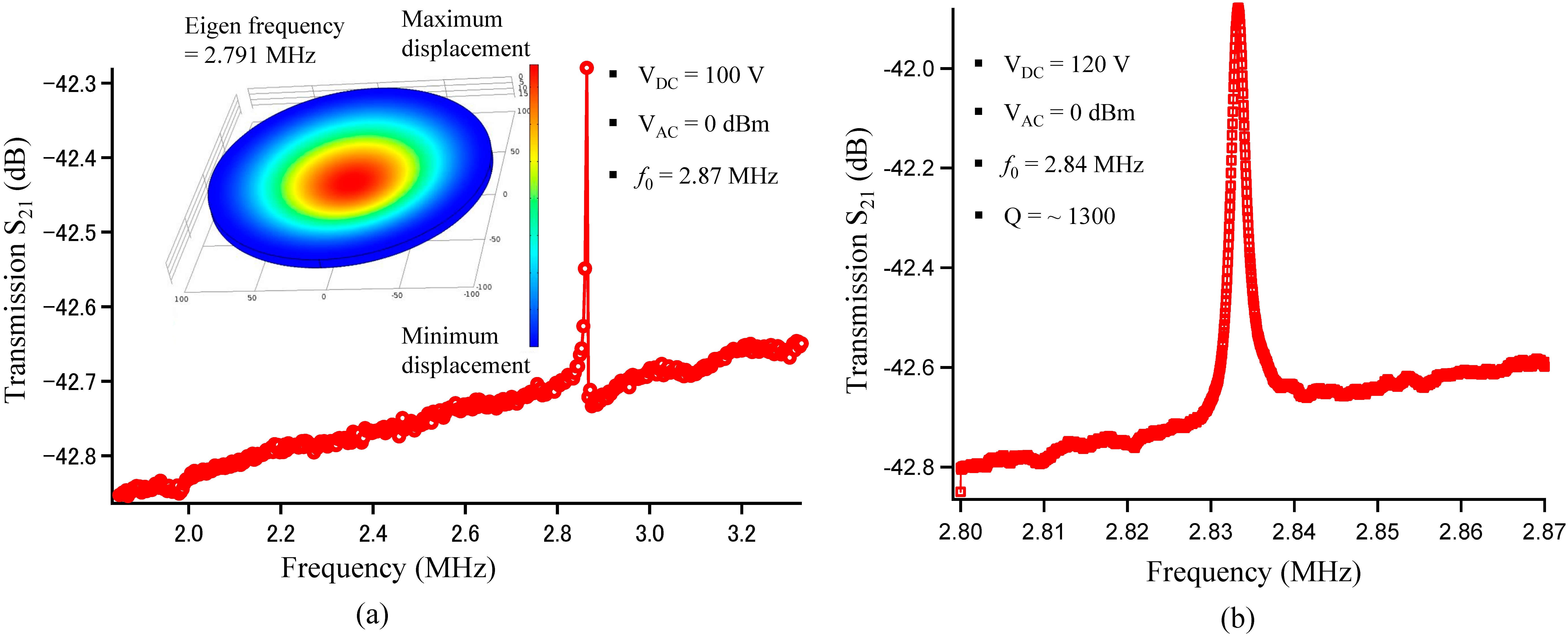
| Parameters | Values |
| Membrane size (radius of membrane) | 100 μm |
| Membrane thickness | 7 μm |
| Array | 5 × 5 |
| Sensing gap | 3.2 μm |
| Applied conditions | Values |
| Polarization voltage (VDC) | 120 V |
| Alternating voltage (VAC) | 0 dBm |
| Pressure level of chamber | 0.01 Pa |
| Resonant frequency (Calculation) | Value |
| Resonant frequency | 2.88 MHz |
| FEM simulation | Value |
| Resonant frequency | 2.79 MHz |
| Measurement results | Values |
| Resonant frequency | 2.84 MHz |
| Q factor | 1300 |
© 2016 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC-BY) license ( http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Toan, N.V.; Hahng, S.; Song, Y.; Ono, T. Fabrication of Vacuum-Sealed Capacitive Micromachined Ultrasonic Transducer Arrays Using Glass Reflow Process. Micromachines 2016, 7, 76. https://doi.org/10.3390/mi7050076
Toan NV, Hahng S, Song Y, Ono T. Fabrication of Vacuum-Sealed Capacitive Micromachined Ultrasonic Transducer Arrays Using Glass Reflow Process. Micromachines. 2016; 7(5):76. https://doi.org/10.3390/mi7050076
Chicago/Turabian StyleToan, Nguyen Van, Shim Hahng, Yunheub Song, and Takahito Ono. 2016. "Fabrication of Vacuum-Sealed Capacitive Micromachined Ultrasonic Transducer Arrays Using Glass Reflow Process" Micromachines 7, no. 5: 76. https://doi.org/10.3390/mi7050076
APA StyleToan, N. V., Hahng, S., Song, Y., & Ono, T. (2016). Fabrication of Vacuum-Sealed Capacitive Micromachined Ultrasonic Transducer Arrays Using Glass Reflow Process. Micromachines, 7(5), 76. https://doi.org/10.3390/mi7050076








