Effect of Acceptor Traps in GaN Buffer Layer on Breakdown Performance of AlGaN/GaN HEMTs
Abstract
1. Introduction
2. Computational Framework
3. Effect of Traps in the Whole Buffer Layer
3.1. Effect of Traps in the Access-D Region
3.2. Effect of Traps in the Access-G Region
3.3. Effect of Traps in the Access-S Region
3.4. Comparison of Leakage Current When Traps Are Introduced in Different Regions
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Zhang, Y.; Huang, S.; Wei, K.; Zhang, S.; Wang, X.; Zheng, Y.; Liu, G.; Chen, X.; Li, Y.; Liu, X. Millimeter-Wave AlGaN/GaN HEMTs with 43.6% Power-Added-Efficiency at 40 GHz Fabricated by Atomic Layer Etching Gate Recess. IEEE Electron Device Lett. 2020, 41, 701–704. [Google Scholar] [CrossRef]
- Jarndal, A.; Kompa, G.A. new small-signal modeling approach applied to GaN devices. IEEE Trans. Microw. Theory Tech. 2005, 53, 3440–3448. [Google Scholar] [CrossRef]
- Yadav, Y.K.; Upadhyay, B.B.; Meer, M.; Bhardwaj, N.; Ganguly, S.; Saha, D. Ti/Au/Al/Ni/Au Low Contact Resistance and Sharp Edge Acuity for Highly Scalable AlGaN/GaN HEMTs. IEEE Electron Device Lett. 2019, 40, 67–70. [Google Scholar] [CrossRef]
- Albahrani, S.A.; Heuken, L.; Schwantuschke, D.; Gneiting, T.; Burghartz, J.N.; Khandelwal, S. Consistent Surface-Potential-Based Modeling of Drain and Gate Currents in AlGaN/GaN HEMTs. IEEE Trans. Electron Devices 2020, 67, 455–462. [Google Scholar] [CrossRef]
- Ohno, Y.; Nakao, T.; Kishimoto, S.; Maezawa, K.; Mizutani, T. Effects of surface passivation on breakdown of AlGaN/GaN high-electron-mobility transistor. Appl. Phys. Lett. 2004, 84, 2184–2186. [Google Scholar] [CrossRef]
- Lyons, J.L.; Janotti, A.; Walle, C.G. Effects of carbon on the electrical and optical properties of InN, GaN, and AlN. Phys. Rev. B 2014, 89, 035204. [Google Scholar] [CrossRef]
- Fariza, A.; Lesnik, A.; Bläsing, J.; Hoffmann, M.P.; Horich, F.; Veit, P.; Witte, H.; Dadgar, A.; Strittmater, A. On reduction of current leakage in GaN by carbon-doping. Appl. Phys. Lett. 2016, 109, 212102. [Google Scholar] [CrossRef]
- Uren, M.J.; Caesar, M.; Karboyan, S.; Moens, P.; Vanmeerbeek, p.; Kuball, M. Electric field reduction in C-doped AlGaN/GaN on Si high electron mobility transistors. IEEE Electron Device Lett. 2015, 36, 826–828. [Google Scholar] [CrossRef]
- Uren, M.J.; Moreke, J.; Kuball, M. Buffer design to minimize current collapse in GaN/AlGaN HFETs. IEEE Trans. Electron Devices 2012, 59, 3327–3333. [Google Scholar] [CrossRef]
- Bahat-Treidel, E.; Brunner, F.; Hilt, O.; Cho, E.; Wurfl, J.; Trankle, G. AlGaN/GaN/GaN: C Back-Barrier HFETs With Breakdown Voltage of Over 1 kV and Low RON × A. IEEE Trans. Electron Devices 2010, 57, 3050–3058. [Google Scholar] [CrossRef]
- Zhu, L.; Wang, J.; Jiang, H.; Wang, H.; Wu, W.; Zhou, Y.; Dai, G. Theoretical analysis of buffer trapping effects on off-state breakdown between gate and drain in AlGaN/GaN HEMTs. In Proceedings of the 2016 International Conference on Integrated Circuits and Microsystems (ICICM), Chengdu, China, 23–25 November 2016; pp. 33–36. [Google Scholar]
- Joshi, V.; Gupta, S.D.; Chaudhuri, R.R.; Shrivastava, M. Interplay between surface and buffer traps in governing breakdown characteristics of AlGaN/GaN HEMTs—Part II. IEEE Trans. Electron Devices 2020, 68, 80–87. [Google Scholar] [CrossRef]
- Silvaco Inc. ATLAS Device Simulation Software; Silvaco Inc.: Santa Clara, CA, USA, 2022. [Google Scholar]
- Pattnaik, G.; Mohapatra, M. Comparison Of DC & RF Characteristics of AlGaN/GaN HEMT Using Different Surface Passivation Materials. In Proceedings of the 2021 IEEE 2nd International Conference on Applied Electromagnetics, Signal Processing, & Communication (AESPC), Bhubaneswar, India, 26–28 November 2021; pp. 1–5. [Google Scholar]
- Miccoli, C.; Cerantonio, V.; Chini, A.; Iucolano, F. T-CAD simulations study on drain leakage current and its correlation with gate current for AlGaN/GaN HEMTs. In Proceedings of the IEEE 8th Workshop on Wide Bandgap Power Devices and Applications (WiPDA), Redondo Beach, CA, USA, 7–9 November 2021; pp. 255–258. [Google Scholar]
- Tang, N.; Shen, B.; Zheng, Z.W.; Liu, J.; Chen, D.J.; Lu, J.; Zhang, R.; Shi, Y.; Zheng, Y.D. Magnetoresistance oscillations induced by intersubband scattering of two-dimensional electron gas in Al0.22Ga0.78N/GaN heterostructures. J. Appl. Phys. 2003, 94, 5420–5422. [Google Scholar] [CrossRef]
- Albrecht, J.D.; Wang, R.P.; Ruden, P.P. Electron transport characteristics of GaN for high temperature device modeling. J. Appl. Phys. 1998, 83, 4777–4781. [Google Scholar] [CrossRef]
- Farahmand, M.; Garetto, C.; Bellotti, E.; Brennan, K.F.; Goano, M.; Ghillino, E.; Ghione, G.; Albrecht, J.D.; Ruden, P.P. Monte Carlo simulation of electron transport in the III-nitride wurtzite phase materials system: Binaries and ternaries. IEEE Trans. Electron Devices 2001, 48, 535–542. [Google Scholar] [CrossRef]
- Lu, M.; Chen, Y.; Liao, M.; Liu, C.; Zheng, S.; Gao, K. Degradation mechanism of D-mode GaN HEMT based on high temperature reverse bias stress. In Proceedings of the IEEE Workshop on Wide Bandgap Power Devices and Applications in Asia, Wuhan, China, 25–27 August 2021; pp. 167–170. [Google Scholar]
- Dhar, S.; Ghosh, S. Low field electron mobility in GaN. J. Appl. Phys. 1999, 86, 2668–2676. [Google Scholar] [CrossRef]
- Ahmeda, K.; Ubochi, B.; Kalna, K.; Benbakhti, B.; Duffy, S.J.; Zhang, W.; Soltani, A. Self-heating and polarization effects in AlGaN/AlN/GaN/AlGaN based devices. In Proceedings of the European Microwave Integrated Circuits Conference, Nuremberg, Germany, 8–10 October 2017; pp. 37–40. [Google Scholar]
- Duan, B.; Yuan, J.; Wang, Y.; Yang, L.; Yang, Y. Novel Enhance-Mode AlGaN/GaN JFET With BV of Over 1.2 kV Maintaining Low RON, sp. IEEE Trans. Electron Devices 2022, 69, 1200–1205. [Google Scholar] [CrossRef]
- Karmalkar, S.; Mishra, U.K. Enhancement of breakdown voltage in AlGaN/GaN high electron mobility transistors using a field plate. IEEE Trans. Electron Devices 2001, 48, 1515–1521. [Google Scholar] [CrossRef]
- Hanawa, H.; Onodera, H.; Nakajima, A.; Horio, K. Numerical Analysis of Breakdown Voltage Enhancement in AlGaN/GaN HEMTs with a High-k Passivation Layer. IEEE Trans. Electron Devices 2014, 61, 769–775. [Google Scholar] [CrossRef]
- Meneghesso, G.; Verzellesi, G.; Pierobon, R.; Rampazzo, F.; Chini, A.; Canali, C.; Zanoni, E. Surface-related drain current dispersion effects in AlGaN-GaN HEMTs. IEEE Trans. Electron Devices 2004, 51, 1554–1561. [Google Scholar] [CrossRef]
- Faqir, M.; Verzellesi, G.; Meneghesso, G.; Zanoni, E.; Fantini, F. Investigation of high-electric-field degradation effects in AlGaN/GaN HEMTs. IEEE Trans. Electron Devices 2008, 55, 1592–1602. [Google Scholar] [CrossRef]
- Joshi, V.; Tiwari, S.P.; Shrivastava, M. Part I: Physical Insight Into Carbon-Doping-Induced Delayed Avalanche Action in GaN Buffer in AlGaN/GaN HEMTs. IEEE Trans. Electron Devices 2019, 66, 561–569. [Google Scholar] [CrossRef]
- Nishitani, T.; Yamaguchi, R.; Asubar, J.T.; Tokuda, H.; Kuzuhara, M. Improved on-state breakdown characteristics in AlGaN/GaN MOS-HEMTs with a gate field plate. In Proceedings of the 2019 Compound Semiconductor Week (CSW), Nara, Japan, 19–23 May 2019; pp. 1–2. [Google Scholar]
- Kunihiro, K.; Kasahara, K.; Takahashi, Y.; Ohno, Y. Experimental evaluation of impact ionization coefficients in GaN. IEEE Electron Device Lett. 1999, 20, 608–610. [Google Scholar] [CrossRef]
- Fossum, J.G.; Lee, D.S. A physical model for the dependence of carrier lifetime on doping density in nondegenerate silicon. Solid-State Electron. 1982, 25, 741–747. [Google Scholar] [CrossRef]
- Chini, A.; Meneghesso, G.; Meneghini, M.; Fantini, F.; Verzellesi, G.; Patti, A.; Lucolano, F. Experimental and Numerical Analysis of Hole Emission Process from Carbon-Related Traps in GaN Buffer Layers. IEEE Trans. Electron Devices 2016, 63, 3473–3478. [Google Scholar] [CrossRef]
- Reddy, M.K.; Lakshmi, J.; Hemanth, A.; Kumar, B.H.; Bandi, L.; Sheu, G.; Song, Y.L.; Chen, P.A.; Chang, L.M. Physics Based TCAD Simulation and Calibration of GaN/AlGaN/GaN HEMT Device. In Proceedings of the International Conference on Systems and Informatics, Shanghai, China, 2–4 November 2019; pp. 253–256. [Google Scholar]
- Hu, J.; Stoffels, S.; Lenci, S.; Groeseneken, G.; Decoutere, S. On the Identification of Buffer Trapping for Bias-Dependent Dynamic RON of AlGaN/GaN Schottky Barrier Diode With AlGaN: C Back Barrier. IEEE Electron Device Lett. 2016, 37, 310–313. [Google Scholar] [CrossRef]
- Bisi, D.; Meneghini, M.; Marino, F.A.; Marcon, D.; Stoffels, S.; Hove, M.V.; Decoutere, S.; Meneghesso, G.; Zanoni, E. Kinetics of Buffer-Related RON-Increase in GaN-on-Silicon MIS-HEMTs. IEEE Electron Device Lett. 2014, 35, 1004–1006. [Google Scholar] [CrossRef]
- Silvestri, M.; Uren, M.J.; Kuball, M. Iron-induced deep-level acceptor center in GaN/AlGaN high electron mobility transistors: Energy level and cross section. Appl. Phys. Lett. 2013, 102, 073501. [Google Scholar] [CrossRef]
- Raja, P.V.; Bouslama, M.; Sarkar, S.; Pandurang, K.R.; Nallatamby, J.C.; Dasgupta, N.; Dasgupta, A. Deep-Level Traps in AlGaN/GaN- and AlInN/GaN-Based HEMTs With Different Buffer Doping Technologies. IEEE Trans. Electron Devices 2020, 67, 2304–2310. [Google Scholar] [CrossRef]
- Zagni, N.; Chini, A.; Puglisi, F.M.; Pavan, P.; Meneghini, M.; Meneghesso, G.; Zanoni, E.; Verzellesi, G. Trap dynamics model explaining the RON stress/recovery behavior in carbon-doped power AlGaN/GaN MOS-HEMTs. In Proceedings of the 2020 IEEE International Reliability Physics Symposium (IRPS), Dallas, TX, USA, 28 April–30 May 2020; pp. 1–5. [Google Scholar]
- Zhou, C.H.; Jiang, Q.M.; Huang, S.; Chen, K.J. Vertical leakage/breakdown mechanisms in AlGaN/GaN-on-Si devices. IEEE Electron Device Lett. 2012, 33, 1132–1134. [Google Scholar] [CrossRef]

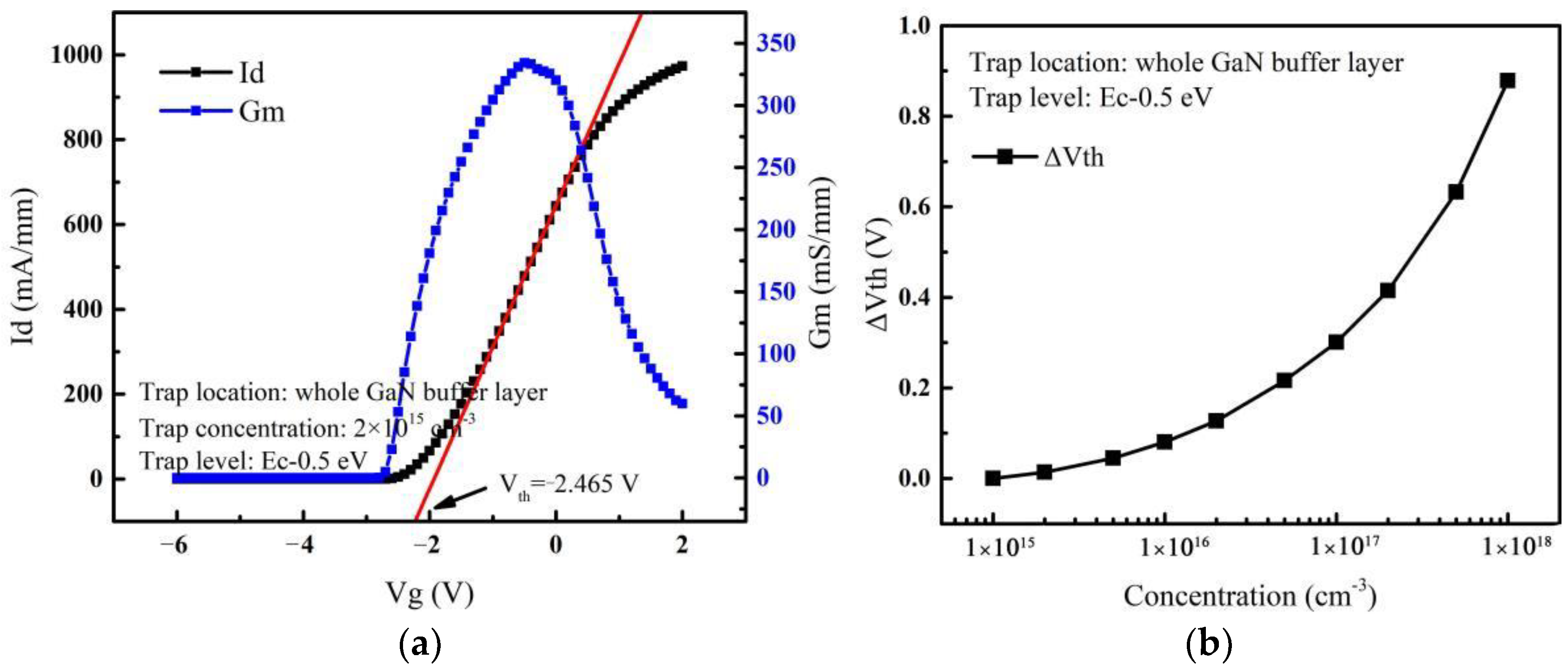
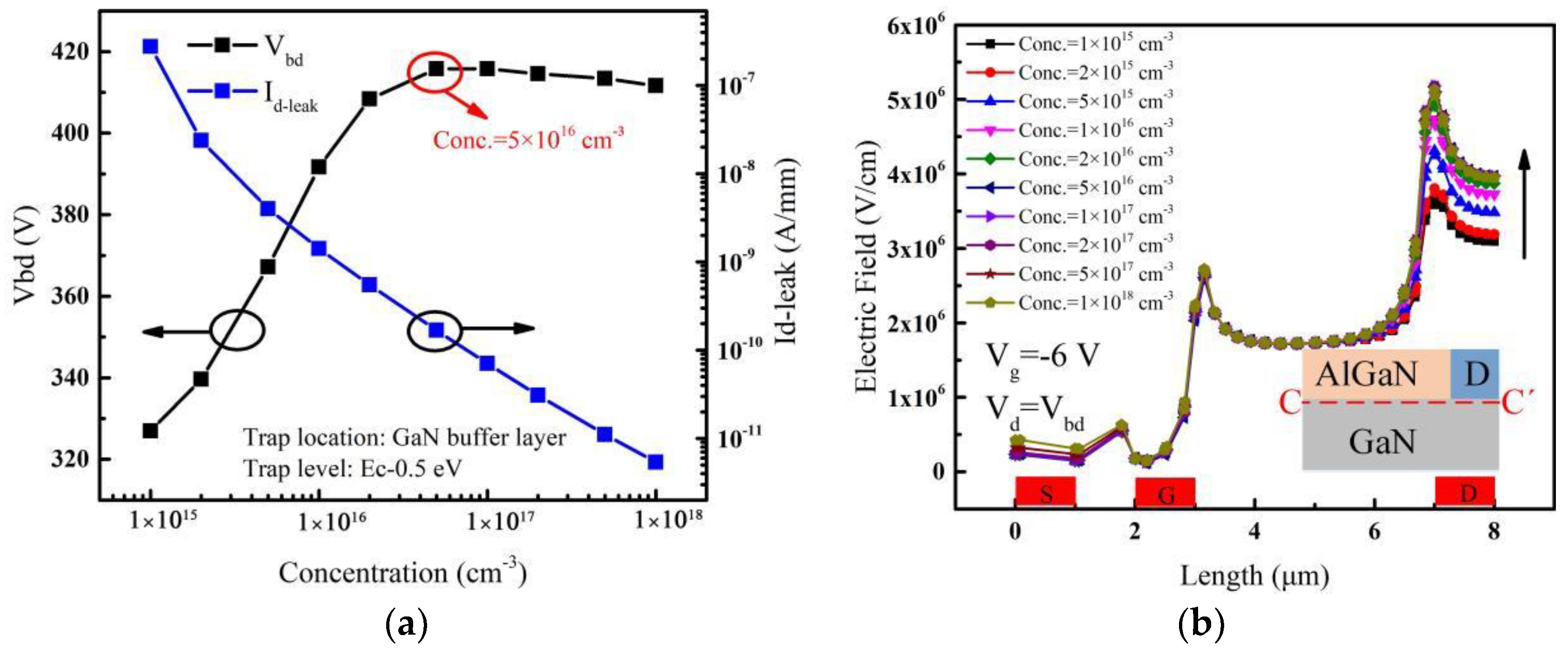
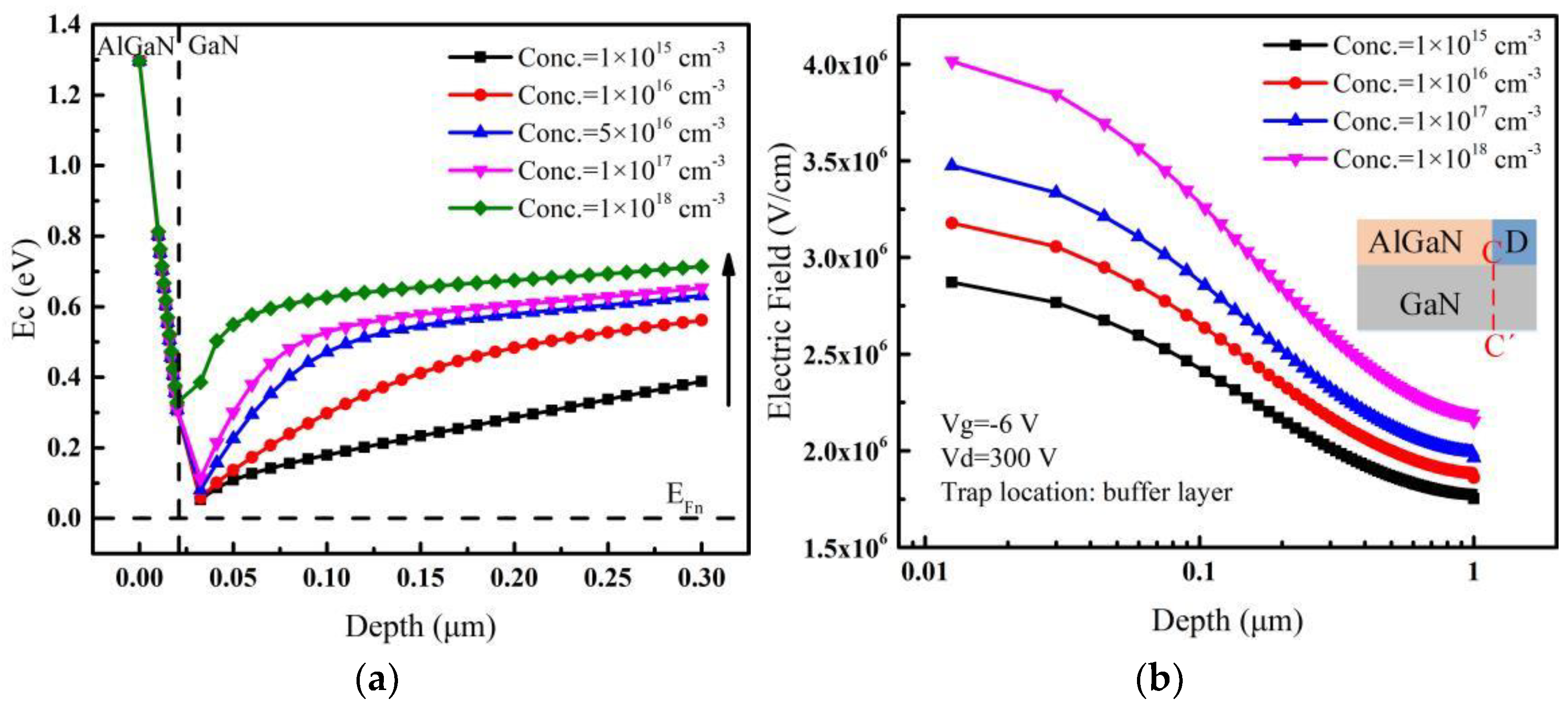
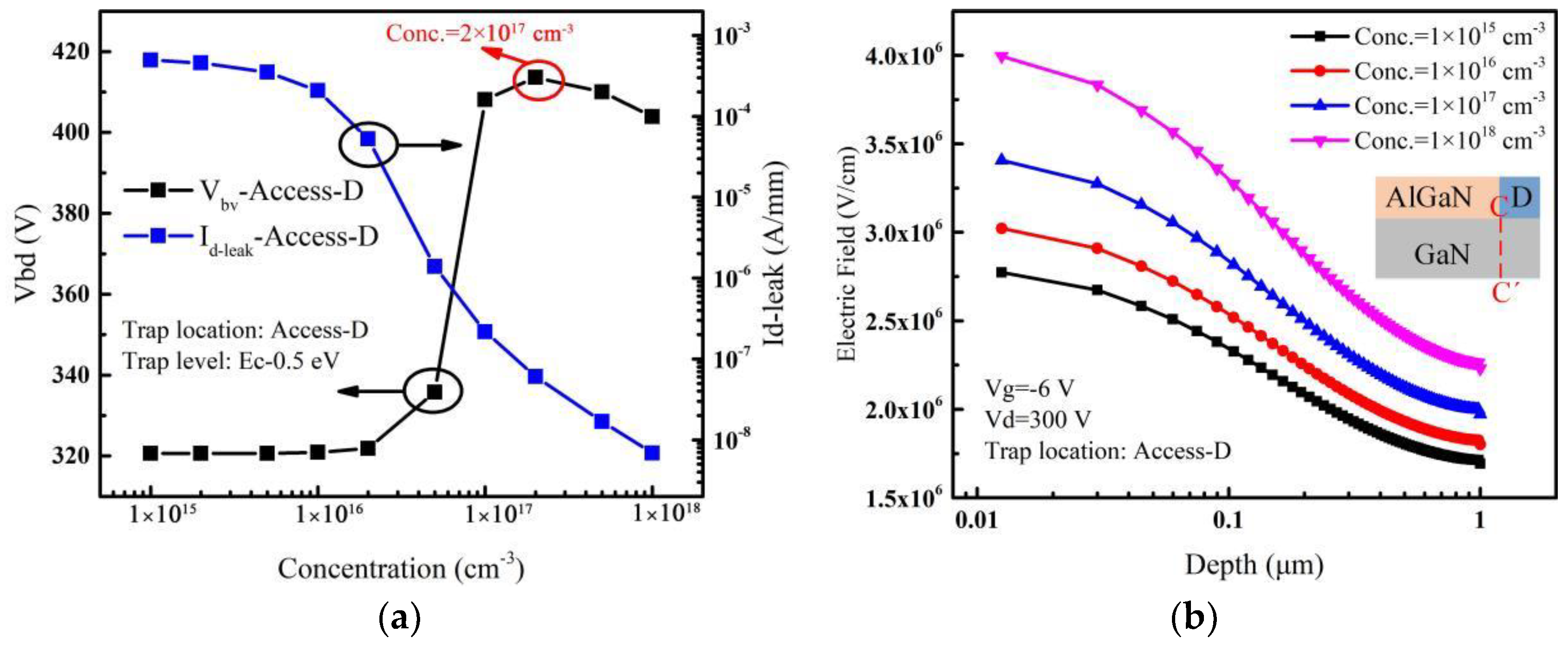
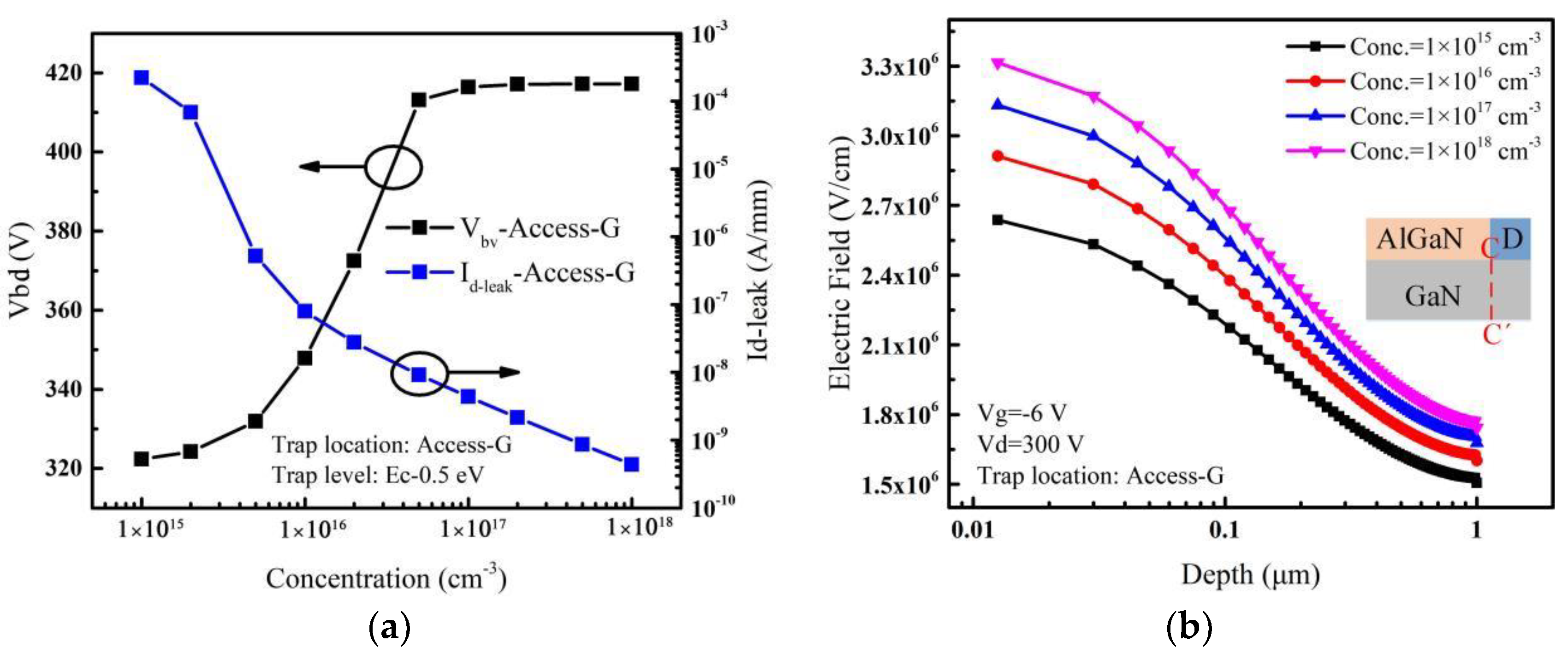

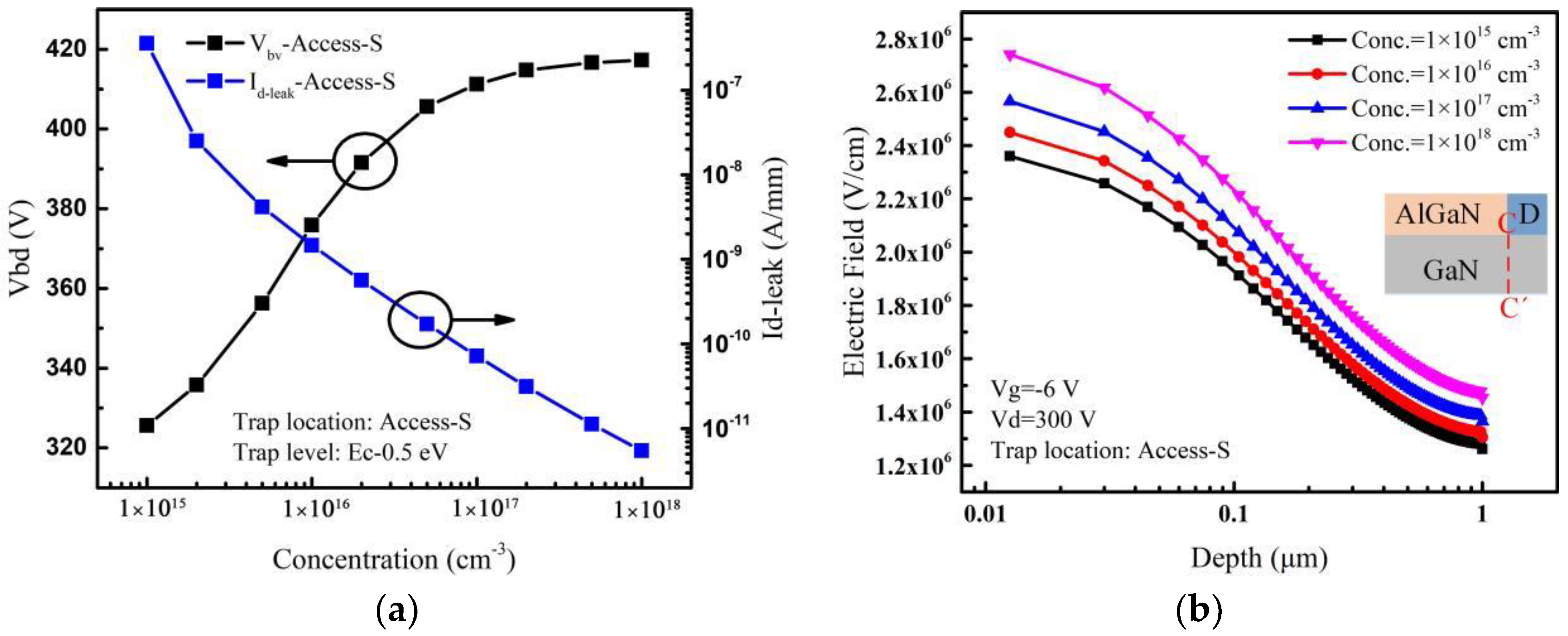
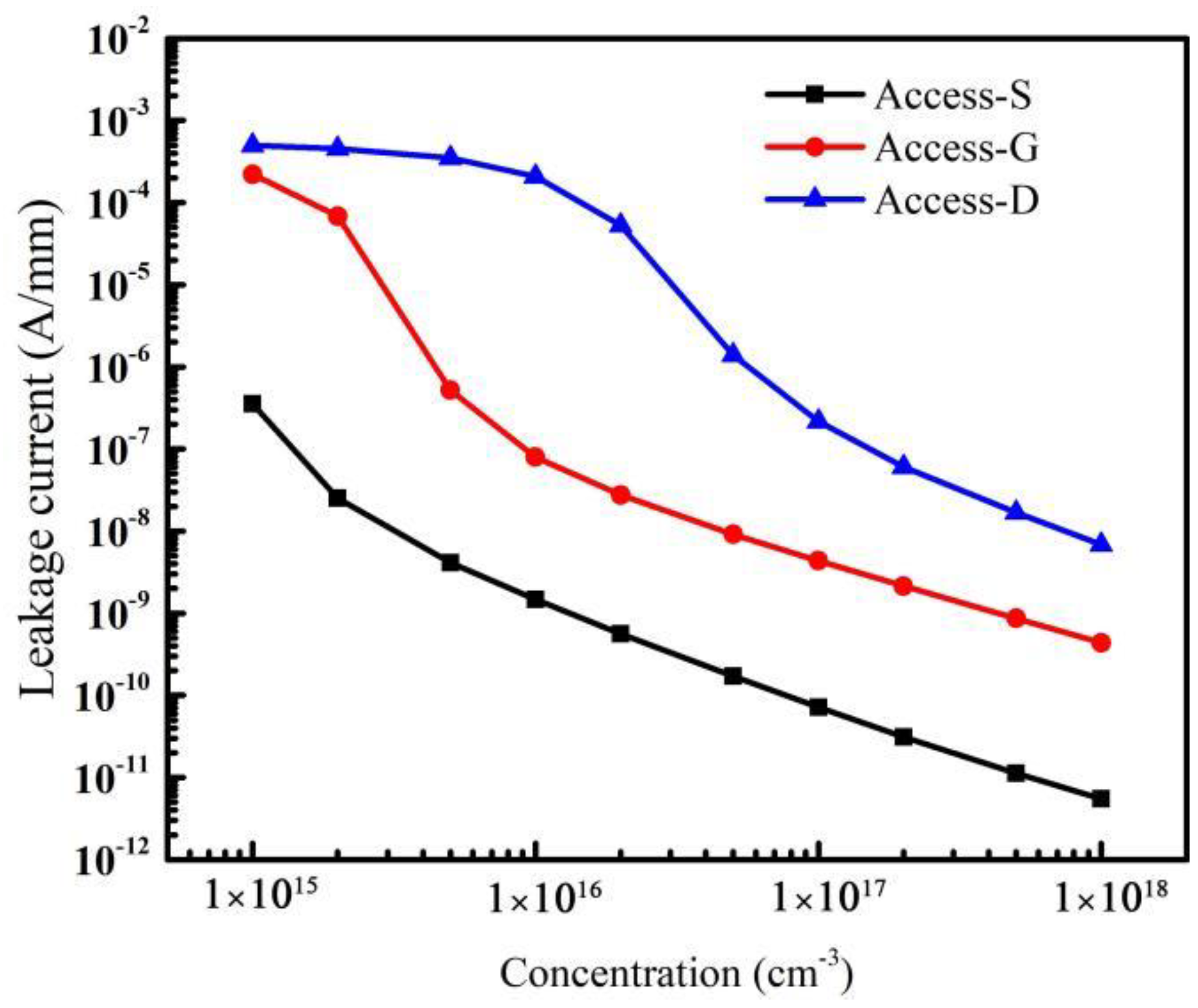
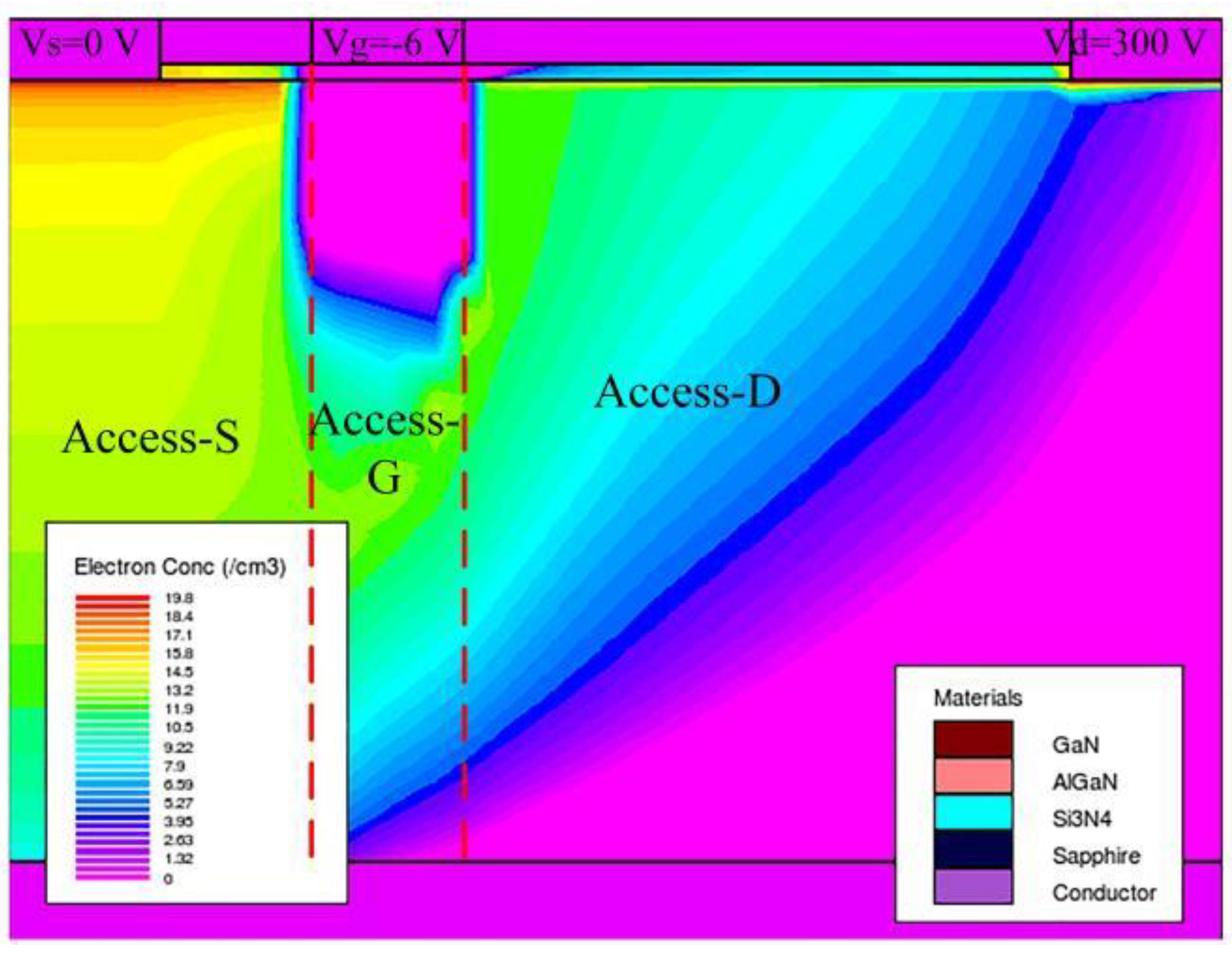
| Parameters of GaN Material | GaN |
|---|---|
| the band-gap energy | 3.4/eV |
| the relative dielectric permittivity | 9.5 |
| lattice temperature | 300/K |
| electron low-field mobility in GaN layer | 900/(cm2/(V × s)) |
| saturated velocity of electrons | 2 × 107 /(cm/s) |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2022 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Ma, M.; Cao, Y.; Lv, H.; Wang, Z.; Zhang, X.; Chen, C.; Wu, L.; Lv, L.; Zheng, X.; Tian, W.; et al. Effect of Acceptor Traps in GaN Buffer Layer on Breakdown Performance of AlGaN/GaN HEMTs. Micromachines 2023, 14, 79. https://doi.org/10.3390/mi14010079
Ma M, Cao Y, Lv H, Wang Z, Zhang X, Chen C, Wu L, Lv L, Zheng X, Tian W, et al. Effect of Acceptor Traps in GaN Buffer Layer on Breakdown Performance of AlGaN/GaN HEMTs. Micromachines. 2023; 14(1):79. https://doi.org/10.3390/mi14010079
Chicago/Turabian StyleMa, Maodan, Yanrong Cao, Hanghang Lv, Zhiheng Wang, Xinxiang Zhang, Chuan Chen, Linshan Wu, Ling Lv, Xuefeng Zheng, Wenchao Tian, and et al. 2023. "Effect of Acceptor Traps in GaN Buffer Layer on Breakdown Performance of AlGaN/GaN HEMTs" Micromachines 14, no. 1: 79. https://doi.org/10.3390/mi14010079
APA StyleMa, M., Cao, Y., Lv, H., Wang, Z., Zhang, X., Chen, C., Wu, L., Lv, L., Zheng, X., Tian, W., Ma, X., & Hao, Y. (2023). Effect of Acceptor Traps in GaN Buffer Layer on Breakdown Performance of AlGaN/GaN HEMTs. Micromachines, 14(1), 79. https://doi.org/10.3390/mi14010079






