Structural Property Study for GeSn Thin Films
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
4. Conclusions
Author Contributions
Funding
Conflicts of Interest
Appendix A

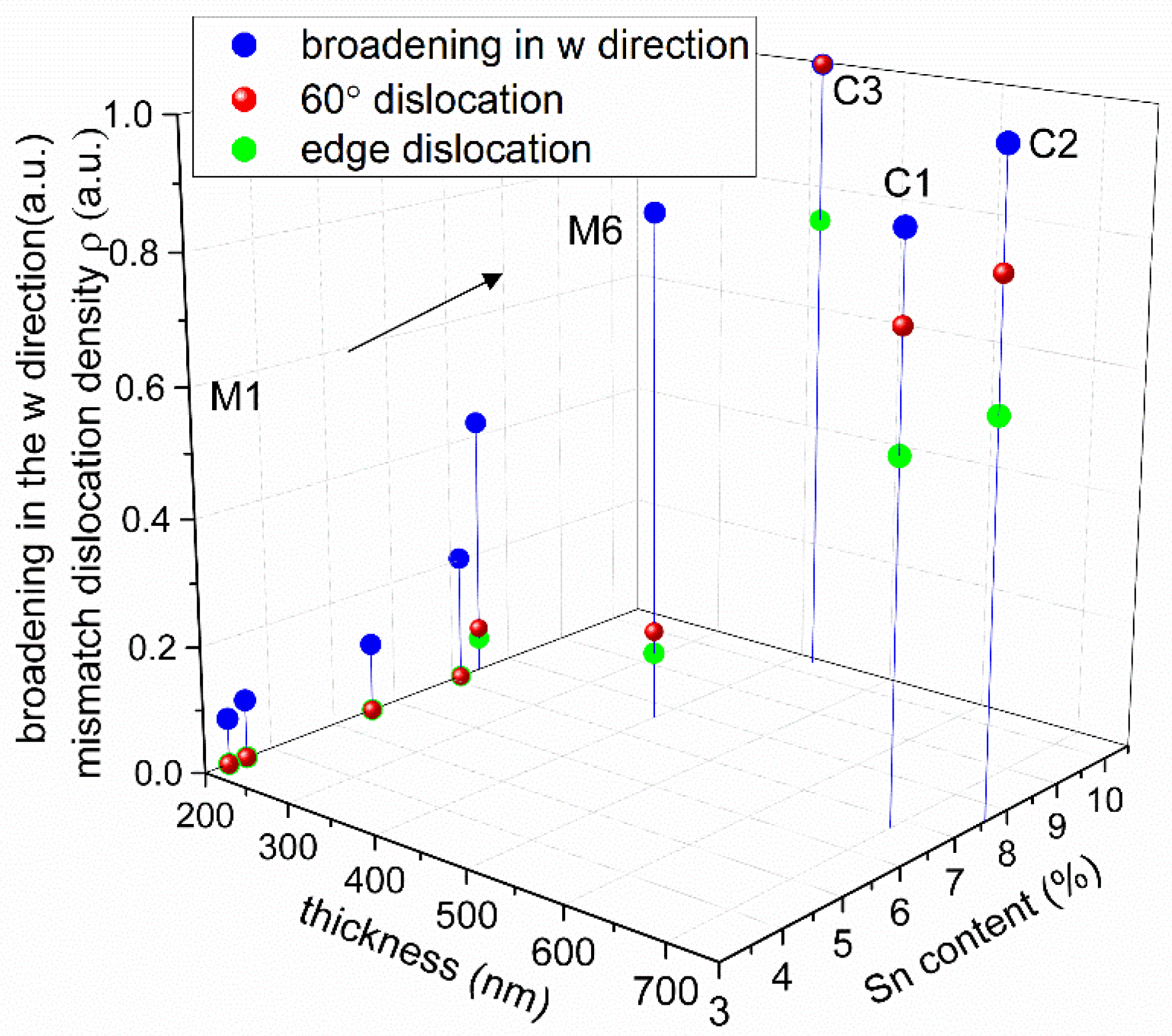
References
- Mack, C.A. Fifty years of Moore’s law. IEEE Trans. Semicond. Manuf. 2011, 24, 202–207. [Google Scholar] [CrossRef]
- Courtland, R. Transistors could stop shrinking in 2021. IEEE Spectr. 2016, 53, 9–11. [Google Scholar] [CrossRef]
- Thomson, D.; Zilkie, A.; Bowers, J.E.; Komljenovic, T.; Reed, G.T.; Vivien, L.; Marris-Morini, D.; Cassan, É.; Virot, L.; Fédéli, J.-M.; et al. Roadmap on silicon photonics. J. Opt. 2016, 18, 73003. [Google Scholar] [CrossRef]
- Soref, R. The Past, Present, and Future of Silicon Photonics. IEEE J. Sel. Top. Quantum Electron. 2006, 12, 1678–1687. [Google Scholar] [CrossRef]
- Bowers, J.E.; Komljenovic, T.; Davenport, M.; Hulme, J.; Liu, A.Y.; Santis, C.T.; Spott, A.; Srinivasan, S.; Stanton, E.J.; Zhang, C. Recent advances in silicon photonic integrated circuits. In Proceedings of the Next-Generation Optical Communication: Components, Sub-Systems, and Systems V, San Francisco, CA, USA, 13–18 February 2016; p. 977402. [Google Scholar]
- Gupta, S.; Magyari-Kope, B.; Nishi, Y.; Saraswat, K.C. Achieving direct band gap in germanium through integration of Sn alloying and external strain. J. Appl. Phys. 2013, 113, 073707. [Google Scholar] [CrossRef]
- Wirths, S.; Geiger, R.; Driesch, N.V.D.; Mussler, G.; Stoica, T.; Mantl, S.; Ikonić, Z.; Luysberg, M.; Chiussi, S.; Hartmann, J.M.; et al. Lasing in direct-bandgap GeSn alloy grown on Si. Nat. Photonics 2015, 9, 88–92. [Google Scholar] [CrossRef]
- De Kersauson, M.; El Kurdi, M.; David, S.; Checoury, X.; Fishman, G.; Sauvage, S.; Jakomin, R.; Beaudoin, G.; Sagnes, I.; Boucaud, P. Optical gain in single tensile-strained germanium photonic wire. Opt. Express 2011, 19, 17925–17934. [Google Scholar] [CrossRef]
- Süess, M.J.; Geiger, R.; Minamisawa, R.; Schiefler, G.; Frigerio, J.; Chrastina, D.; Isella, G.; Spolenak, R.; Faist, J.; Sigg, H. Analysis of enhanced light emission from highly strained germanium microbridges. Nat. Photonics 2013, 7, 466–472. [Google Scholar] [CrossRef]
- Sau, J.D.; Cohen, M.L. Possibility of increased mobility in Ge-Sn alloy system. Phys. Rev. B 2007, 75, 045208. [Google Scholar] [CrossRef]
- Maeda, T.; Wipakorn, J.; Hiroyuki, H.; Noriyuki, U.; Jean-Pierre, L.; Ruben, L. Junctionless GeSn pMOSFETs on Si (111) by solid phase epitaxy. In Proceedings of the International Conference on Silicon epitaxy and Heterostructures (ICSI-8), Fukuoka, Japan, 2 June 2013. [Google Scholar]
- Guo, P.; Han, G.; Gong, X.; Liu, B.; Yang, Y.; Wang, W.; Zhou, Q.; Pan, J.; Zhang, Z.; Tok, E.S.; et al. Ge0.97Sn0.03 p-channel metal-oxide-semiconductor field-effect transistors: Impact of Si surface passivation layer thickness and post metal annealing. J. Appl. Phys. 2013, 114, 044510. [Google Scholar] [CrossRef]
- Maeda, T.; Jevasuwan, W.; Hattori, H.; Uchida, N.; Miura, S.; Tanaka, M.; Santos, N.D.M.; Vantomme, A.; Locquet, J.-P.; Lieten, R.R. Ultrathin GeSn p-channel MOSFETs grown directly on Si(111) substrate using solid phase epitaxy. Jpn. J. Appl. Phys. 2015, 54, 04DA07. [Google Scholar] [CrossRef]
- Al-Kabi, S.; Ghetmiri1, S.A.; Margetis, J.; Pham, T.; Zhou, Y.; Dou, W.; Collier, B.; Quinde, R.; Du, W.; Mosleh, A.; et al. An optically pumped 2.5 μm GeSn laser on Si operating at 110 K. Appl. Phys. Lett. 2016, 109, 171105. [Google Scholar] [CrossRef]
- Stange, D.; Wirths, S.; Geiger, R.; Schulte-Braucks, C.; Marzban, B.; Driesch, N.V.D.; Mussler, G.; Zabel, T.; Stoica, T.; Hartmann, J.-M.; et al. Optically Pumped GeSn Microdisk Lasers on Si. ACS Photonics 2016, 3, 1279–1285. [Google Scholar] [CrossRef]
- Stange, D.; Driesch, N.V.D.; Zabel, T.; Armand-Pilon, F.; Rainko, D.; Marzban, B.; Zaumseil, P.; Hartmann, J.-M.; Ikonic, Z.; Capellini, G.; et al. GeSn/SiGeSn Heterostructure and Multi Quantum Well Lasers. ACS Photonics 2018, 5, 4628–4636. [Google Scholar] [CrossRef]
- Reboud, V.; Gassenq, A.; Pauc, N.; Aubin, J.; Milord, L.; Thai, Q.M.; Bertrand, M.; Guilloy, K.; Rouchon, D.; Rothman, J.; et al. Optically pumped GeSn micro-disks with 16% Sn lasing at 3.1 um up to 180K. Appl. Phys. Lett. 2017, 111, 092101. [Google Scholar] [CrossRef]
- Kasper, E.; Werner, J.; Oehme, M.; Escoubas, S.; Burle, N.; Schulze, J. Growth of silicon based germanium tin alloys. Thin Solid Films 2012, 520, 3195–3200. [Google Scholar] [CrossRef]
- Wirths, S.; Buca, D.; Mantl, S. Si–Ge–Sn alloys: From growth to applications. Prog. Cryst. Growth Charact. Mater. 2016, 62, 1–39. [Google Scholar] [CrossRef]
- Zaima, S.; Nakatsuka, O.; Taoka, N.; Kurosawa, M.; Takeuchi, W.; Sakashita, M. Growth and applications of GeSn-related group-IV semiconductor materials. Sci. Technol. Adv. Mater. 2015, 16, 43502. [Google Scholar] [CrossRef]
- Oehme, M.; Kostecki, K.; Schmid, M.; Oliveira, F.; Kasper, E.; Schulze, J. Epitaxial growth of strained and unstrained GeSn alloys up to 25% Sn. Thin Solid Films 2014, 557, 169–172. [Google Scholar] [CrossRef]
- Mathews, J.; Beeler, R.T.; Tolle, J.; Xu, C.; Roucka, R.; Kouvetakis, J.; Menéndez, J. Direct-gap photoluminescence with tunable emission wavelength in Ge1−y Sny alloys on silicon. Appl. Phys. Lett. 2010, 97, 221912. [Google Scholar] [CrossRef]
- Margetis, J.; Mosleh, A.; Al-Kabi, S.; Ghetmiri, S.; Du, W.; Dou, W.; Benamara, M.; Li, B.; Mortazavi, M.; Naseem, H.; et al. Study of low-defect and strain-relaxed GeSn growth via reduced pressure CVD in H 2 and N 2 carrier gas. J. Cryst. Growth 2017, 463, 128–133. [Google Scholar] [CrossRef]
- Ghetmiri, S.A.; Du, W.; Margetis, J.; Mosleh, A.; Cousar, L.; Conley, B.R.; Domulevicz, L.; Nazzal, A.; Sun, G.; Soref, R.; et al. Direct-bandgap GeSn grown on silicon with 2230 nm photoluminescence. Appl. Phys. Lett. 2014, 105, 151109. [Google Scholar] [CrossRef]
- Margetis, J.; Al-Kabi, S.; Du, W.; Dou, W.; Zhou, Y.; Pham, T.; Grant, P.; Ghetmiri, S.; Mosleh, A.; Li, B.; et al. Si-based GeSn lasers with wavelength coverage of 2–3 μm and operating temperatures up to 180 K. ACS Photonics 2017, 5, 827–833. [Google Scholar] [CrossRef]
- Thai, Q.M.; Pauc, N.; Aubin, J.; Bertrand, M.; Chrétien, J.; Delaye, V.; Chelnokov, A.; Hartmann, J.; Reboud, V.; Calvo, V. GeSn heterostructure micro-disk laser operating at 230 K. Opt. Express 2018, 26, 32500–32508. [Google Scholar] [CrossRef] [PubMed]
- Zhang, Z.P.; Song, Y.; Zhu, Z.Y.S.; Han, Y.; Chen, Q.M.; Li, Y.Y.; Zhang, L.Y.; Wang, S.M. Structural properties of GeSn thin films grown by molecular beam epitaxy. AIP Adv. 2017, 7, 045211. [Google Scholar] [CrossRef]
- Hartmann, J.M.; Abbadie, A.; Cherkashin, N.; Grampeix, H.; Clavelier, L. Epitaxial growth of Ge thick layers on nominal and 6° off Si(0 0 1); Ge surface passivation by Si. Semicond. Sci. Technol. 2009, 24, 055002. [Google Scholar] [CrossRef]
- Driesch, N.V.D.; Stange, D.; Wirths, S.; Mussler, G.; Holländer, B.; Ikonic, Z.; Hartmann, J.M.; Stoica, T.; Mantl, S.; Grützmacher, D.; et al. Direct Bandgap Group IV Epitaxy on Si for Laser Applications. Chem. Mater. 2015, 27, 4693–4702. [Google Scholar] [CrossRef]
- Available online: http://www.ioffe.ru/SVA/NSM/Semicond/Ge/mechanic.html (accessed on 11 November 2019).
- People, R.; Bean, J. Erratum: Calculation of critical layer thickness versus lattice mismatch for GexSi1−x/Si strained-layer heterostructures [Appl. Phys. Lett. 47, 322 (1985)]. Appl. Phys. Lett. 1986, 49, 229. [Google Scholar] [CrossRef]
- Moram, M.A.; Vickers, M.E. X-ray diffraction of III-nitrides. Rep. Prog. Phys. 2009, 72, 36502. [Google Scholar] [CrossRef]
- Hu, S.M. Misfit dislocations and critical thickness of heteroepitaxy. J. Appl. Phys. 1991, 69, 7901–7903. [Google Scholar] [CrossRef]
- Dou, W.; Benamara, M.; Mosleh, A.; Margetis, J.; Grant, P.; Zhou, Y.; Al-Kabi, S.; Du, W.; Tolle, J.; Li, B.; et al. Investigation of GeSn Strain Relaxation and Spontaneous Composition Gradient for Low-Defect and High-Sn Alloy Growth. Sci. Rep. 2018, 8, 5640. [Google Scholar] [CrossRef] [PubMed]
- Yi, H.; Song, Y.; Xiren, C.; Zhang, Z.; Liu, J.; Li, Y.Y.; Zhu, Z.; Huang, H.; Shao, J.; Wang, S. Abnormal strain in suspended GeSn microstructures. Mater. Res. Exp. 2018, 5, 035901. [Google Scholar]
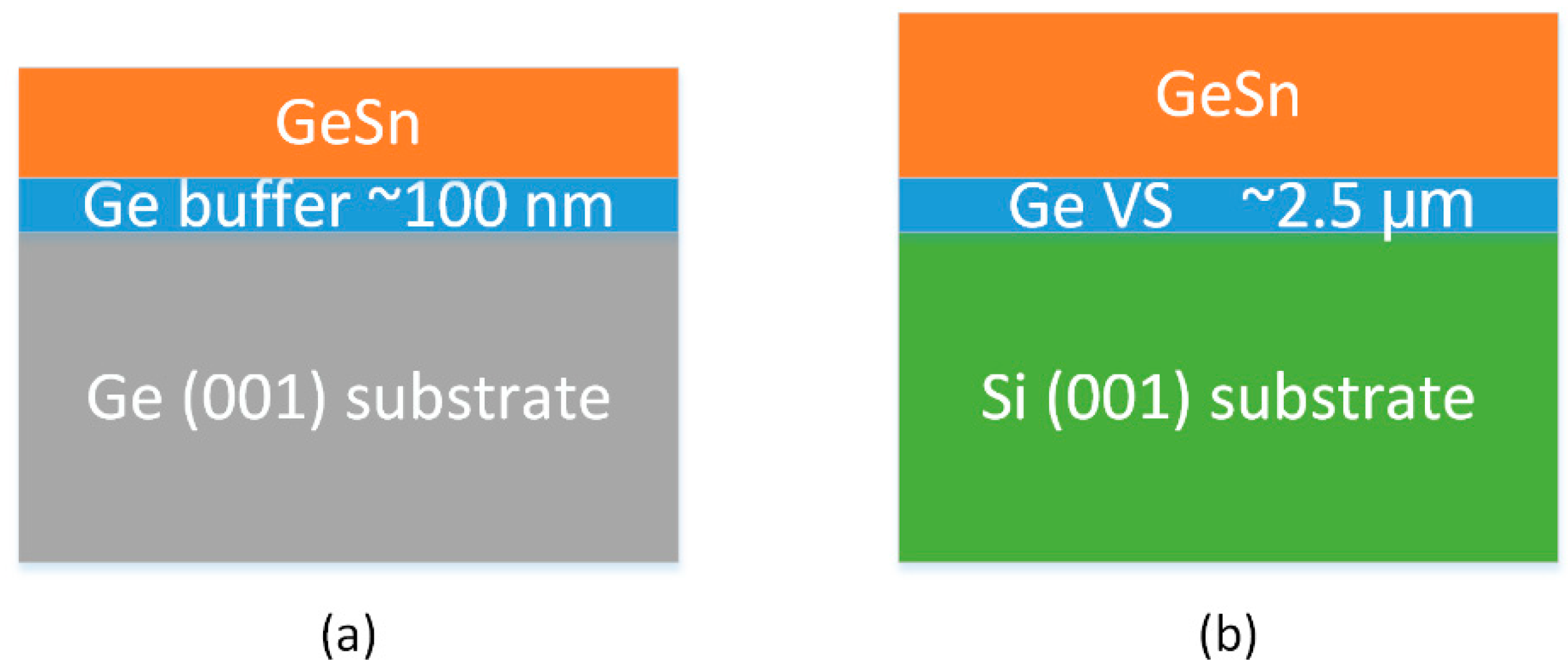

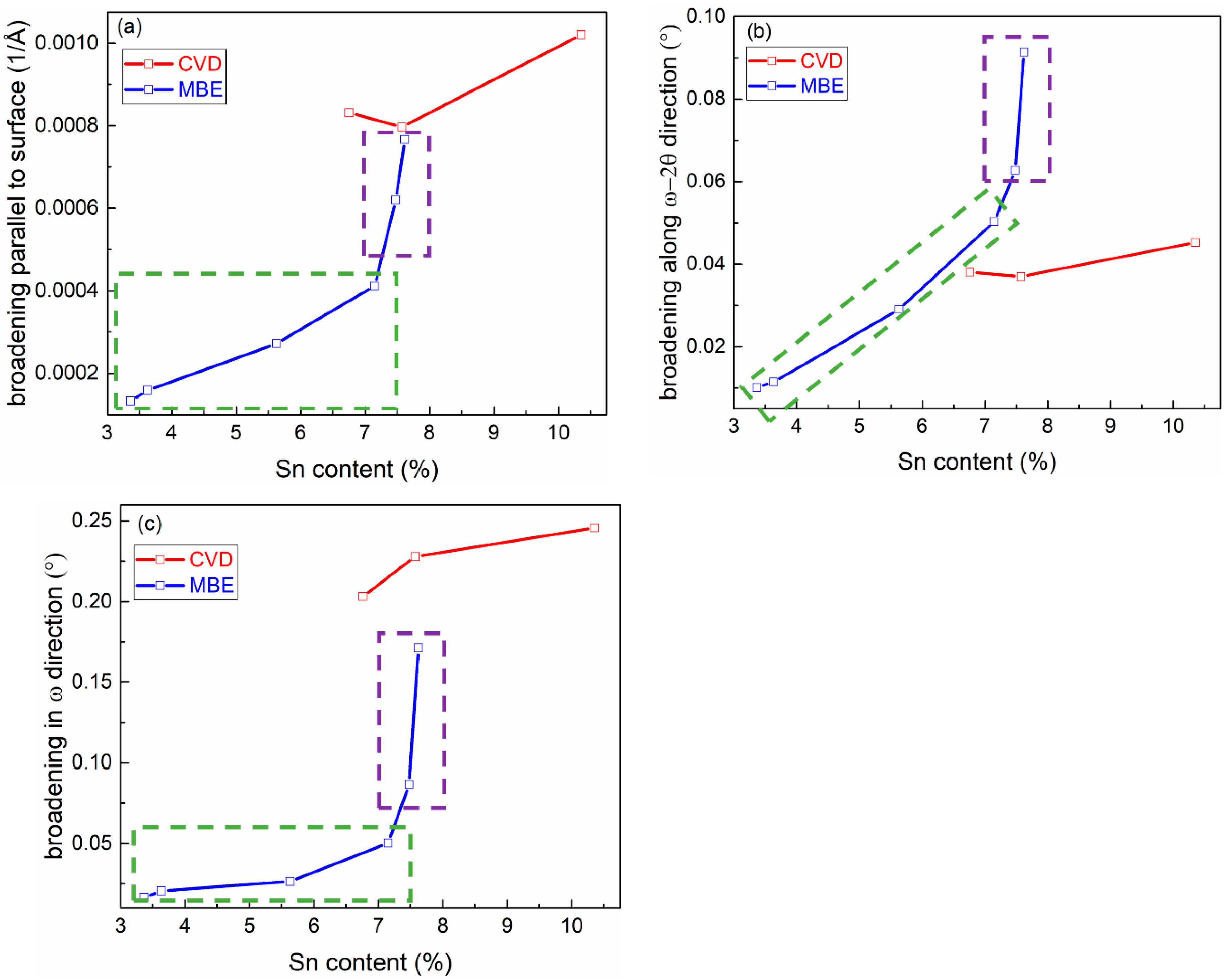


| Sample Number | Sn Content (%) | Thickness (nm) | Critical Thickness (nm) | Relaxation (%) | |
|---|---|---|---|---|---|
| MBE | M1 | 3.4 | 200 | 691.5 | 0 |
| M2 | 3.6 | 200 | 578 | 0 | |
| M3 | 5.6 | 200 | 205.5 | 0 | |
| M4 | 7.2 | 200 | 115.4 | 0 | |
| M5 | 7.5 | 200 | 103.3 | 7.2 | |
| M6 | 7.6 | 400 | 98.7 | 14.2 | |
| CVD | C1 | 6.8 | 700 | 132.3 | 82.7 |
| C2 | 7.6 | 750 | 98.7 | 80.7 | |
| C3 | 10.4 | 420 | 45.8 | 72.5 |
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Zhang, L.; Song, Y.; von den Driesch, N.; Zhang, Z.; Buca, D.; Grützmacher, D.; Wang, S. Structural Property Study for GeSn Thin Films. Materials 2020, 13, 3645. https://doi.org/10.3390/ma13163645
Zhang L, Song Y, von den Driesch N, Zhang Z, Buca D, Grützmacher D, Wang S. Structural Property Study for GeSn Thin Films. Materials. 2020; 13(16):3645. https://doi.org/10.3390/ma13163645
Chicago/Turabian StyleZhang, Liyao, Yuxin Song, Nils von den Driesch, Zhenpu Zhang, Dan Buca, Detlev Grützmacher, and Shumin Wang. 2020. "Structural Property Study for GeSn Thin Films" Materials 13, no. 16: 3645. https://doi.org/10.3390/ma13163645
APA StyleZhang, L., Song, Y., von den Driesch, N., Zhang, Z., Buca, D., Grützmacher, D., & Wang, S. (2020). Structural Property Study for GeSn Thin Films. Materials, 13(16), 3645. https://doi.org/10.3390/ma13163645





