Solid-Liquid Interdiffusion (SLID) Bonding of p-Type Skutterudite Thermoelectric Material Using Al-Ni Interlayers
Abstract
1. Introduction
2. Materials and Methods
3. Results and Discussion
3.1. Evolution of Microstructure Morphologies
3.2. Electrical Contact Resistance (RC) Evaluation
3.3. Mechanical Strength Evaluation
4. Conclusions
Supplementary Materials
Author Contributions
Funding
Acknowledgments
Conflicts of Interest
References
- Rogl, G.; Rogl, P. Skutterudites, a most promising group of thermoelectric materials. Curr. Opin. Green Sustain. Chem. 2017, 4, 50–57. [Google Scholar] [CrossRef]
- Chiwanga, S.; Tuley, R.; Placha, K.; Robbins, M.; Gilchrist, B.; Simpson, K. Automotive power harvesting/thermoelectric applications. In Thermoelectric Materials and Devices; RSC Publishing: Cambridge, UK, 2017; Chapter 9; pp. 230–251. [Google Scholar]
- Holgate, T.C.; Bennett, R.; Hammel, T.; Caillat, T.; Keyser, S.; Sievers, B. Increasing the Efficiency of the Multi-mission Radioisotope Thermoelectric Generator. J. Electron. Mater. 2015, 44, 1814–1821. [Google Scholar] [CrossRef]
- Aswal, D.K.; Basu, R.; Singh, A. Key issues in development of thermoelectric power generators: High figure-of-merit materials and their highly conducting interfaces with metallic interconnects. Energy Convers. Manag. 2016, 114, 50–67. [Google Scholar] [CrossRef]
- Caillat, T.; Firdosy, S.; Li, B.C.-Y.; Huang, K.; Cheng, B.; Paik, J.; Chase, J.; Arakelian, T.; Lara, L. Progress status of the development of high-efficiency segmented thermoelectric couples. Nucl. Emerg. Technol. Space 2012, 2. [Google Scholar]
- Mo/Ti Diffusion Bonding for Making Thermoelectric Devices. Available online: https://www.techbriefs.com/component/content/article/tb/techbriefs/electronics-and-computers/2014 (accessed on 23 July 2018).
- Fleurial, J.-P.; Caillat, T.; Chi, S.C. Electrical contacts for skutterudite thermoelectric materials. U.S. Patent 13,161,156, 12 January 2012. [Google Scholar]
- Salvador, J.R.; Cho, J.Y.; Ye, Z.; Moczygemba, J.E.; Thompson, A.J.; Sharp, J.W.; Koenig, J.D.; Maloney, R.; Thompson, T.; Sakamoto, J.; et al. Conversion efficiency of skutterudite-based thermoelectric modules. Phys. Chem. Chem. Phys. 2014, 16, 12510–12520. [Google Scholar] [CrossRef] [PubMed]
- Zhao, D.; Li, X.; He, L.; Jiang, W.; Chen, L. Interfacial evolution behavior and reliability evaluation of CoSb3/Ti/Mo–Cu thermoelectric joints during accelerated thermal aging. J. Alloys Compd. 2009, 477, 425–431. [Google Scholar] [CrossRef]
- Zybala, R.; Wojciechowski, K.; Schmidt, M.; Mania, R. Junctions and diffusion barriers for high temperature thermoelectric modules. Mater. Ceram. Ceram. Mater. 2010, 62, 481–485. [Google Scholar]
- Park, S.H.; Jin, Y.; Cha, J.; Hong, K.; Kim, Y.; Yoon, H.; Yoo, C.-Y.; Chung, I. High-Power-Density Skutterudite-Based Thermoelectric Modules with Ultralow Contact Resistivity Using Fe–Ni Metallization Layers. ACS Appl. Energy Mater. 2018, 1, 1603–1611. [Google Scholar] [CrossRef]
- Rao, A.; Bosak, G.; Joshi, B.; Keane, J.; Nally, L.; Peng, A.; Perera, S.; Waring, A.; Poudel, B. A TiAlCu Metallization for ‘n’ Type CoSb x Skutterudites with Improved Performance for High-Temperature Energy Harvesting Applications. J. Electron. Mater. 2017, 46, 2419–2431. [Google Scholar] [CrossRef]
- Jie, Q.; Ren, Z.; Chen, G. Fabrication of stable electrode/diffusion barrier layers for thermoelectric filled skutterudite devices. U.S. Patent 15,627,593, 5 October 2017. [Google Scholar]
- Bernstein, L. Semiconductor Joining by the Solid-Liquid-Interdiffusion (SLID) Process: I. The Systems Ag-In, Au-In, and Cu-In. J. Electrochem. Soc. 1966, 113, 1282–1288. [Google Scholar] [CrossRef]
- MacDonald, W.D.; Eagar, T.W. Transient liquid phase bonding. Annu. Rev. Mater. Sci. 1992, 22, 23–46. [Google Scholar] [CrossRef]
- Jacobson, D.M.; Humpston, G. Principles of Brazing; ASM International: Russel, OH, USA, 2005. [Google Scholar]
- Owczarski, W.A.; King, W.H.; Duvall, D.S. Diffusion welding of the nickel-base superalloys. U.S. Patent 3,530,568, 29 September 1970. [Google Scholar]
- Chu, K.; Sohn, Y.; Moon, C. A comparative study of Cn/Sn/Cu and Ni/Sn/Ni solder joints for low temperature stable transient liquid phase bonding. Scr. Mater. 2015, 109, 113–117. [Google Scholar] [CrossRef]
- Xu, H.; Suni, T.; Vuorinen, V.; Li, J.; Heikkinen, H.; Monnoyer, P.; Paulasto-Kröckel, M. Wafer-level SLID bonding for MEMS encapsulation. Adv. Manuf. 2013, 1, 226–235. [Google Scholar] [CrossRef]
- Mao, X.; Lv, X.-D.; Wei, W.-W.; Zhang, Z.; Yang, J.-L.; Qi, Z.-M.; Yang, F.-H. A wafer-level Sn-rich Au-Sn bonding technique and its application in surface plasmon resonance sensors. Chin. Phys. Lett. 2014, 31, 056803. [Google Scholar] [CrossRef]
- Made, R.I.; Gan, C.L.; Yan, L.L.; Yu, A.; Yoon, S.W.; Lau, J.H.; Lee, C. Study of Low-Temperature Thermocompression Bonding in Ag-In Solder for Packaging Applications. J. Electron. Mater. 2009, 38, 365. [Google Scholar] [CrossRef]
- Fukumoto, S.; Miyake, K.; Tatara, S.; Matsushima, M.; Fujimoto, K. Solid-Liquid Interdiffusion Bonding of Copper Using Ag-Sn Layered Films. Mater. Trans. 2015, 56, 1019–1024. [Google Scholar] [CrossRef]
- Deillon, L.; Hessler-Wyser, A.; Hessler, T.; Rappaz, M. Solid-liquid interdiffusion (SLID) bonding in the Au-In system: Experimental study and 1D modelling. J. Micromech. Microeng. 2015, 25, 125016. [Google Scholar] [CrossRef]
- Tollefsen, T.A.; Larsson, A.; Løvvik, O.M.; Aasmundtveit, K. Au-Sn SLID Bonding—Properties and Possibilities. Metall. Mater. Trans. B 2012, 43, 397–405. [Google Scholar] [CrossRef]
- Larsson, A.; Tollefsen, T.A.; Martin, O.; Aasmundtveit, K.E. Ni-Sn solid-liquid interdiffusion (SLID) bonding for thermo-electric elements in extreme environments—FEA of the joint stress. In Proceedings of the Microelectronics Packaging Conference (EMPC), Friedrichshafen, Germany, 14 September 2015; pp. 1–6. [Google Scholar]
- Huang, T.-C.; Smet, V.; Kawamoto, S.; Pulugurtha, M.R.; Tummala, R.R. Accelerated Metastable Solid—Liquid Interdiffusion Bonding with High Thermal Stability and Power Handling. J. Electron. Mater. 2018, 47, 368–377. [Google Scholar] [CrossRef]
- Kumar, K.G. A Novel Intermetallic Nickel Aluminide (Ni3Al) as an Alternative Automotive Body Material. Int. J. Eng. 2011, 11, 8. [Google Scholar]
- Kanetsuki, S.; Kuwahara, K.; Egawa, S.; Miyake, S.; Namazu, T. Effect of thickening outermost layers in Al/Ni multilayer film on thermal resistance of reactively bonded solder joints. Jpn. J. Appl. Phys. 2017, 56, 06GN16. [Google Scholar] [CrossRef]
- Kun, Y.; Hanqing, X.; Yilong, D.; Fei, T.; Sufeng, F.; Xueyan, Q.; Li, W. Bonding Process and Application Properties of an Al-Ni Layer Composite Sheet for Lithium-ion Battery Packaging. Rare Met. Mater. Eng. 2016, 45, 1100–1105. [Google Scholar] [CrossRef]
- Chuang, T.H.; Lin, H.J.; Chuang, C.H.; Yeh, W.T.; Hwang, J.D.; Chu, H.S. Solid Liquid Interdiffusion Bonding of (Pb, Sn)Te Thermoelectric Modules with Cu Electrodes Using a Thin-Film Sn Interlayer. J. Electron. Mater. 2014, 43, 4610–4618. [Google Scholar] [CrossRef]
- Lin, Y.C.; Lee, K.T.; Hwang, J.D.; Chu, H.S.; Hsu, C.C.; Chen, S.C.; Chuang, T.H. Solid Liquid Interdiffusion Bonding of Zn4Sb3 Thermoelectric Material with Cu Electrode. J. Electron. Mater. 2016, 45, 4935–4942. [Google Scholar] [CrossRef]
- ASTM D3359-17. Standard Test Methods for Rating Adhesion by Tape Test; ASTM International: West Conshohocken, PA, USA, 2017. [Google Scholar]
- ASTM D905-08. Standard Test Method for Strength Properties of Adhesive Bonds in Shear by Compression Loading. ASTM International: West Conshohocken, PA, USA, 2013. [Google Scholar]
- Dahal, T.; Kim, H.S.; Gahlawat, S.; Dahal, K.; Jie, Q.; Liu, W.; Lan, Y.; White, K.; Ren, Z. Transport and mechanical properties of the double-filled p-type skutterudites La0.68Ce0.22Fe4−xCoxSb12. Acta Mater. 2016, 117, 13–22. [Google Scholar] [CrossRef]
- Mallory, G.O.; Hajdu, J.B. Electroless Plating: Fundamentals and Applications; William Andrew: New York, NY, USA, 1990. [Google Scholar]
- Zhao, D.; Geng, H.; Teng, X. Fabrication and reliability evaluation of CoSb3/W–Cu thermoelectric element. J. Alloys Compd. 2012, 517, 198–203. [Google Scholar] [CrossRef]
- Chen, W.; Chen, S.; Tseng, S.; Hsiao, H.; Chen, Y.; Snyder, G.J.; Tang, Y. Interfacial reactions in Ni/CoSb3 couples at 450 °C. J. Alloys Compd. 2015, 632, 500–504. [Google Scholar] [CrossRef]
- Okamoto, H. Al-Ni (aluminum-nickel). J. Phase Equilibria 1993, 14, 257–259. [Google Scholar] [CrossRef]
- Ding, Z.; Hu, Q.; Lu, W.; Sun, S.; Xia, M.; Li, J. In situ observation on the formation of intermetallics compounds at the interface of liquid Al/solid Ni. Scr. Mater. 2017, 130, 214–218. [Google Scholar] [CrossRef]
- Edelstein, A.S.; Everett, R.K.; Richardson, G.R.; Qadri, S.B.; Foley, J.C.; Perepezko, J.H. Reaction kinetics and biasing in Al/Ni multilayers. Mater. Sci. Eng. A 1995, 195, 13–19. [Google Scholar] [CrossRef]
- Dhakal, R.; Huh, Y.; Galipeau, D.; Y, X. AlSb Compound Semiconductor as Absorber Layer in Thin Film Solar Cells. In Solar Cells—New Aspects and Solutions; Kosyachenko, L.A., Ed.; InTech: London, UK, 2011. [Google Scholar]
- Seith, W.; Heumann, T. Diffusion of Metals: Exchange Reactions; Springer Press: Berlin, Germany, 1955. [Google Scholar]
- Wołczyński, W.; Okane, T.; Senderowski, C.; Kania, B.; Zasada, D.; Janczak-Rusch, J. Meta-Stable Conditions of Diffusion Brazing. Arch. Metall. Mater. 2011, 56, 311–323. [Google Scholar] [CrossRef]
- Tumminello, S.; Sommadossi, S. Growth kinetics of intermetallic phases in transient liquid phase bonding process (TLPB) in Al/Ni system. Defect Diffus. Forum 2012, 323, 465–470. [Google Scholar] [CrossRef]
- MacDonald, W.D.; Eagar, T.W. Isothermal solidification kinetics of diffusion brazing. Metall. Mater. Trans. A 1998, 29, 315–325. [Google Scholar] [CrossRef]
- Eremenko, V.N.; Natanzon, Y.V.; Titov, V.P. Dissolution kinetics and diffusion coefficients of iron, cobalt, and nickel in molten aluminum. Mater. Sci. 1978, 14, 579–584. [Google Scholar] [CrossRef]
- Bjørk, R. The Universal Influence of Contact Resistance on the Efficiency of a Thermoelectric Generator. J. Electron. Mater. 2015, 44, 2869–2876. [Google Scholar] [CrossRef]
- Chuang, T.-H.; Yeh, W.-T.; Chuang, C.-H.; Hwang, J.-D. Improvement of bonding strength of a (Pb, Sn)Te-Cu contact manufactured in a low temperature SLID-bonding process. J. Alloys Compd. 2014, 613, 46–54. [Google Scholar] [CrossRef]
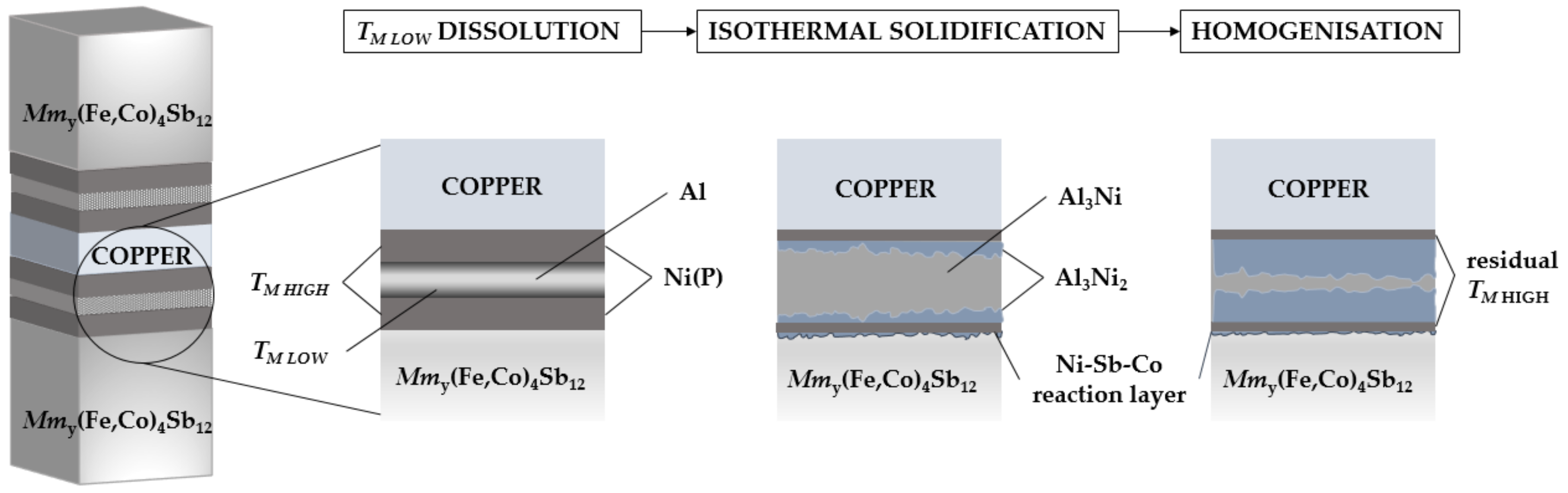
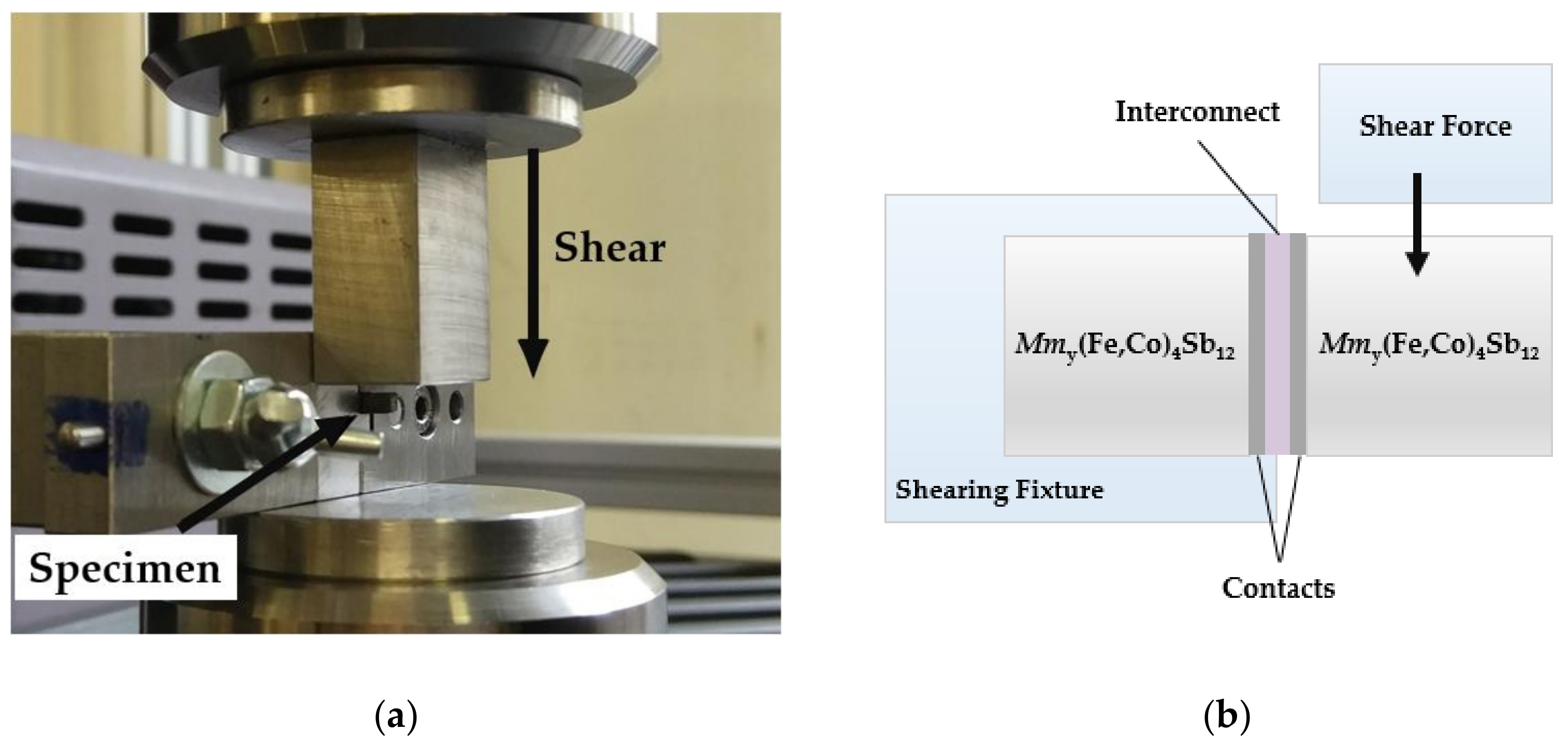
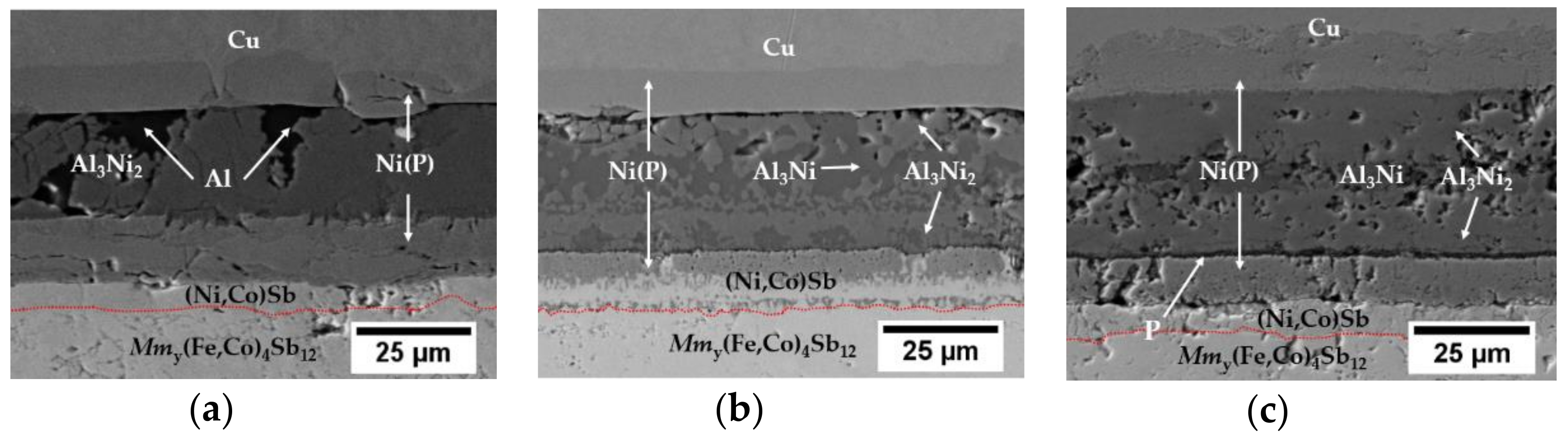
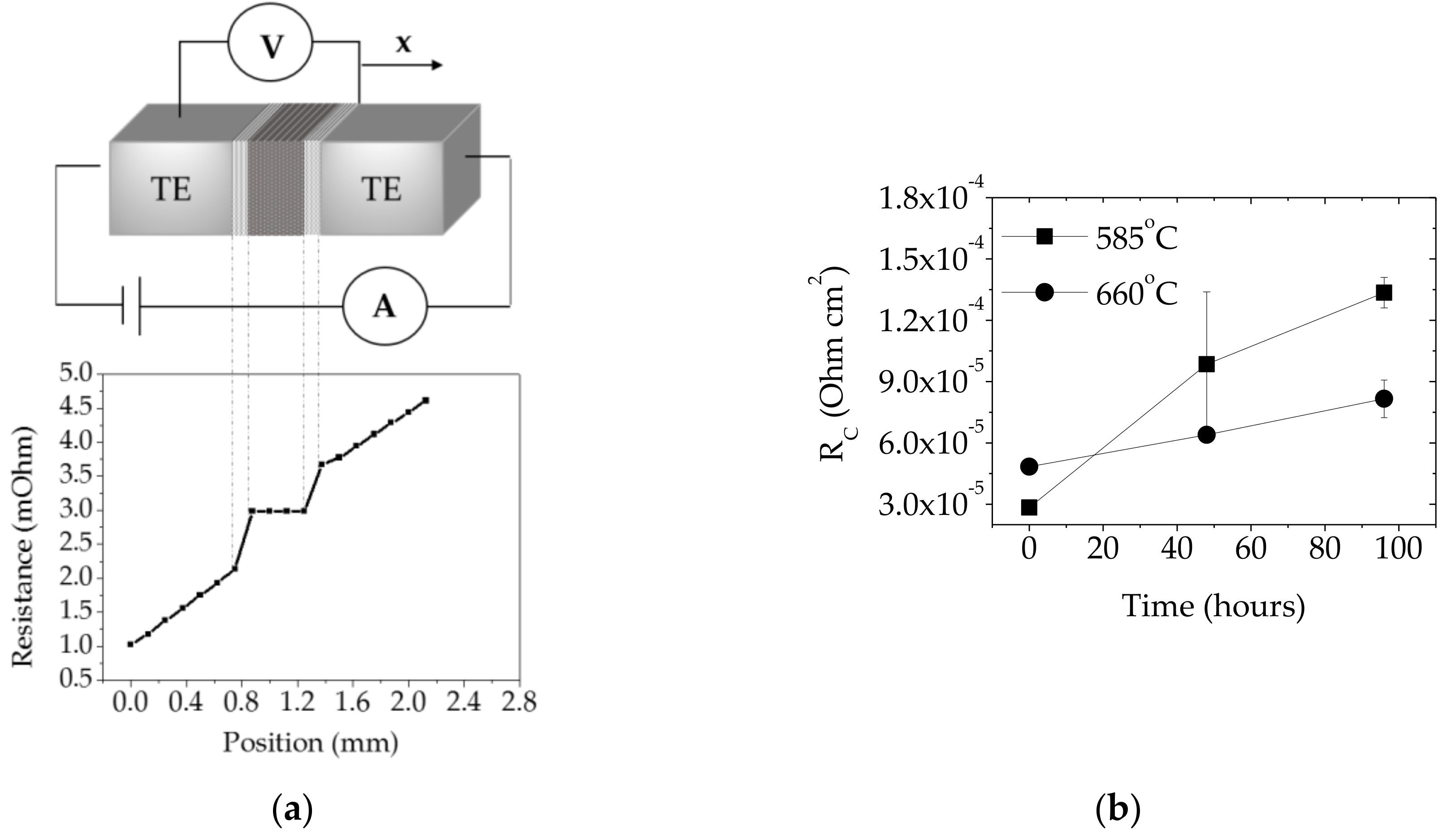

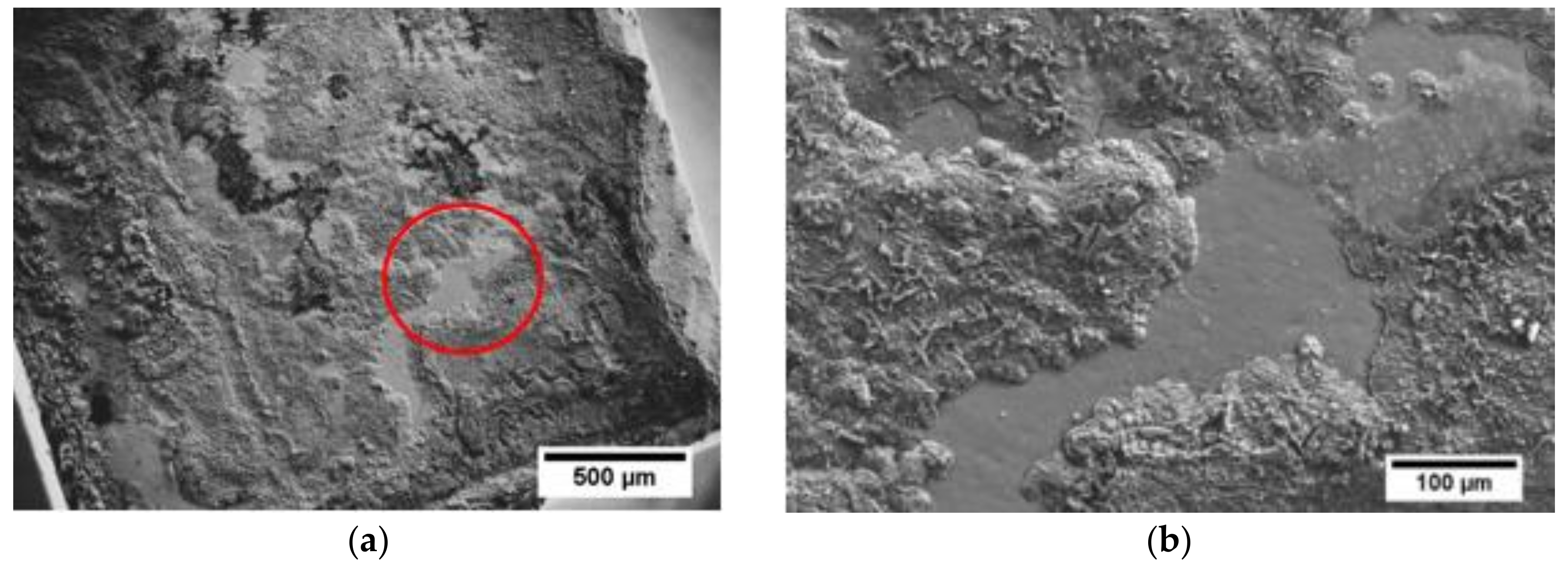
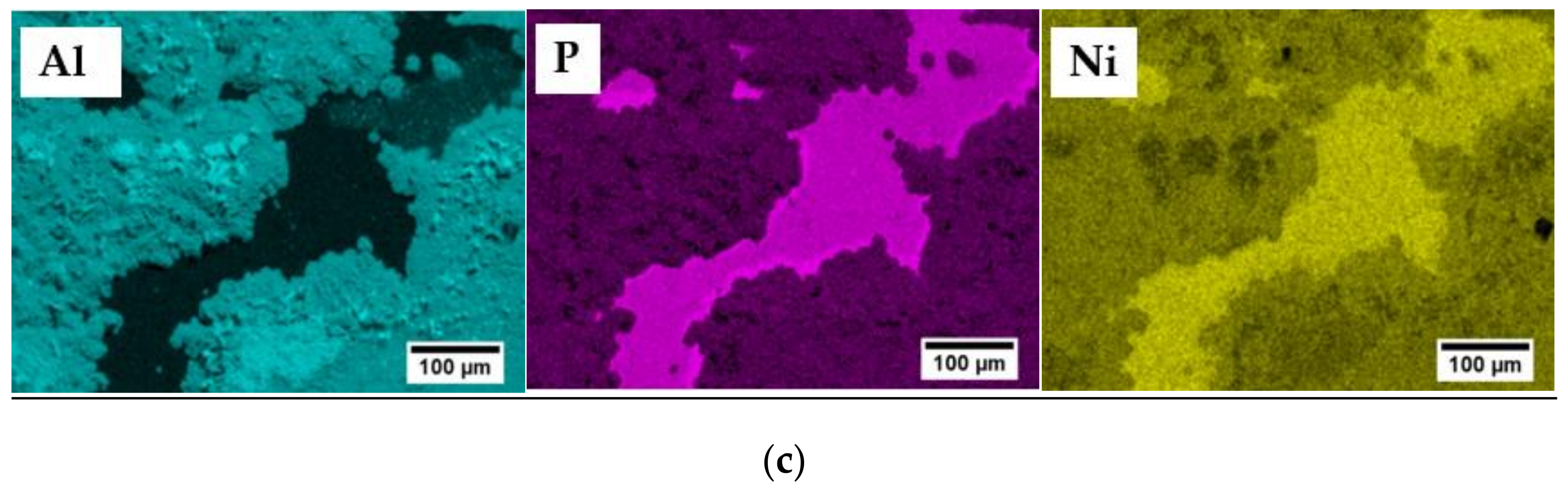
© 2018 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Placha, K.; Tuley, R.S.; Salvo, M.; Casalegno, V.; Simpson, K. Solid-Liquid Interdiffusion (SLID) Bonding of p-Type Skutterudite Thermoelectric Material Using Al-Ni Interlayers. Materials 2018, 11, 2483. https://doi.org/10.3390/ma11122483
Placha K, Tuley RS, Salvo M, Casalegno V, Simpson K. Solid-Liquid Interdiffusion (SLID) Bonding of p-Type Skutterudite Thermoelectric Material Using Al-Ni Interlayers. Materials. 2018; 11(12):2483. https://doi.org/10.3390/ma11122483
Chicago/Turabian StylePlacha, Katarzyna, Richard S. Tuley, Milena Salvo, Valentina Casalegno, and Kevin Simpson. 2018. "Solid-Liquid Interdiffusion (SLID) Bonding of p-Type Skutterudite Thermoelectric Material Using Al-Ni Interlayers" Materials 11, no. 12: 2483. https://doi.org/10.3390/ma11122483
APA StylePlacha, K., Tuley, R. S., Salvo, M., Casalegno, V., & Simpson, K. (2018). Solid-Liquid Interdiffusion (SLID) Bonding of p-Type Skutterudite Thermoelectric Material Using Al-Ni Interlayers. Materials, 11(12), 2483. https://doi.org/10.3390/ma11122483






