Non-Contact Degradation Evaluation for IGBT Modules Using Eddy Current Pulsed Thermography Approach
Abstract
1. Introduction
2. Thermal RC Network Degradation and Detection
2.1. Characteristic of Degradation in an IGBT Module
2.2. Degradation Thermal Modeling
3. ECPT Based Non-Contact Detection of Thermal RC Network Degradation
3.1. Thermography Technologies
3.2. Operation Principle of ECPT System
3.3. Heat Conduction Analysis
4. Finite Element Simulation and Experimental Results
4.1. Simulation Models and Analysis
4.2. Experimental Result and Discussion
4.3. Comparison and Analysis
5. Conclusions
Author Contributions
Funding
Conflicts of Interest
References
- Agustin, C.A.; Yu, J.; Lin, C.; Fu, X. A Modulated Model Predictive Current Controller for Interior Permanent-Magnet Synchronous Motors. Energies 2019, 12, 2885. [Google Scholar] [CrossRef]
- Ryndzionek, R.; Sienkiewicz, Ł. Evolution of the HVDC Link Connecting Offshore Wind Farms to Onshore Power Systems. Energies 2020, 13, 1914. [Google Scholar] [CrossRef]
- Schulze, H.-J.; Niedernostheide, F.-J.; Pfirsch, F.; Baburske, R. Limiting Factors of the Safe Operating Area for Power Devices. IEEE Trans. Electron Devices 2013, 60, 551–562. [Google Scholar] [CrossRef]
- Ji, B.; Song, X.; Cao, W.; Pickert, V.; Hu, Y.; Mackersie, J.W.; Pierce, G. In Situ Diagnostics and Prognostics of Solder Fatigue in IGBT Modules for Electric Vehicle Drives. IEEE Trans. Power Electron. 2015, 30, 1535–1543. [Google Scholar]
- Ji, B.; Pickert, V.; Cao, W.; Zahawi, B. In Situ Diagnostics and Prognostics of Wire Bonding Faults in IGBT Modules for Electric Vehicle Drives. IEEE Trans. Power Electron. 2013, 28, 5568–5577. [Google Scholar] [CrossRef]
- Ciappa, M. Selected failure mechanisms of modern power modules. Microelectron. Reliab. 2002, 42, 653–667. [Google Scholar] [CrossRef]
- Bahman, A.S.; Iannuzzo, F.; Uhrenfeldt, C.; Blaabjerg, F.; Munk-Nielsen, S. Modeling of Short-Circuit-Related Thermal Stress in Aged IGBT Modules. IEEE Trans. Ind. Appl. 2017, 53, 4788–4795. [Google Scholar] [CrossRef]
- Oh, H.; Han, B.; McCluskey, P.; Han, C.; Youn, B.D. Physics-of-Failure, Condition Monitoring, and Prognostics of Insulated Gate Bipolar Transistor Modules: A Review. IEEE Trans. Power Electron. 2015, 30, 2413–2426. [Google Scholar] [CrossRef]
- Katsis, D.C.; van Wyk, J.D. Void-induced thermal impedance in power semiconductor modules: Some transient temperature effects. IEEE Trans. Ind. Appl. 2003, 39, 1239–1246. [Google Scholar] [CrossRef]
- Ma, K.; Bahman, A.S.; Beczkowski, S.; Blaabjerg, F. Complete Loss and Thermal Model of Power Semiconductors Including Device Rating Information. IEEE Trans. Power Electron. 2015, 30, 2556–2569. [Google Scholar] [CrossRef]
- Smet, V.; Forest, F.; Huselstein, J.; RASHED, A.; Richardeau, F. Evaluation of Vce Monitoring as a Real-Time Method to Estimate Aging of Bond Wire-IGBT Modules Stressed by Power Cycling. IEEE Trans. Ind. Electron. 2013, 60, 2760–2770. [Google Scholar] [CrossRef]
- Zhang, J.; Du, X.; Yu, Y.; Zheng, S.; Sun, P.; Tai, H. Thermal Parameter Monitoring of IGBT Module Using Junction Temperature Cooling Curves. IEEE Trans. Ind. Electron. 2019, 66, 8148–8160. [Google Scholar] [CrossRef]
- Kong, Q.; Du, M.; Ouyang, Z.; Wei, K.; Hurley, W.G. A Method to Monitor IGBT Module Bond Wire Failure Using On-State Voltage Separation Strategy. Energies 2019, 12, 1791. [Google Scholar] [CrossRef]
- Xiang, D.; Ran, L.; Tavner, P.; Yang, S.; Bryant, A.; Mawby, P. Condition Monitoring Power Module Solder Fatigue Using Inverter Harmonic Identification. IEEE Trans. Power Electron. 2012, 27, 235–247. [Google Scholar] [CrossRef]
- Avenas, Y.; Dupont, L.; Khatir, Z. Temperature Measurement of Power Semiconductor Devices by Thermo-Sensitive Electrical Parameters—A Review. IEEE Trans. Power Electron. 2012, 27, 3081–3092. [Google Scholar] [CrossRef]
- Zhang, J.; Du, M.; Jing, L.; Wei, K.; Hurley, W.G. IGBT Junction Temperature Measurements: Inclusive of Dynamic Thermal Parameters. IEEE Trans. Device Mater. Relib. 2019, 19, 333–340. [Google Scholar] [CrossRef]
- Dupont, L.; Avenas, Y.; Jeannin, P. Comparison of Junction Temperature Evaluations in a Power IGBT Module Using an IR Camera and Three Thermosensitive Electrical Parameters. IEEE Trans. Ind. Appl. 2013, 49, 1599–1608. [Google Scholar] [CrossRef]
- Hu, Z.; Du, M.; Wei, K.; Hurley, W.G. An Adaptive Thermal Equivalent Circuit Model for Estimating the Junction Temperature of IGBTs. IEEE Trans. Emerg. Sel. Top. Power Electron. 2019, 7, 392–403. [Google Scholar] [CrossRef]
- Li, K.; Tian, G.Y.; Cheng, L.; Yin, A.; Cao, W.; Crichton, S. State Detection of Bond Wires in IGBT Modules Using Eddy Current Pulsed Thermography. IEEE Trans. Power Electron. 2014, 29, 5000–5009. [Google Scholar] [CrossRef]
- Cheng, L.; Tian, G.Y. Transient Thermal Behavior of Eddy-Current Pulsed Thermography for Nondestructive Evaluation of Composites. IEEE Trans. Instrum. Meas. 2013, 62, 1215–1222. [Google Scholar] [CrossRef]
- Bui, H.K.; Wasselynck, G.; Trichet, D.; Ramdane, B.; Berthiau, G.; Fouladgar, J. 3-D Modeling of Thermo Inductive Non Destructive Testing Method Applied to Multilayer Composite. IEEE Trans. Magn. 2013, 49, 1949–1952. [Google Scholar] [CrossRef]
- Nnebe, I.M.; Feger, C. Drainage-Induced Dry-Out of Thermal Greases. IEEE Trans. Adv. Packag. 2008, 31, 512–518. [Google Scholar] [CrossRef]
- Shammas, N.Y.A.; Rodriguez, M.P.; Plumpton, A.T.; Newcombe, D. Finite element modelling of thermal fatigue effects in IGBT modules. IEE Proc. Circ. Devices Syst. 2001, 148, 95–100. [Google Scholar] [CrossRef]
- Batard, C.; Ginot, N.; Antonios, J. Lumped Dynamic Electrothermal Model of IGBT Module of Inverters. IEEE Trans. Compon. Pack. Manuf. Technol. 2015, 5, 355–364. [Google Scholar] [CrossRef]
- Wintrich, A.; Nicolai, U.; Tursky, W.; Reimann, T. Application Manual Power Semiconductors, 2nd ed.; SEMIKRON International GmbH: Ilmenau, Germany, 2015. [Google Scholar]
- Bohm, J.; Wolter, K.J. Inductive excited lock-in thermography for electronic packages and modules. In Proceedings of the 33rd International Spring Seminar Electronics Technology (ISSE), Warsaw, Poland, 12–16 May 2010; pp. 190–195. [Google Scholar]
- Yin, A.; Gao, B.; Yun Tian, G.; Woo, W.L.; Li, K. Physical interpretation and separation of eddy current pulsed thermography. J. Appl. Phys. 2013, 113, 64101. [Google Scholar] [CrossRef]
- Alamin, M.; Tian, G.Y.; Andrews, A.; Jackson, P. Principal Component Analysis of Pulsed Eddy Current Response from Corrosion in Mild Steel. IEEE Sens. J. 2012, 12, 2548–2553. [Google Scholar] [CrossRef]
- May, D.; Wunderle, B.; Schacht, R.; Michel, B. Transient thermal response as failure analytical tool—A comparison of different techniques. In Proceedings of the 14th International Thermal, Mechanical and Multi-Physics Simulation and Experiments in Microelectronics and Microsystems (EuroSimE), Wroclaw, Poland, 14–17 April 2013; pp. 1–5. [Google Scholar]
- Riccio, M.; Irace, A.; Breglio, G. Lock-in thermography for the localization of prebreakdown leakage current on power diodes. In Proceedings of the Ph.D. Research in Microelectronics and Electronics (PRIME), Cork, Ireland, 12–17 July 2009; pp. 208–211. [Google Scholar]
- Gershman, I.; Bernstein, J.B. Nondestructive Quantitative Analysis of Crack Propagation in Solder Joints. IEEE Trans. Compon. Pack. Manuf. Technol. 2013, 3, 1263–1270. [Google Scholar] [CrossRef]


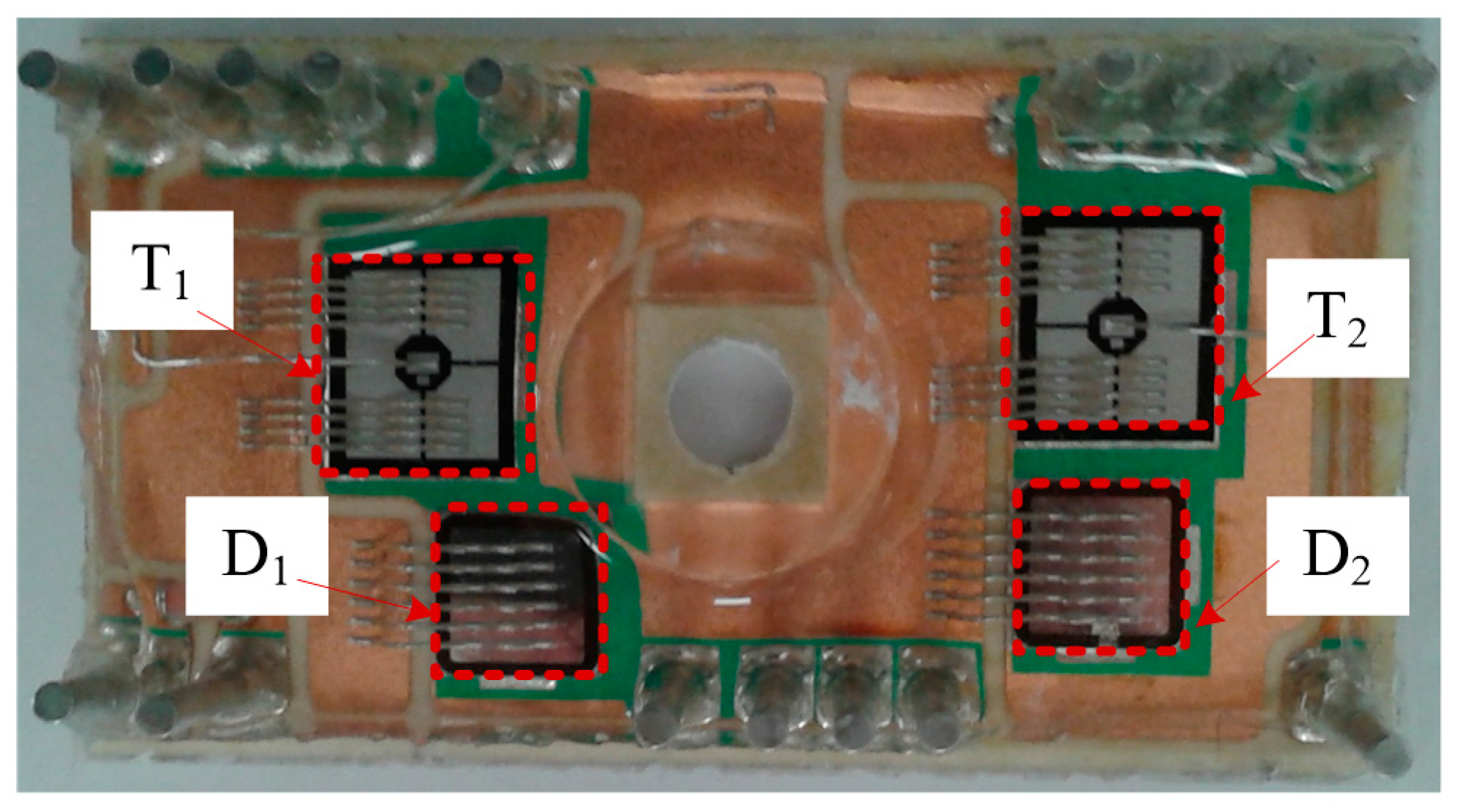





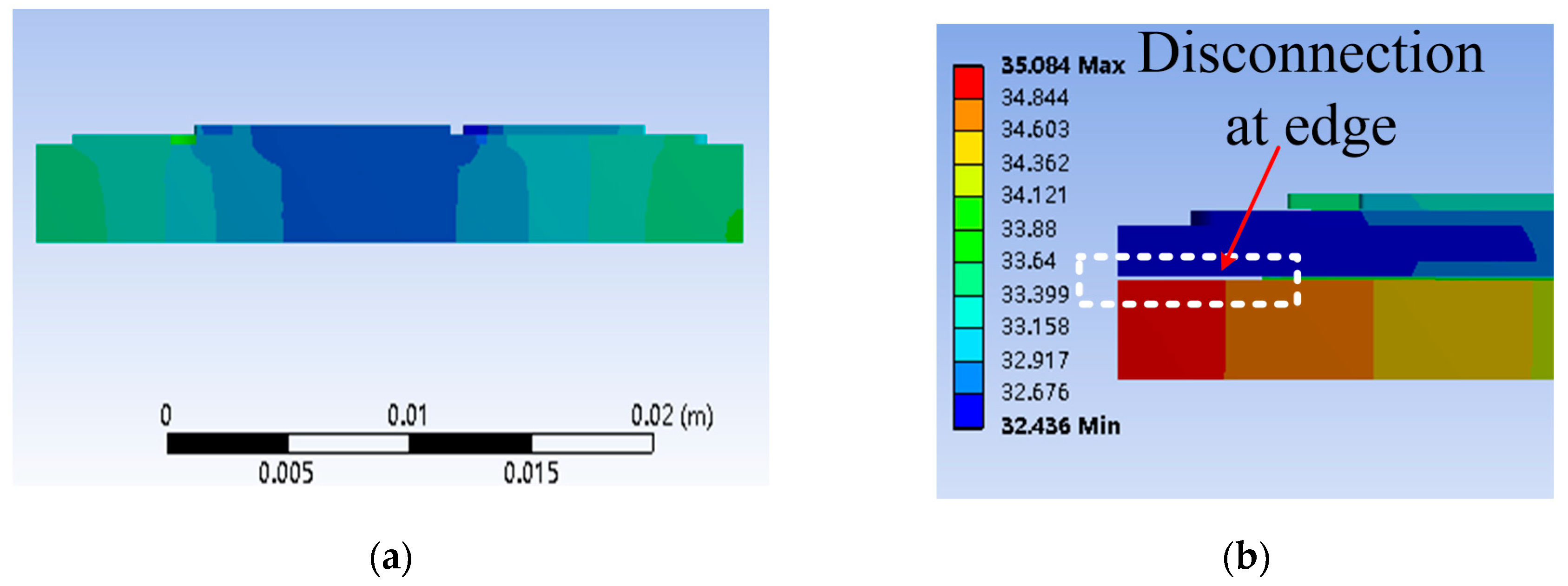

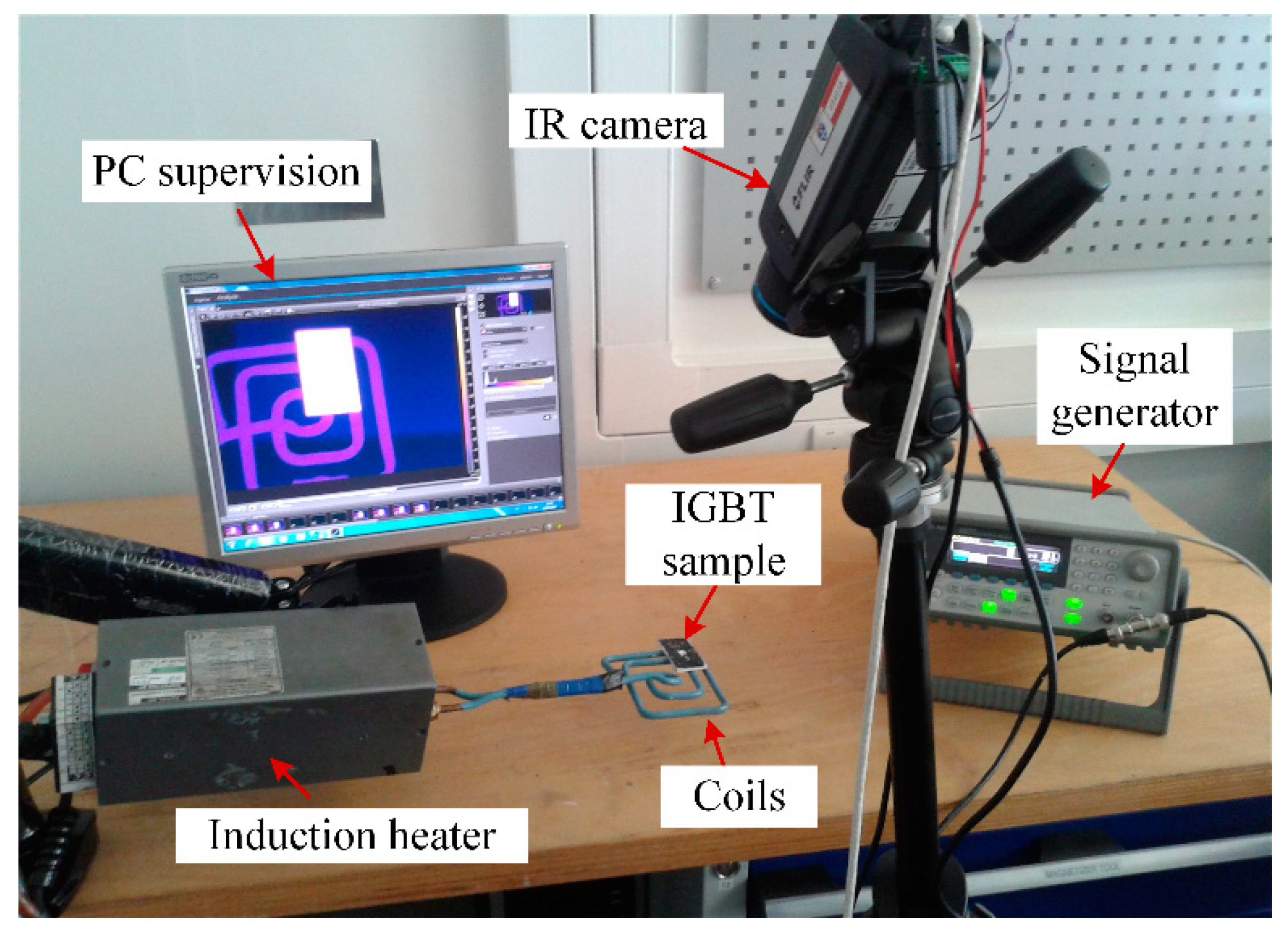
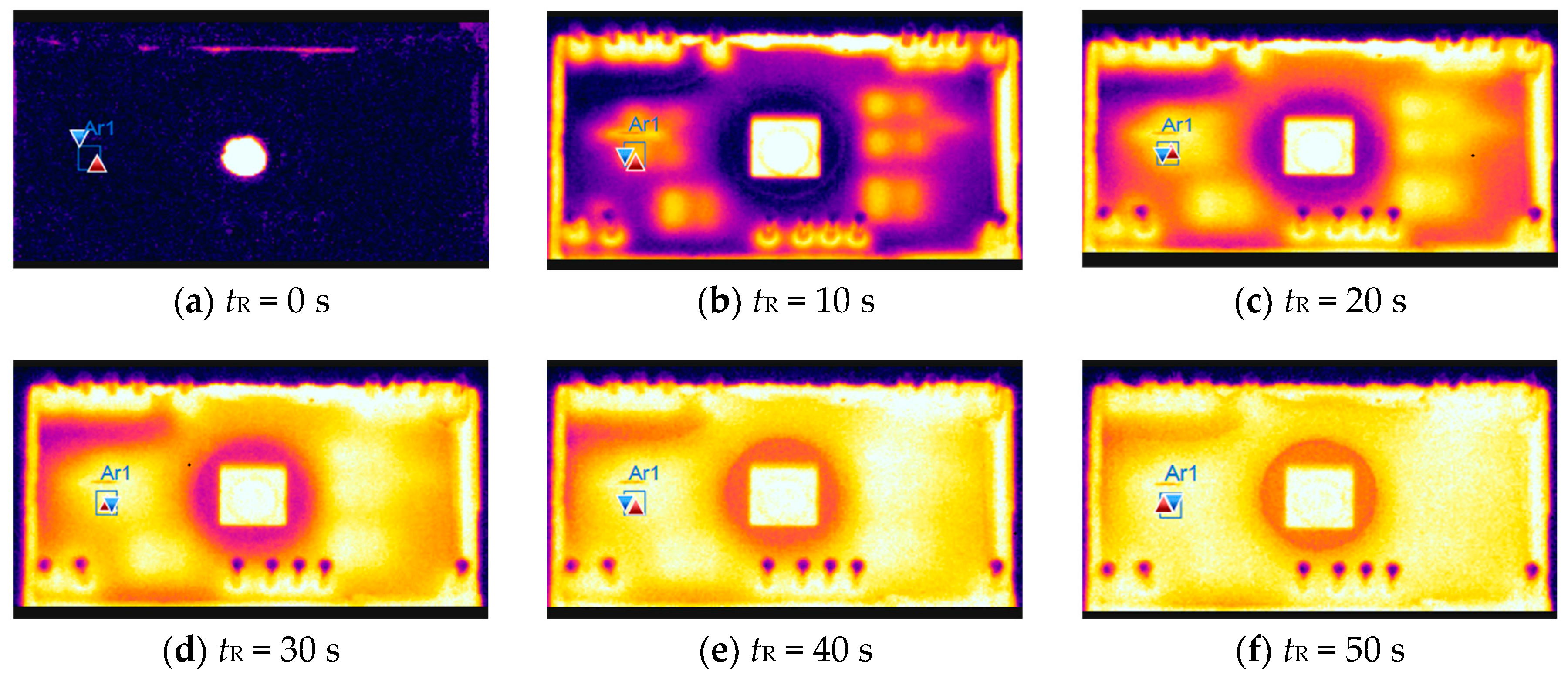
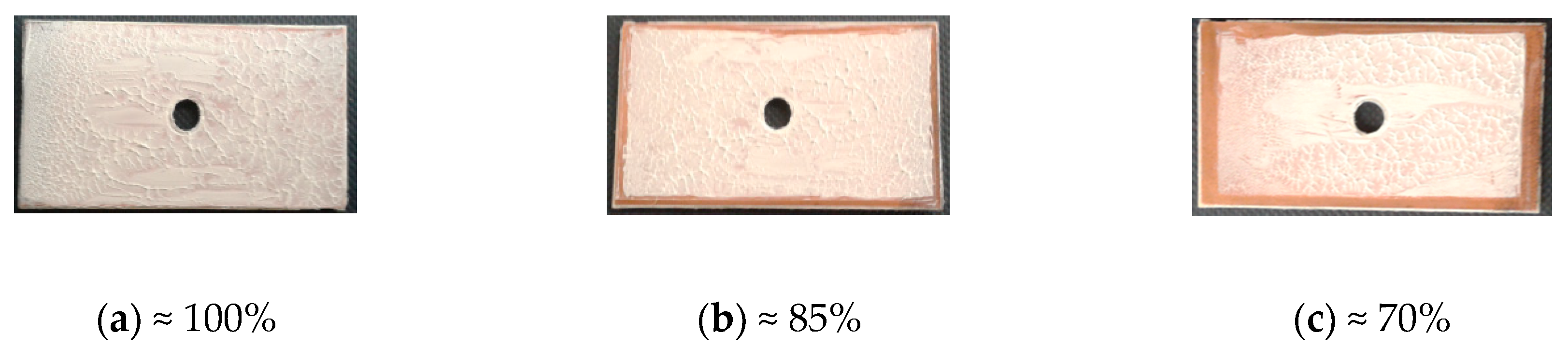
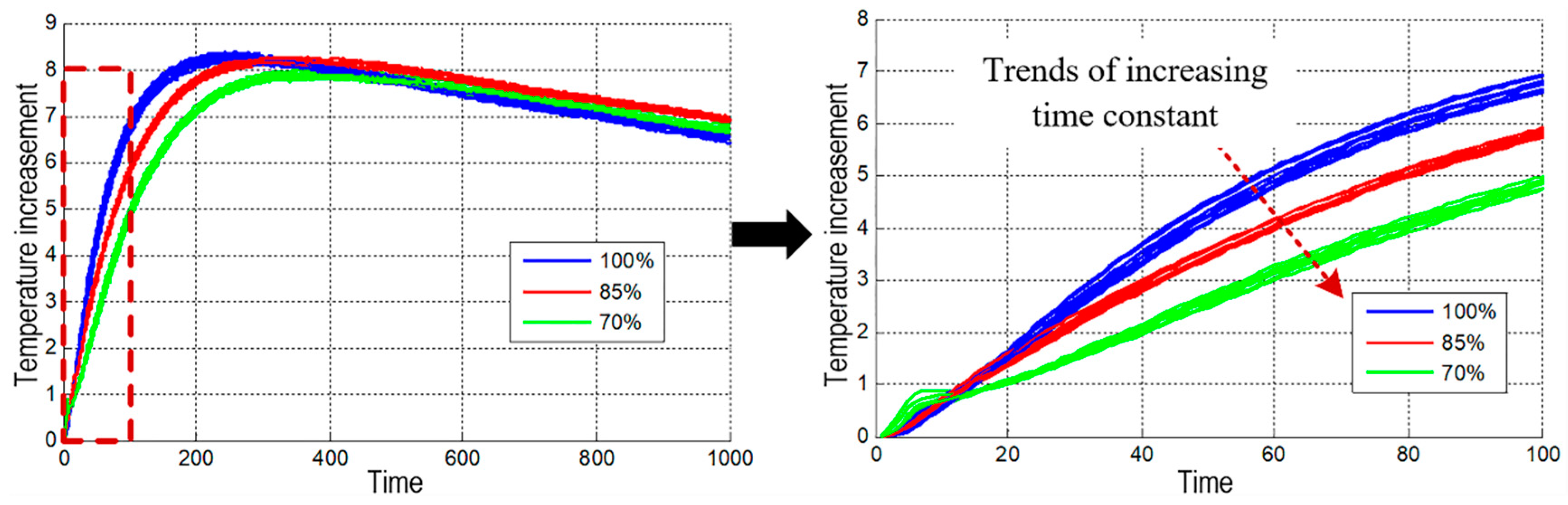
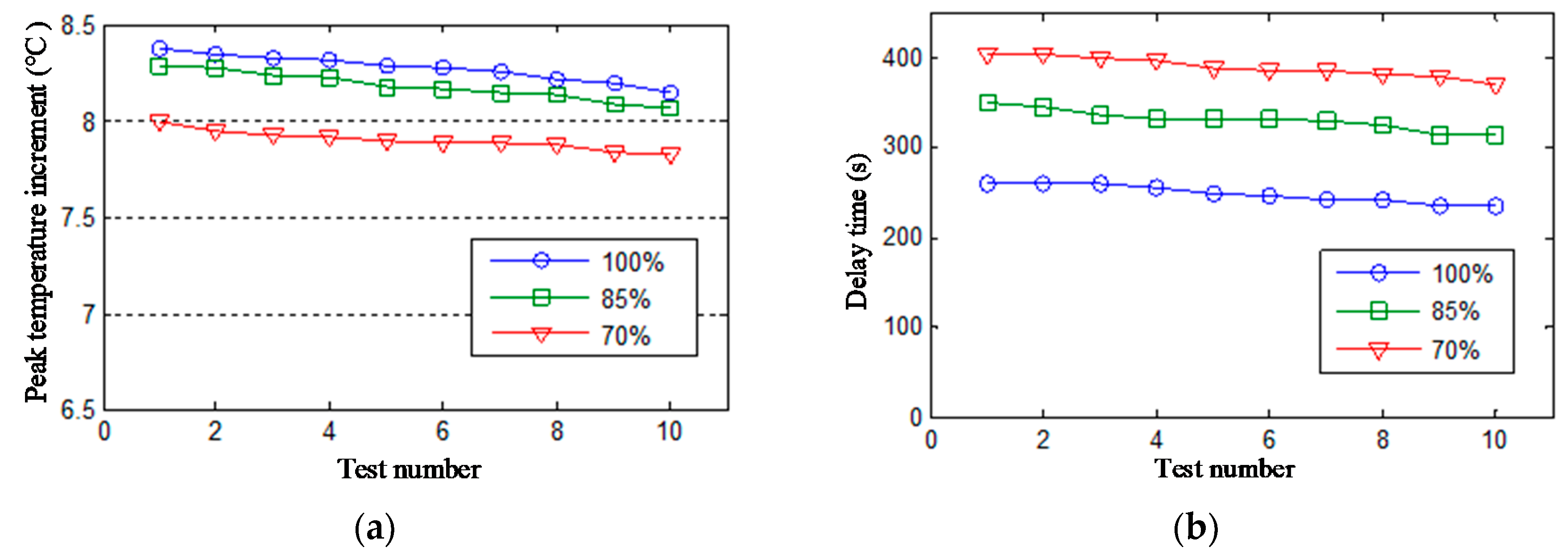
| Designation and Material | Thickness (µm) | Density (kg/m3) | Thermal Conductivity (W/m·K) | Specific Heat Capacity (J/kg·K) |
|---|---|---|---|---|
| Silicon chip | 300 | 2330 | 148 | 712 |
| Die attach solder | 50 | 7400 | 57 | 226 |
| Up copper layer | 300 | 8960 | 390 | 390 |
| Ceramic-Al2O3 | 700 | 3780 | 24 | 830 |
| Down copper layer | 300 | 8960 | 390 | 390 |
| Thermal grease | 50 | 2000 | 0.67 | 300 |
| Parameters | Value | Parameters | Value |
|---|---|---|---|
| Inspected IGBT module | SK75GB12T4T | Recording duration | 60 s |
| Induction heating source | 2.4 kW | Infrared (IR) camera | FLIR SC655 |
| Heating duration | 200 ms | Frame rate of IR camera | 25 |
| Excitation current frequency | 140–400 kHz | Ambient temperature | 22 °C |
| Parameters | Electrical Parameters Based Method | Proposed ECPT Method |
|---|---|---|
| Heat incentive | The heat energy is supplied by power source, and it is an active heat method. | The heat energy is induced by the eddy current in the metal. It is a positive heat method. |
| Temperature measurement | The chip and module temperature are measured by some temperature sensitive electrical parameters (TSEP) or thermal couples. | The chip and module temperature can be captured by an infrared camera at one time. |
| Calibration | It is necessary to calibrate the relationships between electrical parameters and temperature. | Automatic calibration in IR camera system. |
| Operation | The heat excitation and temperature measurement process should be in contact with inspected objects. | The heat excitation and temperature measurement process are carried out by a non-contact method. |
© 2020 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Liu, X.; Tian, G.; Chen, Y.; Luo, H.; Zhang, J.; Li, W. Non-Contact Degradation Evaluation for IGBT Modules Using Eddy Current Pulsed Thermography Approach. Energies 2020, 13, 2613. https://doi.org/10.3390/en13102613
Liu X, Tian G, Chen Y, Luo H, Zhang J, Li W. Non-Contact Degradation Evaluation for IGBT Modules Using Eddy Current Pulsed Thermography Approach. Energies. 2020; 13(10):2613. https://doi.org/10.3390/en13102613
Chicago/Turabian StyleLiu, Xingliang, Guiyun Tian, Yu Chen, Haoze Luo, Jian Zhang, and Wuhua Li. 2020. "Non-Contact Degradation Evaluation for IGBT Modules Using Eddy Current Pulsed Thermography Approach" Energies 13, no. 10: 2613. https://doi.org/10.3390/en13102613
APA StyleLiu, X., Tian, G., Chen, Y., Luo, H., Zhang, J., & Li, W. (2020). Non-Contact Degradation Evaluation for IGBT Modules Using Eddy Current Pulsed Thermography Approach. Energies, 13(10), 2613. https://doi.org/10.3390/en13102613







