Wafer Type Ion Energy Monitoring Sensor for Plasma Diagnosis
Abstract
1. Introduction
2. IEMS
2.1. Principle of IEMS and Ion Energy
2.2. The Design of IEMS
3. Experiment Detail
Experiment Setup
4. Results and Discussion
5. Conclusions
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Gottscho, R.A.; Jurgensen, C.W.; Vitkavage, D.J. Microscopic uniformity in plasma etching. J. Vac. Sci. Technol. B Microelectron. Nanometer Struct. Process. Meas. Phenomena 1992, 10, 2133–2147. [Google Scholar] [CrossRef]
- Adamovich, I.; Baalrud, S.D.; Bogaerts, A.; Bruggeman, P.J.; Cappelli, M.; Colombo, V.; Czarnetzki, U.; Ebert, U.; Eden, J.G.; Favia, P. The 2017 Plasma Roadmap: Low temperature plasma science and technology. J. Phys. D Appl. Phys. 2017, 50, 323001. [Google Scholar] [CrossRef]
- Hayashi, H.; Kurihara, K.K.K.; Sekine, M.S.M. Characterization of highly selective SiO2/Si3N4 etching of high-aspect-ratio holes. Jpn. J. Appl. Phys. 1996, 35, 2488. [Google Scholar] [CrossRef]
- Wang, S.B.; Wendt, A.E. Control of ion energy distribution at substrates during plasma processing. J. Appl. Phys. 2000, 88, 643–646. [Google Scholar] [CrossRef]
- Bruce, R.H.; Reinberg, A.R. Profile Control with D-C Bias in Plasma Etching. J. Electrochem. Soc. 1982, 129, 393. [Google Scholar] [CrossRef]
- Sobolewski, M.A.; Wang, Y.; Goyette, A. Measurements and modeling of ion energy distributions in high-density, radio-frequency biased CF 4 discharges. J. Appl. Phys. 2002, 91, 6303–6314. [Google Scholar] [CrossRef]
- Eriguchi, K. Modeling of defect generation during plasma etching and its impact on electronic device performance—Plasma-induced damage. J. Phys. D Appl. Phys. 2017, 50, 333001. [Google Scholar] [CrossRef]
- Gahan, D.; Dolinaj, B.; Hopkins, M.B. Retarding field analyzer for ion energy distribution measurements at a radio-frequency biased electrode. Rev. Sci. Instrum. 2008, 79, 033502. [Google Scholar] [CrossRef]
- Akatsuka, H. Optical Emission Spectroscopic (OES) analysis for diagnostics of electron density and temperature in non-equilibrium argon plasma based on collisional-radiative model. Adv. Phys. X 2019, 4, 1592707. [Google Scholar] [CrossRef]
- Lee, Y.I.; Song, W.S.; Hong, S.J. In situ monitoring of plasma ignition step in capacitively coupled plasma systems. Jpn. J. Appl. Phys. 2020, 59, SJJD02. [Google Scholar] [CrossRef]
- Evdokimov, K.E.; Konischev, M.E.; Pichugin, V.F.; Sun, Z. Study of argon ions density and electron temperature and density in magnetron plasma by optical emission spectroscopy and collisional-radiative model. Resour.-Effic. Technol. 2017, 3, 187–193. [Google Scholar] [CrossRef]
- Arshad, M.Z.; Jo, K.J.; Kim, H.G.; Hong, S.J. Optical in situ monitoring of plasma-enhanced atomic layer deposition process. Jpn. J. Appl. Phys. 2018, 57, 06JF05. [Google Scholar] [CrossRef]
- Arshad, M.Z.; Hong, S.J. In-situ detection method of abnormal plasma discharge in plasma-assisted deposition processes. Trans. Electr. Electron. Mater. 2018, 19, 96–100. [Google Scholar] [CrossRef]
- An, S.R.; Choi, J.E.; Hong, S.J. In-situ process monitoring for eco-friendly chemical vapor deposition chamber cleaning. J. Korean Phys. Soc. 2021, 79, 1027–1036. [Google Scholar] [CrossRef]
- Matsutani, A.; Ohtsuki, H.; Koyama, F.; Iga, K. Plasma diagnostics in inductively coupled plasma etching using Cl2/Xe. Jpn. J. Appl. Phys. 2000, 39, 1435. [Google Scholar] [CrossRef]
- Burlacov, I.; Börner, K.; Spies, H.J.; Biermann, H.; Lopatik, D.; Zimmermann, H.; Röpcke, J. In-situ monitoring of plasma enhanced nitriding processes using infrared absorption and mass spectroscopy. Surf. Coat. Technol. 2012, 206, 3955–3960. [Google Scholar] [CrossRef]
- Lee, N.; Kwon, O.; Chung, C.W. Correlation of RF impedance with Ar plasma parameters in semiconductor etch equipment using inductively coupled plasma. AIP Adv. 2021, 11, 025027. [Google Scholar] [CrossRef]
- Kang, G.G.; An, S.R.; Kim, K.P.; Hong, S. An in-situ monitoring method for PECVD process equipment condition. Plasma Sci. Technol. 2019, 21, 064003. [Google Scholar] [CrossRef]
- Yokoshima, I. RF impedance measurements by voltage-current detection. IEEE Trans. Instrum. Meas. 1993, 42, 524–527. [Google Scholar] [CrossRef]
- Hopwood, J.; Guarnieri, C.R.; Whitehair, S.J.; Cuomo, J.J. Langmuir probe measurements of a radio frequency induction plasma. J. Vac. Sci. Technol. A Vac. Surf. Film. 1993, 11, 152–156. [Google Scholar] [CrossRef]
- Cox, T.I.; Deshmukh, V.G.I.; Hope, D.A.O.; Hydes, A.J.; Braithwaite, N.S.J.; Benjamin, N.M.P. The use of Langmuir probes and optical emission spectroscopy to measure electron energy distribution functions in RF-generated argon plasmas. J. Phys. D Appl. Phys. 1987, 20, 820. [Google Scholar] [CrossRef]
- Merlino, R.L. Understanding Langmuir probe current-voltage characteristics. Am. J. Phys. 2007, 75, 1078–1085. [Google Scholar] [CrossRef]
- Kim, Y.D.; Lee, H.C.; Chung, C.W. A study on the maximum power transfer condition in an inductively coupled plasma using transformer circuit model. Phys. Plasmas 2013, 20, 093508. [Google Scholar] [CrossRef]
- Irimiciuc, S.A.; Chertopalov, S.; Lancok, J.; Craciun, V. Langmuir Probe technique for plasma characterization during pulsed laser Deposition process. Coatings 2021, 11, 762. [Google Scholar] [CrossRef]
- Kim, J.H.; Koo, Y.S.; Song, W.S.; Hong, S.J. On-Wafer Temperature Monitoring Sensor for Condition Monitoring of Repaired Electrostatic Chuck. Electronics 2022, 11, 880. [Google Scholar] [CrossRef]
- Kawamura, E.; Vahedi, V.; Lieberman, M.A.; Birdsall, C.K. Ion energy distributions in rf sheaths; review, analysis and simulation. Plasma Sources Sci. Technol. 1999, 8, R45. [Google Scholar] [CrossRef]
- Langmuir, I. The effect of space charge and residual gases on thermionic currents in high vacuum. Phys. Rev. 1913, 2, 450. [Google Scholar] [CrossRef]
- Gahan, D.; Daniels, S.; Hayden, C.; Scullin, P.; O’sullivan, D.; Pei, Y.T.; Hopkins, M.B. Ion energy distribution measurements in rf and pulsed dc plasma discharges. Plasma Sources Sci. Technol. 2012, 21, 024004. [Google Scholar] [CrossRef]
- Kim, J.H.; Kim, Y.C.; Chung, C.W. Experimental investigation on plasma parameter profiles on a wafer level with reactor gap lengths in an inductively coupled plasma. Phys. Plasmas 2015, 22, 073502. [Google Scholar] [CrossRef]
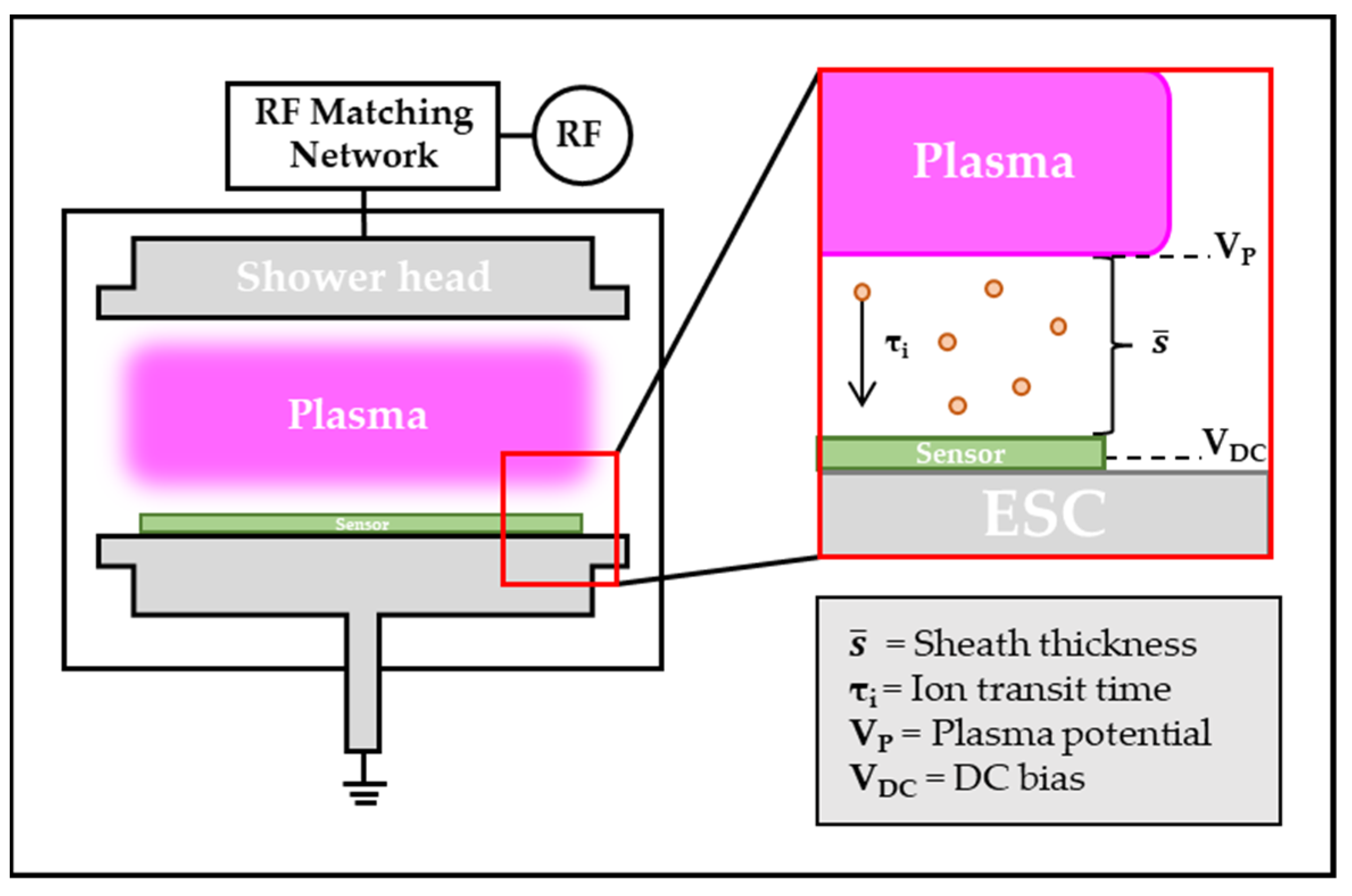


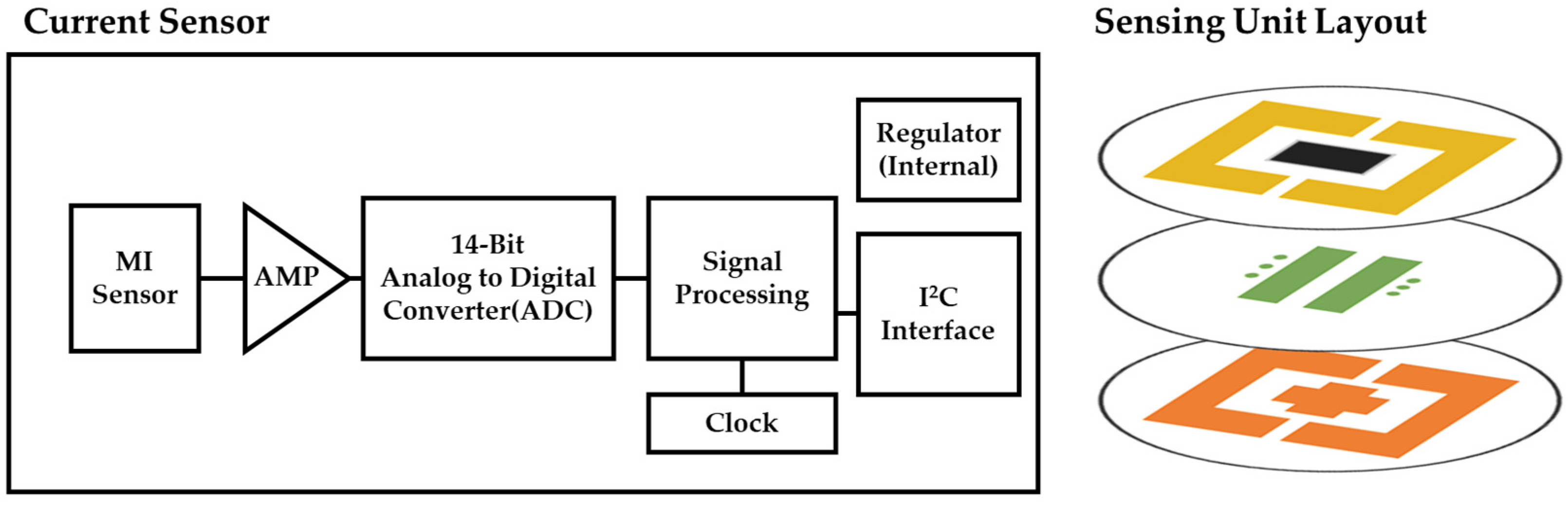

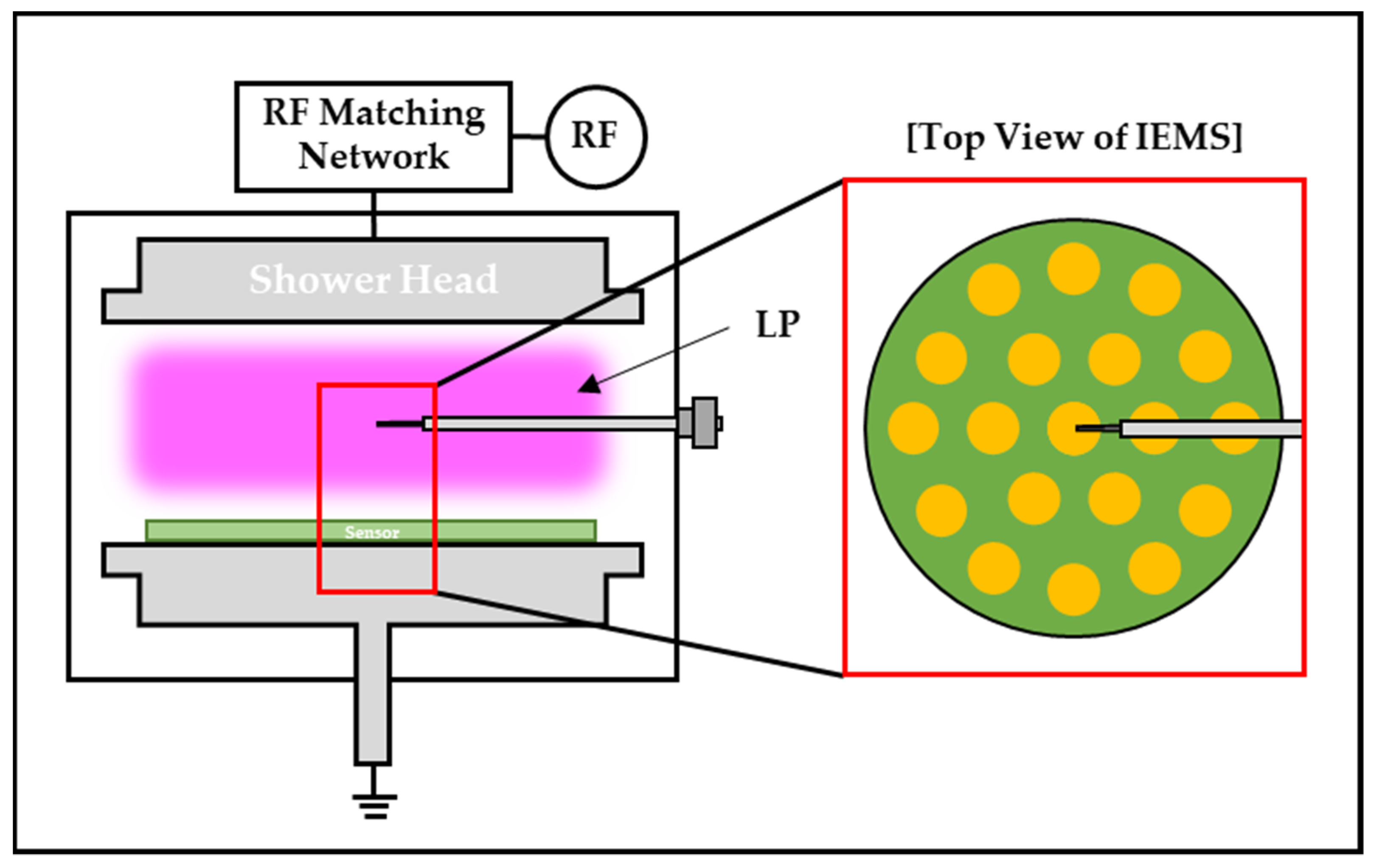







| Parameter (Unit) | Value | ||
|---|---|---|---|
| Radial position (mm) | 0 | 30 | 60 |
| Pressure (mTorr) | 50 | ||
| RF power (W) | 100 | ||
| Ar flow rate (sccm) | 30 | ||
| Parameter (Unit) | Value | ||
|---|---|---|---|
| Pressure (mTorr) | 30 | 50 | 70 |
| RF power (W) | 100 | ||
| Ar flow rate (sccm) | 30 | ||
| Parameter (Unit) | Value | ||||||
|---|---|---|---|---|---|---|---|
| Pressure (mTorr) | 100 | 150 | 200 | 250 | 300 | 350 | 400 |
| RF power (W) | 50 | ||||||
| Ar flow rate (sccm) | 30 | ||||||
| Parameter (Unit) | Value | ||||
|---|---|---|---|---|---|
| Radial position (mm) | −60 | −30 | 0 | 30 | 60 |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Han, C.; Koo, Y.; Kim, J.; Choi, K.; Hong, S. Wafer Type Ion Energy Monitoring Sensor for Plasma Diagnosis. Sensors 2023, 23, 2410. https://doi.org/10.3390/s23052410
Han C, Koo Y, Kim J, Choi K, Hong S. Wafer Type Ion Energy Monitoring Sensor for Plasma Diagnosis. Sensors. 2023; 23(5):2410. https://doi.org/10.3390/s23052410
Chicago/Turabian StyleHan, Chansu, Yoonsung Koo, Jaehwan Kim, Kwangwook Choi, and Sangjeen Hong. 2023. "Wafer Type Ion Energy Monitoring Sensor for Plasma Diagnosis" Sensors 23, no. 5: 2410. https://doi.org/10.3390/s23052410
APA StyleHan, C., Koo, Y., Kim, J., Choi, K., & Hong, S. (2023). Wafer Type Ion Energy Monitoring Sensor for Plasma Diagnosis. Sensors, 23(5), 2410. https://doi.org/10.3390/s23052410








