Toward Precise n-Type Doping Control in MOVPE-Grown β-Ga2O3 Thin Films by Deep-Learning Approach
Abstract
:1. Introduction
2. Materials and Methods
2.1. Experimental
2.2. Machine-Learning Methodology
3. Results and Discussion
4. Conclusions
Supplementary Materials
Author Contributions
Funding
Institutional Review Board Statement
Informed Consent Statement
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Mccluskey, M.D. Point defects in Ga2O3. J. Appl. Phys. 2020, 127, 101101. [Google Scholar] [CrossRef] [Green Version]
- Galazka, Z.; Uecker, R.; Klimm, D.; Irmscher, K.; Naumann, M.; Pietsch, M.; Kwasniewski, A.; Bertram, R.; Ganschow, S.; Bickermann, M. Scaling-Up of Bulk β-Ga2O3 Single Crystals by the Czochralski Method. ECS J. Solid State Sci. Technol. 2017, 6, Q3007–Q3011. [Google Scholar] [CrossRef]
- Galazka, Z.; Ganschow, S.; Irmscher, K.; Klimm, D.; Albrecht, M.; Schewski, R.; Pietsch, M.; Schulz, T.; Dittmar, A.; Kwasniewski, A.; et al. Bulk single crystals of β-Ga2O3 and Ga-based spinels as ultra-wide bandgap transparent semiconducting oxides. Prog. Cryst. Growth Charact. Mater. 2021, 67, 100511. [Google Scholar] [CrossRef]
- Suzuki, N.; Ohira, S.; Tanaka, M.; Sugawara, T.; Nakajima, K.; Shishido, T. Fabrication and characterization of transparent conductive Sn-doped β-Ga2O3 single crystal. Phys. Status Solidi C 2007, 4, 2310–2313. [Google Scholar] [CrossRef]
- Villora, E.G.; Shimamura, K.; Yoshikawa, Y.; Aoki, K.; Ichinose, N. Large-size β-Ga2O3 single crystals and wafers. J. Cryst. Growth 2004, 270, 420–426. [Google Scholar] [CrossRef]
- Kuramata, A.; Koshi, K.; Watanabe, S.; Yamaoka, Y.; Masui, T.; Yamakoshi, S. High-quality β-Ga2O3 single crystals grown by edge-defined film-fed growth. Jpn. J. Appl. Phys. 2016, 55, 1202A2. [Google Scholar] [CrossRef]
- Hoshikawa, K.; Ohba, E.; Kobayashi, T.; Yanagisawa, J.; Miyagawa, C.; Nakamura, Y. Growth of β-Ga2O3 single crystals using vertical Bridgman method in ambient air. J. Cryst. Growth 2016, 447, 36–41. [Google Scholar] [CrossRef]
- Higashiwaki, M.; Sasaki, K.; Kuramata, A.; Masui, T.; Yamakoshi, S. Gallium oxide (Ga2O3) metal-semiconductor field-effect transistors. Appl. Phys. Lett. 2012, 100, 013504. [Google Scholar] [CrossRef]
- Ahmadi, E.; Koksaldi, O.S.; Kaun, S.W.; Oshima, Y.; Short, D.B.; Mishra, U.K.; Speck, J.S. Ge doping of β-Ga2O3 films grown by plasma-assisted molecular beam epitaxy. Appl. Phys. Express 2017, 10, 041102. [Google Scholar] [CrossRef]
- Alema, F.; Seryogin, G.; Osinsky, A.; Osinsky, A. Ge doping of β-Ga2O3 by MOCVD. APL Mater. 2021, 9, 091102. [Google Scholar] [CrossRef]
- Lim, K.; Schelhas, L.T.; Siah, S.C.; Brandt, R.E.; Zakutayev, A.; Lany, S.; Gorman, B.; Sun, C.J.; Ginley, D.; Buonassisi, T.; et al. The effect of sub-oxide phases on the transparency of tin-doped gallium oxide. Appl. Phys. Lett. 2016, 109, 141909. [Google Scholar] [CrossRef] [Green Version]
- Baldini, M.; Albrecht, M.; Fiedler, A.; Irmscher, K.; Schewski, R.; Wagner, G. Si- and Sn-doped homoepitaxial β-Ga2O3 layers grown by MOVPE on (010)-oriented substrates. ECS J. Solid State Sci. Technol. 2017, 6, Q3040–Q3044. [Google Scholar] [CrossRef]
- Bin Anooz, S.; Grüneberg, R.; Chou, T.S.; Fiedler, A.; Irmscher, K.; Wouters, C.; Schewski, R.; Albrecht, M.; Galazka, Z.; Miller, W.; et al. Impact of chamber pressure and Si-doping on the surface morphology and electrical properties of homoepitaxial (100) β-Ga2O3 thin films grown by MOVPE. J. Phys. D Appl. Phys. 2021, 54, 034003. [Google Scholar] [CrossRef]
- Feng, Z.; Anhar Uddin Bhuiyan, A.F.M.; Karim, M.R.; Zhao, H. MOCVD homoepitaxy of Si-doped (010) β-Ga2O3 thin films with superior transport properties. Appl. Phys. Lett. 2019, 114, 250601. [Google Scholar] [CrossRef]
- Bhattacharyya, A.; Ranga, P.; Roy, S.; Ogle, J.; Whittaker-Brooks, L.; Krishnamoorthy, S. Low temperature homoepitaxy of (010) β-Ga2O3 by metalorganic vapor phase epitaxy: Expanding the growth window. Appl. Phys. Lett. 2020, 117, 142102. [Google Scholar] [CrossRef]
- Rojas, R. Neural Networks: A Systematic Introduction; Springer: Berlin/Heidelberg, Germany, 1996. [Google Scholar]
- Dropka, N.; Holena, M. Optimization of magnetically driven directional solidification of silicon using artificial neural networks and Gaussian process models. J. Cryst. Growth 2017, 471, 53–61. [Google Scholar] [CrossRef]
- Dropka, N.; Holena, M.; Ecklebe, S.; Frank-Rotsch, C.; Winkler, J. Fast forecasting of VGF crystal growth process by dynamic neural networks. J. Cryst. Growth 2019, 521, 9–14. [Google Scholar] [CrossRef]
- Kutsukake, K.; Nagai, Y.; Horikawa, T.; Banba, H. Real-time prediction of interstitial oxygen concentration in Czochralski silicon using machine learning. Appl. Phys. Express 2020, 13, 125502. [Google Scholar] [CrossRef]
- Tsunooka, Y.; Kokubo, N.; Hatasa, G.; Harada, S.; Tagawa, M.; Ujihara, T. High-speed prediction of computational fluid dynamics simulation in crystal growth. CrystEngComm 2018, 20, 6546–6550. [Google Scholar] [CrossRef] [Green Version]
- Lee, M. Robust random forest based non-fullerene organic solar cells efficiency prediction. Org. Electron. 2020, 76, 105465. [Google Scholar] [CrossRef]
- Wei, L.; Xu, X.; Bullock, J.; Ager, J.W. Machine Learning Optimization of p-Type Transparent Conducting Films. Chem. Mater. 2019, 31, 7340–7350. [Google Scholar] [CrossRef] [Green Version]
- Wakabayashi, Y.K.; Otsuka, T.; Krockenberger, Y.; Sawada, H.; Taniyasu, Y.; Yamamoto, H. Machine-learning-assisted thin-film growth: Bayesian optimization in molecular beam epitaxy of SrRuO3 thin films. APL Mater. 2019, 7, 101114. [Google Scholar] [CrossRef] [Green Version]
- Hansen, K.; Montavon, G.; Biegler, F.; Fazli, S.; Rupp, M.; Scheffler, M.; Von Lilienfeld, O.A.; Tkatchenko, A.; Müller, K.R. Assessment and validation of machine learning methods for predicting molecular atomization energies. J. Chem. Theory Comput. 2013, 9, 3404–3419. [Google Scholar] [CrossRef] [PubMed]
- Von Lilienfeld, O.A. Quantum Machine Learning in Chemical Compound Space. Angew. Chem. Int. Ed. 2018, 57, 4164–4169. [Google Scholar] [CrossRef] [PubMed]
- Schmidt, J.; Marques, M.R.G.; Botti, S.; Marques, M.A.L. Recent advances and applications of machine learning in solid-state materials science. npj Comput. Mater. 2019, 5, 83. [Google Scholar] [CrossRef]
- Stocker, S.; Csányi, G.; Reuter, K.; Margraf, J.T. Machine learning in chemical reaction space. Nat. Commun. 2020, 11, 5505. [Google Scholar] [CrossRef]
- Zhang, M.; Zhang, D.; Wells, M.T. Variable selection for large p small n regression models with incomplete data: Mapping QTL with epistases. BMC Bioinform. 2008, 9, 251. [Google Scholar] [CrossRef] [Green Version]
- Kong, Y.; Yu, T. A Deep Neural Network Model using Random Forest to Extract Feature Representation for Gene Expression Data Classification. Sci. Rep. 2018, 8, 16477. [Google Scholar] [CrossRef] [Green Version]
- Schewski, R.; Lion, K.; Fiedler, A.; Wouters, C.; Popp, A.; Levchenko, S.V.; Schulz, T.; Schmidbauer, M.; Bin Anooz, S.; Grüneberg, R.; et al. Step-flow growth in homoepitaxy of β-Ga2O3 (100)—The influence of the miscut direction and faceting. APL Mater. 2019, 7, 022515. [Google Scholar] [CrossRef] [Green Version]
- Bin Anooz, S.; Grüneberg, R.; Wouters, C.; Schewski, R.; Albrecht, M.; Fiedler, A.; Irmscher, K.; Galazka, Z.; Miller, W.; Wagner, G.; et al. Step Flow Growth of β-Ga2O3 Thin Films on Vicinal (100) β-Ga2O3 Substrates Grown by MOVPE. Appl. Phys. Lett. 2020, 116, 182106. [Google Scholar] [CrossRef]
- Breiman, L. Random Forests. Mach. Learn. 2001, 45, 5–32. [Google Scholar] [CrossRef] [Green Version]
- Fiedler, A.; Schewski, R.; Baldini, M.; Galazka, Z.; Wagner, G.; Albrecht, M.; Irmscher, K. Influence of incoherent twin boundaries on the electrical properties of β-Ga2O3 layers homoepitaxially grown by metal-organic vapor phase epitaxy. J. Appl. Phys. 2017, 122, 165701. [Google Scholar] [CrossRef]
- Korhonen, E.; Tuomisto, F.; Gogova, D.; Wagner, G.; Baldini, M.; Galazka, Z.; Schewski, R.; Albrecht, M. Electrical compensation by Ga vacancies in Ga2O3 thin films. Appl. Phys. Lett. 2015, 106, 242103. [Google Scholar] [CrossRef] [Green Version]
- Peelaers, H.; Lyons, J.L.; Varley, J.B.; Van De Walle, C.G. Deep acceptors and their diffusion in Ga2O3. APL Mater. 2019, 7, 022519. [Google Scholar] [CrossRef] [Green Version]
- Tadjer, M.J.; Freitas, J.A.; Culbertson, J.C.; Weber, M.H.; Glaser, E.R.; Mock, A.L.; Mahadik, N.A.; Schmieder, K.; Jackson, E.; Gallagher, J.C.; et al. Structural and electronic properties of Si- And Sn-doped (−201) β-Ga2O3 annealed in nitrogen and oxygen atmospheres. J. Phys. D Appl. Phys. 2020, 53, 504002. [Google Scholar] [CrossRef]
- Mazzolini, P.; Falkenstein, A.; Galazka, Z.; Martin, M.; Bierwagen, O. Offcut-related step-flow and growth rate enhancement during (100) β-Ga2O3 homoepitaxy by metal-exchange catalyzed molecular beam epitaxy (MEXCAT-MBE). Appl. Phys. Lett. 2020, 117, 222105. [Google Scholar] [CrossRef]
- Wang, Z.; Chen, X.; Ren, F.F.; Gu, S.; Ye, J. Deep-level defects in gallium oxide. J. Phys. D Appl. Phys. 2021, 54, 043002. [Google Scholar] [CrossRef]
- Varley, J.B.; Peelaers, H.; Janotti, A.; Van De Walle, C.G. Hydrogenated cation vacancies in semiconducting oxides. J. Phys. Condens. Matter 2011, 23, 334212. [Google Scholar] [CrossRef]
- Makkonen, I.; Karjalainen, A.; Prozheeva, V.; Wagner, G.; Baldini, M.; Tuomisto, F. Ga vacancies and electrical compensation in β-Ga2O3 thin films studied with positron annihilation spectroscopy. In Proceedings of the Oxide-Based Materials and Devices X, San Francisco, CA, USA, 3–7 February 2019; Volume 10919, p. 4. [Google Scholar] [CrossRef] [Green Version]
- Oshiro, T.M.; Perez, P.S.; Baranauskas, J.A. How Many Trees in a Random Forest? In Proceedings of the Machine Learning and Data Mining in Pattern Recognition; Perner, P., Ed.; Springer: Berlin/Heidelberg, Germany, 2012; pp. 154–168. [Google Scholar]
- Kingma, D.P.; Ba, J.L. Adam: A method for stochastic optimization. In Proceedings of the 3rd International Conference for Learning Representations, San Diego, CA, USA, 7–9 May 2015; pp. 1–15. [Google Scholar]
- Olden, J.D.; Jackson, D.A. Illuminating the “black box”: A randomization approach for understanding variable contributions in artificial neural networks. Ecol. Modell. 2002, 154, 135–150. [Google Scholar] [CrossRef]
- Strobl, C.; Boulesteix, A.L.; Kneib, T.; Augustin, T.; Zeileis, A. Conditional variable importance for random forests. BMC Bioinform. 2008, 9, 307. [Google Scholar] [CrossRef] [Green Version]
- Toloşi, L.; Lengauer, T. Classification with correlated features: Unreliability of feature ranking and solutions. Bioinformatics 2011, 27, 1986–1994. [Google Scholar] [CrossRef] [PubMed]
- Alema, F.; Hertog, B.; Osinsky, A.; Mukhopadhyay, P.; Toporkov, M.; Schoenfeld, W.V. Fast growth rate of epitaxial β-Ga2O3 by close coupled showerhead MOCVD. J. Cryst. Growth 2017, 475, 77–82. [Google Scholar] [CrossRef]
- Kaspari, C.; Pristovsek, M.; Richter, W. Homoepitaxial growth rate measurement using in situ reflectance anisotropy spectroscopy. J. Cryst. Growth 2007, 298, 46–49. [Google Scholar] [CrossRef]
- Fu, K.; Fu, H.; Deng, X.; Su, P.-Y.Y.; Liu, H.; Hatch, K.; Cheng, C.-Y.Y.; Messina, D.; Meidanshahi, R.V.; Peri, P.; et al. The impact of interfacial Si contamination on GaN-on-GaN regrowth for high power vertical devices. Appl. Phys. Lett. 2021, 118, 222104. [Google Scholar] [CrossRef]
- Feng, Z.; Bhuiyan, A.F.M.A.U.; Xia, Z.; Moore, W.; Chen, Z.; McGlone, J.F.; Daughton, D.R.; Arehart, A.R.; Ringel, S.A.; Rajan, S.; et al. Probing Charge Transport and Background Doping in Metal-Organic Chemical Vapor Deposition-Grown (010) β-Ga2O3. Phys. Status Solidi RRL 2020, 14, 2000145. [Google Scholar] [CrossRef]
- Neal, A.T.; Mou, S.; Lopez, R.; Li, J.V.; Thomson, D.B.; Chabak, K.D.; Jessen, G.H. Incomplete Ionization of a 110 meV Unintentional Donor in β-Ga2O3 and its Effect on Power Devices. Sci. Rep. 2017, 7, 13218. [Google Scholar] [CrossRef] [PubMed] [Green Version]
- Alema, F.; Zhang, Y.; Osinsky, A.; Valente, N.; Mauze, A.; Itoh, T.; Speck, J.S. Low temperature electron mobility exceeding 104 cm2/V s in MOCVD grown β-Ga2O3. APL Mater. 2019, 7, 121110. [Google Scholar] [CrossRef] [Green Version]
- Tadjer, M.J.; Lyons, J.L.; Nepal, N.; Freitas, J.A.; Koehler, A.D.; Foster, G.M. Review—theory and characterization of doping and defects in β-Ga2O3. ECS J. Solid State Sci. Technol. 2019, 8, Q3187–Q3194. [Google Scholar] [CrossRef]
- Varley, J.B.; Weber, J.R.; Janotti, A.; Van De Walle, C.G. Oxygen vacancies and donor impurities in β-Ga2O3. Appl. Phys. Lett. 2010, 97, 142106. [Google Scholar] [CrossRef]
- Weiser, P.; Stavola, M.; Fowler, W.B.; Qin, Y.; Pearton, S. Structure and vibrational properties of the dominant O-H center in β-Ga2O3. Appl. Phys. Lett. 2018, 112, 232104. [Google Scholar] [CrossRef]




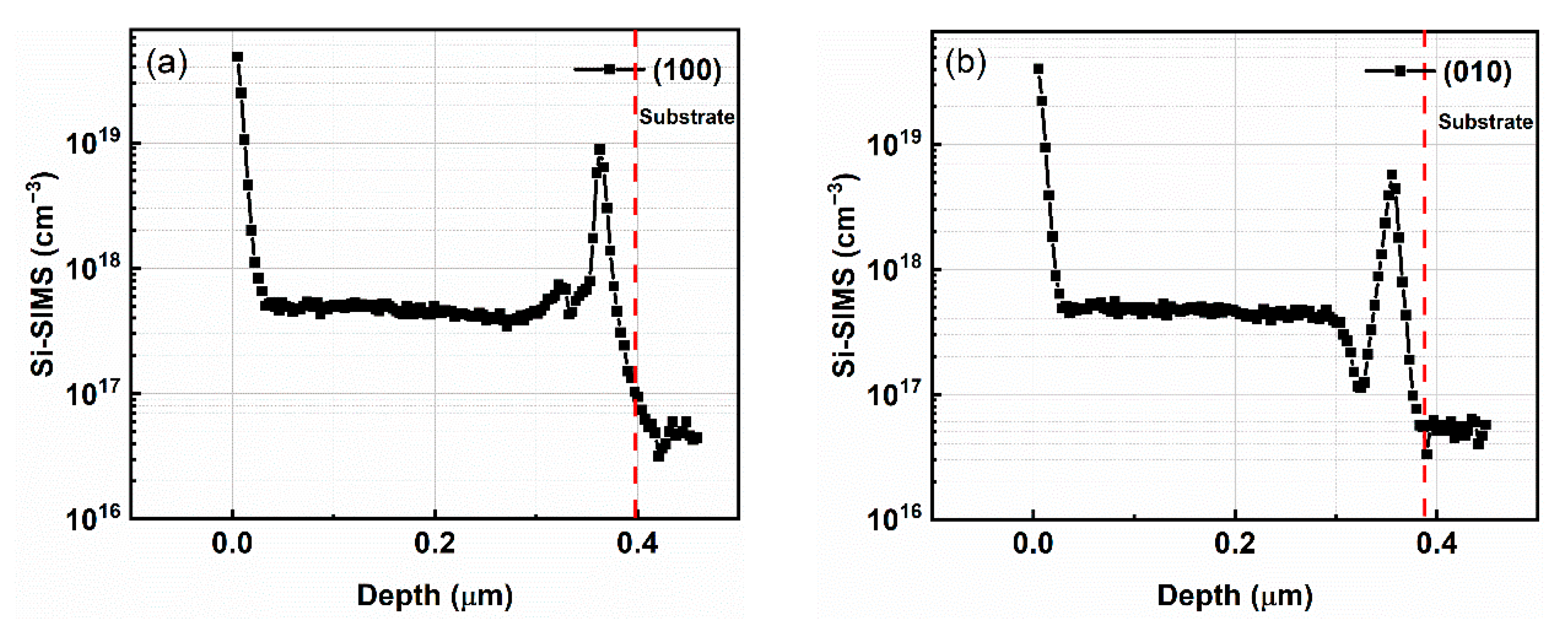

| Parameter | Range |
|---|---|
| Growth temperature | 700–825 °C |
| Chamber pressure | 5–70 mbar |
| TEGa molar flow | 3 × 10−6–3 × 10−5 mol/min |
| TEOS molar flow | 1 × 10−11–3 × 10−8 mol/min |
| Oxygen molar flow | 3 × 10−5–5 × 10−2 mol/min |
| Push gas | 1800–4000 sccm |
| No. Test | Growth Temperature (°C) | TEGa Molar Flow (mol/min) | Chamber Pressure (mbar) | TEOS Molar Flow (mol/min) | Growth Rate (nm/min) |
|---|---|---|---|---|---|
| 1 | 800 | 1.5 × 10−5 | 20 | 9.8 × 10−10 | 5.1 |
| 2 | 800 | 1.5 × 10−5 | 20 | 9.8 × 10−11 | 4.8 |
| 3 | 800 | 1.5 × 10−5 | 20 | 3.9 × 10−10 | 4.8 |
| 4 | 800 | 1.5 × 10−5 | 20 | 1.2 × 10−9 | 4.6 |
| 5 | 800 | 1.5 × 10−5 | 20 | 1.6 × 10−9 | 4.6 |
| 6 | 850 | 6.1 × 10−6 | 5 | 1.5 × 10−10 | 1.2 |
| 7 | 850 | 9.2 × 10−6 | 5 | 1.3 × 10−10 | 1.7 |
| 8 | 850 | 9.2 × 10−6 | 5 | 5.3 × 10−10 | 1.4 |
| 9 | 825 | 9.2 × 10−6 | 5 | 7.6 × 10−10 | 1.8 |
| 10 | 825 | 9.2 × 10−6 | 5 | 1.9 × 10−9 | 2.0 |
Publisher’s Note: MDPI stays neutral with regard to jurisdictional claims in published maps and institutional affiliations. |
© 2021 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
Chou, T.-S.; Bin Anooz, S.; Grüneberg, R.; Irmscher, K.; Dropka, N.; Rehm, J.; Tran, T.T.V.; Miller, W.; Seyidov, P.; Albrecht, M.; et al. Toward Precise n-Type Doping Control in MOVPE-Grown β-Ga2O3 Thin Films by Deep-Learning Approach. Crystals 2022, 12, 8. https://doi.org/10.3390/cryst12010008
Chou T-S, Bin Anooz S, Grüneberg R, Irmscher K, Dropka N, Rehm J, Tran TTV, Miller W, Seyidov P, Albrecht M, et al. Toward Precise n-Type Doping Control in MOVPE-Grown β-Ga2O3 Thin Films by Deep-Learning Approach. Crystals. 2022; 12(1):8. https://doi.org/10.3390/cryst12010008
Chicago/Turabian StyleChou, Ta-Shun, Saud Bin Anooz, Raimund Grüneberg, Klaus Irmscher, Natasha Dropka, Jana Rehm, Thi Thuy Vi Tran, Wolfram Miller, Palvan Seyidov, Martin Albrecht, and et al. 2022. "Toward Precise n-Type Doping Control in MOVPE-Grown β-Ga2O3 Thin Films by Deep-Learning Approach" Crystals 12, no. 1: 8. https://doi.org/10.3390/cryst12010008
APA StyleChou, T.-S., Bin Anooz, S., Grüneberg, R., Irmscher, K., Dropka, N., Rehm, J., Tran, T. T. V., Miller, W., Seyidov, P., Albrecht, M., & Popp, A. (2022). Toward Precise n-Type Doping Control in MOVPE-Grown β-Ga2O3 Thin Films by Deep-Learning Approach. Crystals, 12(1), 8. https://doi.org/10.3390/cryst12010008








