A Critical Review of Techniques for the Experimental Extraction of the Thermal Resistance of Bipolar Transistors from DC Measurements—Part I: Thermometer-Based Approaches
Abstract
:1. Introduction
- Techniques using a thermometer, i.e., the relation between a temperature-sensitive electrical parameter (TSEP) and the temperature in a relevant device region [18,23,24,25,26,27,28,29,30,31]. The TSEP typically adopted in a bipolar transistor is the base-emitter voltage VBE, as it varies with temperature more linearly than the common-emitter forward current gain βF [24].
- A technique relying on analytical assumptions that allows the full evaluation of nonlinear thermal effects [40].
2. Theoretical Background
2.1. Temperature Dependence of the Collector Current
- VAF [V] is the forward Early voltage;
- BHI (≥1) is an IC-dependent dimensionless term included to empirically describe the attenuation dictated by high-injection (high-current) effects leading to the gain roll-off;
- q [C] is the absolute value of the electron charge (or elementary charge);
- AE [cm2 or µm2] is the emitter area;
- Tj [K] is the average temperature over the base-emitter junction (also simply referred to as junction temperature), as mentioned in Section 1;
- DnB [cm2/s] is the average electron diffusivity in the quasi-neutral base region;
- niB [cm−3] is the intrinsic carrier concentration in the base;
- WB [cm or µm] is the quasi-neutral base width;
- NB [cm−3] is the average base doping;
- VBEj [V] is the “internal” (junction) base-emitter voltage, that is, VBEj = VBE − RB·IB − RE·IE, where VBE [V] is the externally-accessible base-emitter voltage, IB and IE [A] are the base and emitter current, respectively, and RB and RE [Ω] are the parasitic base and emitter resistances, respectively;
- η is the dimensionless ideality coefficient;
- VT = kTj/q [V] is the thermal voltage at Tj, k = 8.617 × 10−5 eV/K being the Boltzmann constant.
- by increasing the backside (or baseplate, or ambient) temperature TB through a thermochuck at given values of IE and VCB, the junction temperature Tj increases, and VBEj decreases almost linearly with Tj;
- by increasing VCB at TB = T0 and at an assigned IE, the dissipated power PD [W] increases, the junction temperature Tj increases, and VBEj decreases almost linearly with Tj.
2.2. Thermal Resistance
3. Simulation Approach
3.1. Devices under Test
3.2. Transistor Model
3.3. Circuit-Based Electrothermal Simulation
3.4. Validation Methodology
4. Analysis of Thermometer-Based Experimental RTH Extraction Techniques
4.1. Dawson et al. [24]
4.1.1. Significant Self-Heating in the Thermometer Calibration
4.1.2. Significant Temperature-Induced Variation of the Voltage Drop over the Base Resistance
4.1.3. Significant Early Effect
4.1.4. Significant Nonlinear Thermal Effects
4.2. Bovolon et al. [25]
4.3. Yeats [26]
4.4. Pfost et al. [28]
4.5. Rieh et al. [7,27]
- To eliminate VBE, an interpolation process leading to the same VBE values (i) in the IE- and VCB-constant VBE–TB data and (ii) in the IE-constant VBE–PD data at TB = T0 is needed.
- The presence of the Early and of the nonlinear self-heating effect during the second measurement might lead to an RTH overestimation.
4.6. Vanhoucke et al. [29]
4.7. University of Bordeaux
4.8. d’Alessandro et al. [18,31]
4.9. Summary of the Main Findings
5. Conclusions
Author Contributions
Funding
Data Availability Statement
Acknowledgments
Conflicts of Interest
References
- Nenadović, N.; d’Alessandro, V.; Nanver, L.K.; Tamigi, F.; Rinaldi, N.; Slotboom, J.W. A back-wafer contacted silicon-on-glass integrated bipolar process–Part II: A novel analysis of thermal breakdown. IEEE Trans. Electron Devices 2004, 51, 51–62. [Google Scholar] [CrossRef]
- Rinaldi, N.; d’Alessandro, V. Theory of electrothermal behavior of bipolar transistors: Part I—Single-finger devices. IEEE Trans. Electron Devices 2005, 52, 2009–2021. [Google Scholar] [CrossRef]
- La Spina, L.; d’Alessandro, V.; Russo, S.; Rinaldi, N.; Nanver, L.K. Influence of concurrent electrothermal and avalanche effects on the safe operating area of multifinger bipolar transistors. IEEE Trans. Electron Devices 2009, 56, 483–491. [Google Scholar] [CrossRef]
- Lee, C.-P.; Tao, N.G.M.; Lin, B.J.-F. Studies of safe operating area of InGaP/GaAs heterojunction bipolar transistors. IEEE Trans. Electron Devices 2014, 61, 943–949. [Google Scholar] [CrossRef]
- Rinaldi, N. Small-signal operation of semiconductor devices including self-heating, with application to thermal characterization and instability analysis. IEEE Trans. Electron Devices 2001, 48, 323–331. [Google Scholar] [CrossRef]
- Russo, S.; La Spina, L.; d’Alessandro, V.; Rinaldi, N.; Nanver, L.K. Influence of layout design and on-wafer heatspreaders on the thermal behavior of fully-isolated bipolar transistors: Part II—Dynamic analysis. Solid-State Electron 2010, 54, 754–762. [Google Scholar] [CrossRef]
- Rieh, J.-S.; Greenberg, D.; Liu, Q.; Joseph, A.J.; Freeman, G.; Ahlgren, D.C. Structure optimization of trench-isolated SiGe HBTs for simultaneous improvements in thermal and electrical performances. IEEE Trans. Electron Devices 2005, 52, 2744–2752. [Google Scholar] [CrossRef]
- Seiler, U.; Koenig, E.; Narozny, P.; Dämbkes, H. Thermally triggered collapse of collector current in power heterojunction bipolar transistors. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Minneapolis, MN, USA, 4–5 October 1993; pp. 257–260. [Google Scholar]
- Liu, W.; Nelson, S.; Hill, D.G.; Khatibzadeh, A. Current gain collapse in microwave multifinger heterojunction bipolar transistors operated at very high power densities. IEEE Trans. Electron Devices 1993, 40, 1917–1927. [Google Scholar] [CrossRef]
- Liu, W.; Khatibzadeh, A. The collapse of current gain in multi-finger heterojunction bipolar transistors: Its substrate temperature dependence, instability criteria, and modeling. IEEE Trans. Electron Devices 1994, 41, 1698–1707. [Google Scholar] [CrossRef]
- La Spina, L.; d’Alessandro, V.; Russo, S.; Nanver, L.K. Thermal design of multifinger bipolar transistors. IEEE Trans. Electron Devices 2010, 57, 1789–1800. [Google Scholar] [CrossRef]
- Sevimli, O.; Parker, A.E.; Fattorini, A.P.; Mahon, S.J. Measurement and modeling of thermal behavior in InGaP/GaAs HBTs. IEEE Trans. Electron Devices 2013, 60, 1632–1639. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Catalano, A.P.; Magnani, A.; Codecasa, L.; Rinaldi, N.; Moser, B.; Zampardi, P.J. Simulation comparison of InGaP/GaAs HBT thermal performance in wire-bonding and flip-chip technologies. Microelectron. Reliab. 2017, 78, 233–242. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Catalano, A.P.; Codecasa, L.; Zampardi, P.J.; Moser, B. Accurate and efficient analysis of the upward heat flow in InGaP/GaAs HBTs through an automated FEM-based tool and Design of Experiments. Int. J. Numer. Model. Electron. Netw. Devices Fields 2019, 32, e2530. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Catalano, A.P.; Scognamillo, C.; Codecasa, L.; Zampardi, P.J. Analysis of electrothermal effects in devices and arrays in InGaP/GaAs HBT technology. Electronics 2021, 10, 757. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Marano, I.; Russo, S.; Céli, D.; Chantre, A.; Chevalier, P.; Pourchon, F.; Rinaldi, N. Impact of layout and technology parameters on the thermal resistance of SiGe:C HBTs. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Austin, TX, USA, 4–6 October 2010; pp. 137–140. [Google Scholar]
- Sahoo, A.K.; Frégonèse, S.; Weiß, M.; Malbert, N.; Zimmer, T. A scalable electrothermal model for transient self-heating effects in trench-isolated SiGe HBTs. IEEE Trans. Electron Devices 2012, 59, 2619–2625. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Sasso, G.; Rinaldi, N.; Aufinger, K. Influence of scaling and emitter layout on the thermal behavior of toward-THz SiGe:C HBTs. IEEE Trans. Electron Devices 2014, 61, 3386–3394. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Magnani, A.; Codecasa, L.; Rinaldi, N.; Aufinger, K. Advanced thermal simulation of SiGe:C HBTs including back-end-of-line. Microelectron. Reliab. 2016, 67, 38–45. [Google Scholar] [CrossRef]
- Balanethiram, S.; Berkner, J.; D’Esposito, R.; Frégonèse, S.; Céli, D.; Zimmer, T. Extracting the temperature dependence of thermal resistance from temperature-controlled DC measurements of SiGe HBTs. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Miami, FL, USA, 19–21 October 2017; pp. 94–97. [Google Scholar]
- Balanethiram, S.; D’Esposito, R.; Frégonèse, S.; Chakravorty, A.; Zimmer, T. Validation of thermal resistance extracted from measurements on stripe geometry SiGe HBTs. IEEE Trans. Electron Devices 2019, 66, 4151–4155. [Google Scholar] [CrossRef]
- Huszka, Z.; Nidhin, K.; Céli, D.; Chakravorty, A. Extraction of compact static thermal model parameters for SiGe HBTs. IEEE Trans. Electron Devices 2021, 68, 491–496. [Google Scholar] [CrossRef]
- Waldrop, J.R.; Wang, K.C.; Asbeck, P.M. Determination of junction temperature in AlGaAs/GaAs heterojunction bipolar transistor by electrical measurement. IEEE Trans. Electron Devices 1992, 39, 1248–1250. [Google Scholar] [CrossRef]
- Dawson, D.E.; Gupta, A.K.; Salib, M.L. CW measurements of HBT thermal resistance. IEEE Trans. Electron Devices 1992, 39, 2235–2239. [Google Scholar] [CrossRef]
- Bovolon, N.; Baureis, P.; Müller, J.-E.; Zwicknagl, P.; Schultheis, R.; Zanoni, E. A simple method for the thermal resistance measurement of AlGaAs/GaAs heterojunction bipolar transistors. IEEE Trans. Electron Devices 1998, 45, 1846–1848. [Google Scholar] [CrossRef]
- Yeats, B. Inclusion of topside metal heat spreading in the determination of HBT temperatures by electrical and geometrical methods. In Proceedings of the IEEE Gallium Arsenide Integrated Circuit (GaAs IC) Symposium, Monterey, CA, USA, 17–20 October 1999; pp. 59–62. [Google Scholar]
- Rieh, J.-S.; Greenberg, D.; Jagannathan, B.; Freeman, G.; Subanna, S. Measurement and modeling of thermal resistance of high speed SiGe heterojunction bipolar transistors. In Proceedings of the IEEE Topical Meeting on Silicon Monolithic Integrated Circuits in RF Systems, Ann Arbor, MI, USA, 14 September 2001; pp. 110–113. [Google Scholar]
- Pfost, M.; Kubrak, V.; Brenner, P. A practical method to extract the thermal resistance for heterojunction bipolar transistors. In Proceedings of the IEEE conference on European Solid-State Device Research (ESSDERC), Estoril, Portugal, 16–18 September 2003; pp. 335–338. [Google Scholar]
- Vanhoucke, T.; Boots, H.M.J.; van Noort, W.D. Revised method for extraction of the thermal resistance applied to bulk and SOI SiGe HBTs. IEEE Electron Device Lett. 2004, 25, 150–152. [Google Scholar] [CrossRef]
- Koné, G.A. Caractérisation des Effets Thermiques et des Mécanismes de Défaillance Spécifiques aux Transistors Bipolaires Submicroniques sur Substrat InP Dédiés aux Transmissions. Ph.D. Dissertation, University of Bordeaux 1, Bordeaux, France, 20 December 2011. [Google Scholar]
- d’Alessandro, V. Experimental DC extraction of the thermal resistance of bipolar transistors taking into account the Early effect. Solid-State Electron. 2017, 127, 5–12. [Google Scholar] [CrossRef]
- Liu, W.; Yuksel, A. Measurement of junction temperature of an AlGaAs/GaAs heterojunction bipolar transistor operating at large power densities. IEEE Trans. Electron Devices 1995, 42, 358–360. [Google Scholar] [CrossRef]
- Marsh, S.P. Direct extraction technique to derive the junction temperature of HBT’s under high self-heating bias conditions. IEEE Trans. Electron Devices 2000, 47, 288–291. [Google Scholar] [CrossRef]
- Berkner, J. Extraction of Thermal Resistance and Its Temperature Dependence Using DC Methods. In Proceedings of the HICUM Workshop, Dresden, Germany, 18–19 June 2007; Available online: https://www.iee.et.tu-dresden.de/iee/eb/forsch/Models/workshop0607/contr/Berkner_Infineon_HICUM_WS_2007_Dresden_070621s.pdf (accessed on 1 August 2022).
- Reisch, M. Self-heating in BJT circuit parameter extraction. Solid-State Electron. 1992, 35, 677–679. [Google Scholar] [CrossRef]
- Zweidinger, D.T.; Fox, R.M.; Brodsky, J.S.; Jung, T.; Lee, S.-G. Thermal impedance extraction for bipolar transistors. IEEE Trans. Electron Devices 1996, 43, 342–346. [Google Scholar] [CrossRef]
- Tran, H.; Schröter, M.; Walkey, D.J.; Marchesan, D.; Smy, T.J. Simultaneous extraction of thermal and emitter series resistances in bipolar transistors. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Minneapolis, MN, USA, 28–30 September 1997; pp. 170–173. [Google Scholar]
- Williams, D.; Tasker, P. Thermal parameter extraction technique using DC I–V data for HBT transistors. In Proceedings of the IEEE High Frequency Postgraduate Student Colloquium, Dublin, Ireland, 7–8 September 2000; pp. 71–75. [Google Scholar]
- Pawlak, A.; Lehmann, S.; Schröter, M. A simple and accurate method for extracting the emitter and thermal resistance of BJTs and HBTs. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Coronado, CA, USA, 28 September–1 October 2014; pp. 175–178. [Google Scholar]
- Menozzi, R.; Barrett, J.; Ersland, P. A new method to extract HBT thermal resistance and its temperature and power dependence. IEEE Trans. Device Mater. Reliab. 2005, 5, 595–601. [Google Scholar] [CrossRef]
- Müller, M.; d’Alessandro, V.; Falk, S.; Weimer, C.; Jin, X.; Krattenmacher, M.; Kuthe, P.; Claus, M.; Schröter, M. Methods for extracting the temperature- and power-dependent thermal resistance for SiGe and III–V HBTs from DC measurements: A review and comparison across technologies. IEEE Trans. Electron Devices 2022, 69, 4064–4074. [Google Scholar] [CrossRef]
- Rinaldi, N.; d’Alessandro, V. Theory of electrothermal behavior of bipolar transistors: Part III—Impact ionization. IEEE Trans. Electron Devices 2006, 53, 1683–1697. [Google Scholar] [CrossRef]
- MacFarlane, G.G.; McLean, T.P.; Quarrington, J.E.; Roberts, V. Fine structure in the absorption-edge spectrum of Si. Phys. Rev. 1958, 111, 1245–1254. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Sasso, G.; Rinaldi, N.; Aufinger, K. Experimental DC extraction of the base resistance of bipolar transistors: Application to SiGe:C HBTs. IEEE Trans. Electron Devices 2016, 63, 2691–2699. [Google Scholar] [CrossRef]
- d’Alessandro, V.; D’Esposito, R.; Metzger, A.G.; Kwok, K.H.; Aufinger, K.; Zimmer, T.; Rinaldi, N. Analysis of electrothermal and impact-ionization effects in bipolar cascode amplifiers. IEEE Trans. Electron Devices 2018, 65, 431–439. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Catalano, A.P.; Scognamillo, C.; Müller, M.; Schröter, M.; Zampardi, P.J.; Codecasa, L. Experimental determination, modeling, and simulation of nonlinear thermal effects in bipolar transistors under static conditions: A critical review and update. Energies 2022, 15, 5457. [Google Scholar] [CrossRef]
- Walkey, D.J.; Smy, T.J.; Macelwee, T.; Maliepaard, M. Compact representation of temperature and power dependence of thermal resistance in Si, InP and GaAs substrate devices using linear models. Solid-State Electron. 2002, 46, 819–826. [Google Scholar] [CrossRef]
- Zhang, Q.M.; Hu, H.; Sitch, J.; Surridge, R.K.; Xu, J.M. A new large signal HBT model. IEEE Trans. Microw. Theory Technol. 1996, 44, 2001–2009. [Google Scholar] [CrossRef]
- Miller, S.L. Ionization rates for holes and electrons in silicon. Phys. Rev. 1957, 105, 1246–1249. [Google Scholar] [CrossRef]
- Sasso, G.; Costagliola, M.; Rinaldi, N. Avalanche multiplication and pinch-in models for simulating electrical instability effects in SiGe HBTs. Microelectron. Reliab. 2010, 50, 1577–1580. [Google Scholar] [CrossRef]
- d’Alessandro, V.; Schröter, M. On the modeling of the avalanche multiplication coefficient in SiGe HBTs. IEEE Trans. Electron Devices 2019, 66, 2472–2482. [Google Scholar] [CrossRef]
- Nenadović, N.; d’Alessandro, V.; La Spina, L.; Rinaldi, N.; Nanver, L.K. Restabilizing mechanisms after the onset of thermal instability in bipolar transistors. IEEE Trans. Electron Devices 2006, 53, 643–653. [Google Scholar] [CrossRef]
- Paasschens, J.C.J.; Harmsma, S.; van der Toorn, R. Dependence of thermal resistance on ambient and actual temperature. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Montreal, QC, Canada, 12–14 September 2004; pp. 96–99. [Google Scholar]
- COMSOL Multiphysics User’s Guide, Release 5.2A. 2016. Available online: https://www.comsol.it/ (accessed on 1 August 2020).
- PSPICE User’s Manual, Cadence OrCAD 16.5. 2011. Available online: https://www.orcad.com/ (accessed on 1 August 2020).
- Russo, S.; d’Alessandro, V.; La Spina, L.; Rinaldi, N.; Nanver, L.K. Evaluating the self-heating thermal resistance of bipolar transistors by DC measurements: A critical review and update. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Capri, Italy, 12–14 October 2009; pp. 95–98. [Google Scholar]
- Raya, C.; Ardouin, B.; Huszka, Z. Improving parasitic emitter resistance determination methods for advanced SiGe:C HBT transistors. In Proceedings of the IEEE Bipolar/BiCMOS Circuits and Technology Meeting (BCTM), Atlanta, GA, USA, 9–11 October 2011. [Google Scholar]
- Krause, J.; Schröter, M. Methods for determining the emitter resistance in SiGe HBTs: A review and an evaluation across technology generations. IEEE Trans. Electron Devices 2015, 62, 1363–1374. [Google Scholar] [CrossRef]
- PathWave Advanced Design System (ADS). 2022. Available online: https://www.keysight.com/zz/en/lib/resources/software-releases/pathwave-advanced-design-system-ads-2022.html (accessed on 1 August 2022).
- AgilentHBT Model (Agilent Heterojunction Bipolar Transistor Model). Available online: https://edadocs.software.keysight.com/pages/viewpage.action?pageId=6262855 (accessed on 1 August 2022).
- Schröter, M.; Chakravorty, A. Compact Hierarchical Bipolar Transistor Modeling with HICUM; World Scientific Publishing: Singapore, 2010. [Google Scholar]
- Sparkes, J.J. Voltage feedback and thermal resistance in junction transistors. Proc. IRE 1958, 46, 1305–1306. [Google Scholar]

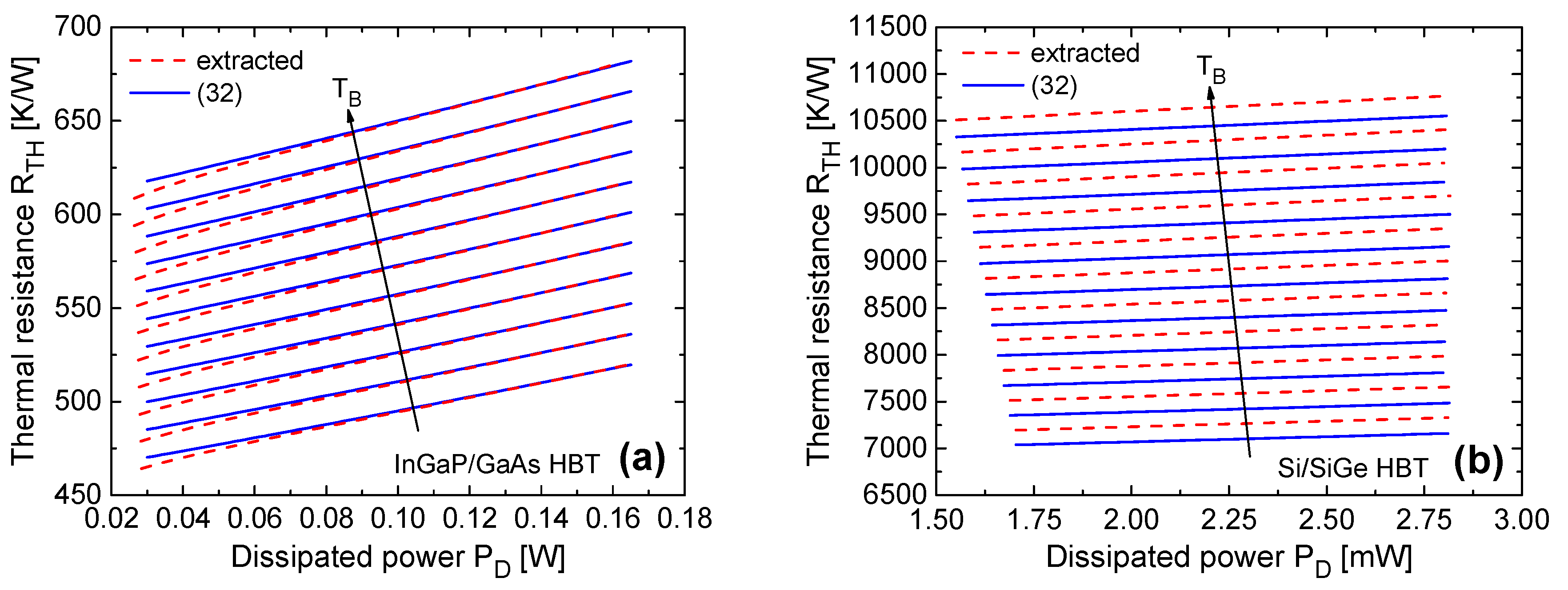



| Parameter | Value |
|---|---|
| Common-emitter current gain βF at 300 K and medium current levels | 150 |
| Open-emitter breakdown voltage BVCBO | 27 V |
| Open-base breakdown voltage BVCEO | 17 V |
| Peak cut-off frequency fT for VCE = 3 V | 40 GHz |
| Collector current density JC at peak fT for VCE = 3 V | 0.2 mA/µm2 |
| Maximum oscillation frequency fmax for VCE = 3 V | 82 GHz |
| Parameter | Value |
|---|---|
| Common-emitter current gain βF at 300 K and medium current levels | 2200 |
| Open-emitter breakdown voltage BVCBO | 5.5 V |
| Open-base breakdown voltage BVCEO | 1.6 V |
| Peak cut-off frequency fT for VCB = 0.5 V | 240 GHz |
| Collector current density JC at peak fT for VCB = 0.5 V | 10 mA/µm2 |
| Maximum oscillation frequency fmax for VCB = 0.5 V | 380 GHz |
| Technique | Advantages, Approximations, and Limitations |
|---|---|
| Dawson et al. [24] and Rieh et al. [7,27] | The technique developed by Rieh et al. can be considered a variant of the classical approach of Dawson et al., the latter being more complex as it is applied to a device with grounded emitter, and the first being simpler as it is applied to a device with accessible emitter, for which it is possible to force an assigned emitter current. In both techniques, coefficient ϕ′ extracted in the first measurement is higher than the desired ϕ due to the nonlinear thermal effect induced by the TB increase on the RTH. Conveniently, the resulting error (which would give rise to an RTH underestimation) is compensated by another error in the second measurement dictated by the Early and nonlinear self-heating effects (such an error tends to overestimate RTH). By keeping IE sufficiently low in both measurements and choosing a limited PD range in the second measurement, these techniques allow extracting RTH00 with a fairly good accuracy for the InGaP/GaAs and Si/SiGe HBT devices under test, which do not exhibit a significant Early effect. However, it must be remarked that this accuracy originates from a compensation of errors; hence, further analyses should be performed to establish if a similar compensation takes place also in other HBT technologies devised for RF applications. |
| Bovolon et al. [25] | This technique can be reviewed as an extension of the differential variant of the approach of Dawson et al. conceived to extract RTH as a function of TB and PD. Unfortunately, due to its differential nature and to the underlying assumptions, this technique suffers from a marked inaccuracy in describing the impact of the nonlinear self-heating effect, regardless of the HBT technology. |
| Yeats [26] | This technique represents an extension of the approaches of Dawson et al. and Rieh et al. aimed to extract RTH vs. TB and PD. The method allows determining accurate results when applied to simulated data (corresponding to ideal noiseless measurements). However, as the approach is based on the direct use of the thermometer to evaluate the junction temperature Tj, noisy VBE data coming from real measurements are expected to jeopardize the extraction accuracy. |
| Pfost et al. [28] | This approach is developed to extract the RTH dependence on PD at TB = T0; differently from other techniques, the method operates on IC–VBE characteristics and is quite critical, as it is based on the detection of points at the same IC on characteristics measured at different VCE values. This detection is indeed possible when IC (VBE) is high, but in severe cases increasing VBE can lead to thermal runaway, and in milder cases the extraction accuracy can be affected by high-injection effects. |
| Vanhoucke et al. [29] | This technique is conceived to improve the approaches of Dawson et al. and Rieh et al. by mitigating the error due to self-heating in the first measurement. However, Vanhoucke et al. improperly assume that only linear self-heating takes place, while the prevailing mechanism is the RTH increase due to the nonlinear thermal effect induced by the TB sweep. Hence, this technique unintentionally exacerbates the error associated to the first measurement, and paradoxically improves the compensation of errors, thus leading to a slightly higher accuracy in the RTH00 extraction. Again, as the accuracy derives from a compensation of errors, it is difficult to predict what might happen by applying this method to other HBT technologies. |
| University of Bordeaux | This technique is based on common-emitter measurements performed at various TB values by sweeping VCE and keeping IB constant. By elaborating the results and selecting a VBE value, the IB- and VBE-constant TB–PD curve is obtained, and the RTH is determined from its slope. Unfortunately, the IB and VBE values are not simple to choose, which makes the method quite difficult to apply. For the HBT technologies under test, the extracted RTH is higher than RTH00 due to an underlying approximation and to the nonlinear self-heating effect. |
| d’Alessandro et al. [18,31] | The technique in [18] aims to improve the accuracy in the extraction of coefficient ϕ with respect to the approaches of Dawson et al. and Rieh et al., the price to pay being an increased elaboration effort. Consequently, in this case the compensation of errors does not take place, and this technique overestimates RTH with respect to RTH00 due to the nonlinear self-heating effect and the Early effect in the second measurement. The inaccuracy dictated by the nonlinear self-heating effect can be alleviated by limiting the PD range in which the RTH extraction is performed. The extended versions in [31] allow purifying the extraction from the Early effect, which is misinterpreted as additional self-heating. As a result, differently from all other techniques, the approaches in [31] can be adopted not only to NPN HBTs, but also to PNP HBTs and Si BJTs, where the Early effect plays a more relevant role. |
Disclaimer/Publisher’s Note: The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of MDPI and/or the editor(s). MDPI and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content. |
© 2023 by the authors. Licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution (CC BY) license (https://creativecommons.org/licenses/by/4.0/).
Share and Cite
d’Alessandro, V.; Catalano, A.P.; Scognamillo, C.; Müller, M.; Schröter, M.; Zampardi, P.J.; Codecasa, L. A Critical Review of Techniques for the Experimental Extraction of the Thermal Resistance of Bipolar Transistors from DC Measurements—Part I: Thermometer-Based Approaches. Electronics 2023, 12, 3471. https://doi.org/10.3390/electronics12163471
d’Alessandro V, Catalano AP, Scognamillo C, Müller M, Schröter M, Zampardi PJ, Codecasa L. A Critical Review of Techniques for the Experimental Extraction of the Thermal Resistance of Bipolar Transistors from DC Measurements—Part I: Thermometer-Based Approaches. Electronics. 2023; 12(16):3471. https://doi.org/10.3390/electronics12163471
Chicago/Turabian Styled’Alessandro, Vincenzo, Antonio Pio Catalano, Ciro Scognamillo, Markus Müller, Michael Schröter, Peter J. Zampardi, and Lorenzo Codecasa. 2023. "A Critical Review of Techniques for the Experimental Extraction of the Thermal Resistance of Bipolar Transistors from DC Measurements—Part I: Thermometer-Based Approaches" Electronics 12, no. 16: 3471. https://doi.org/10.3390/electronics12163471






