Resistive Switching of Plasma–Treated Zinc Oxide Nanowires for Resistive Random Access Memory
Abstract
:1. Introduction
2. Results and Discussion
2.1. Enhanced Homogeneity and Reproducibility
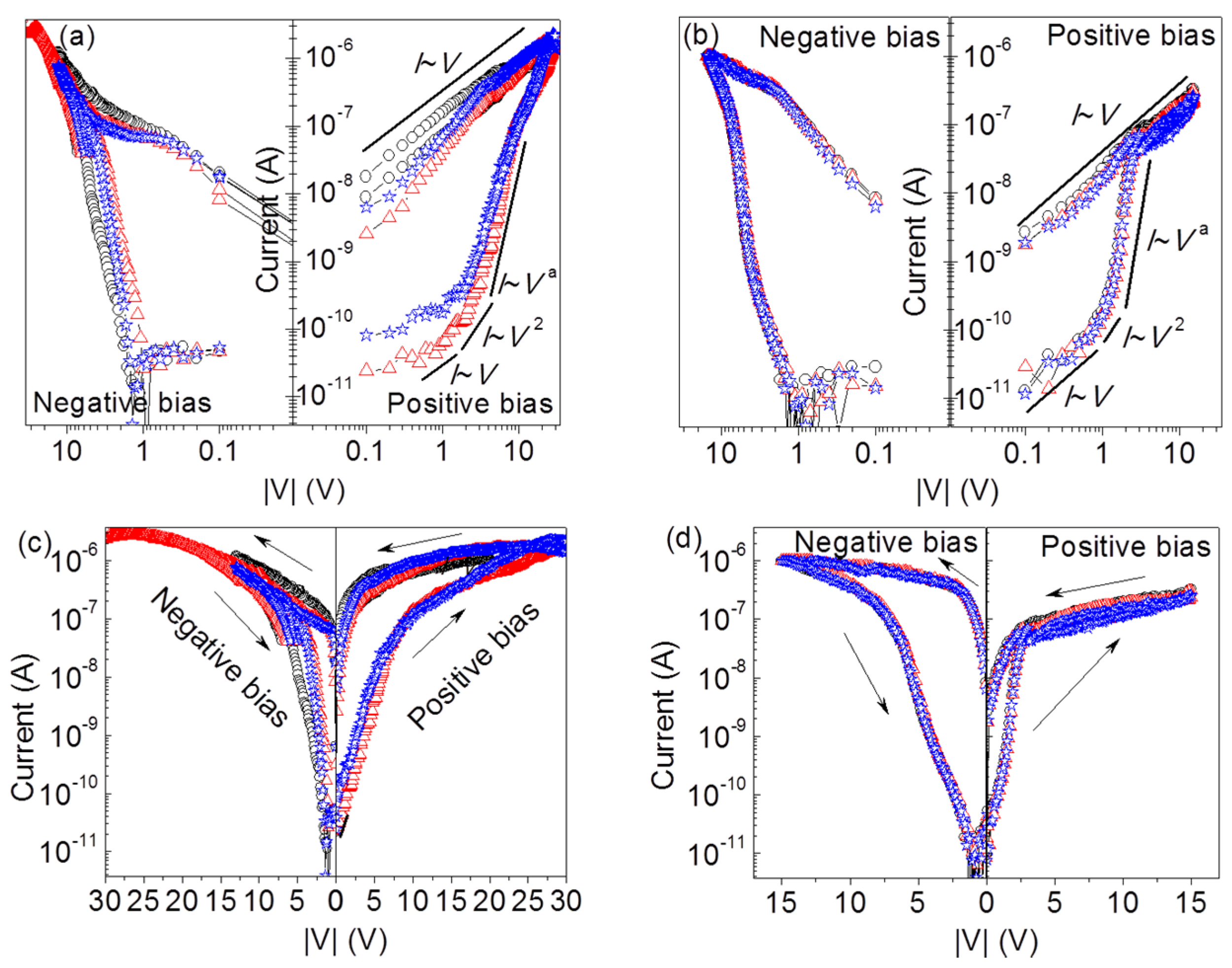

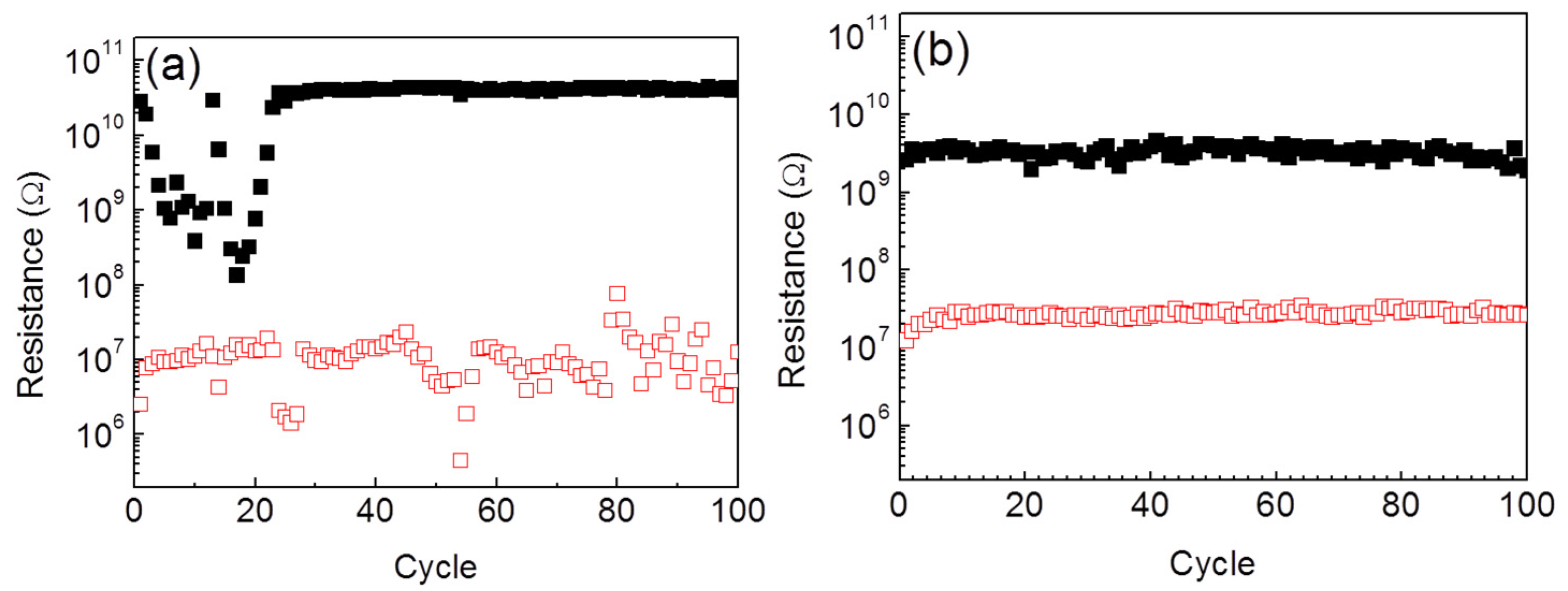
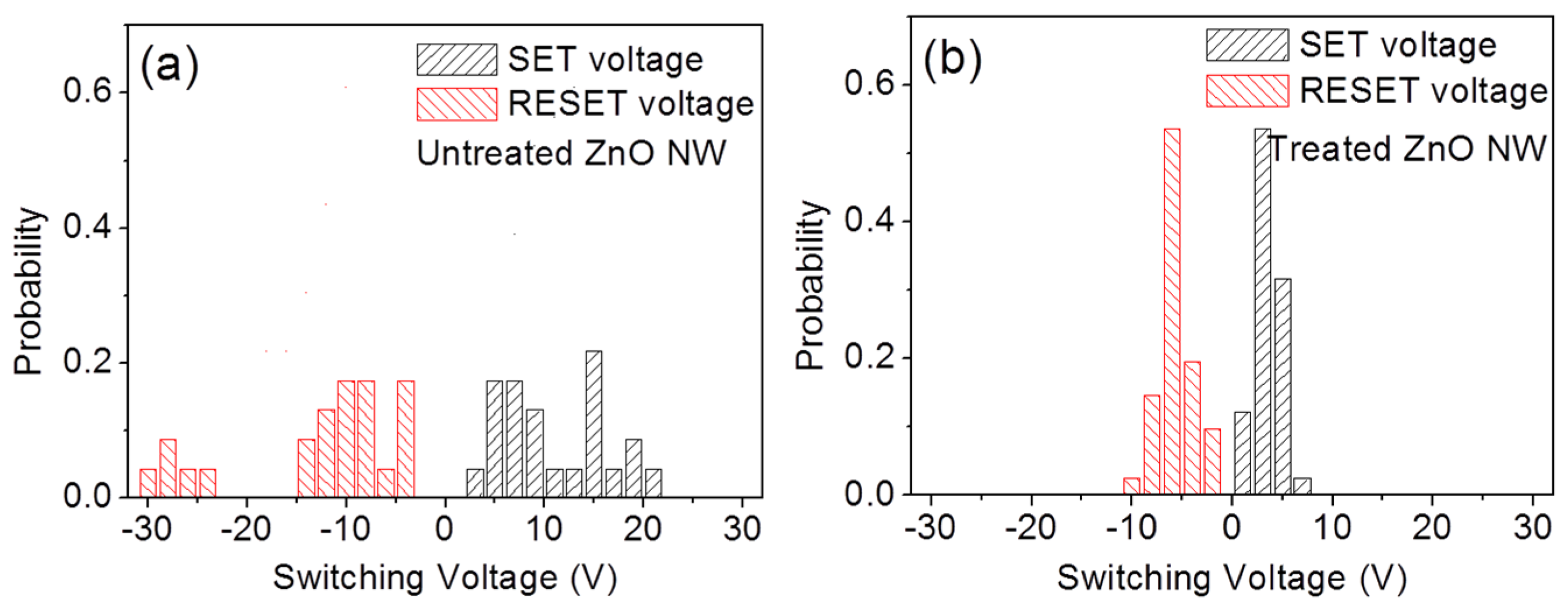
2.2. Improved Data Retention

2.3. Self-Rectification of the RRAM Cells

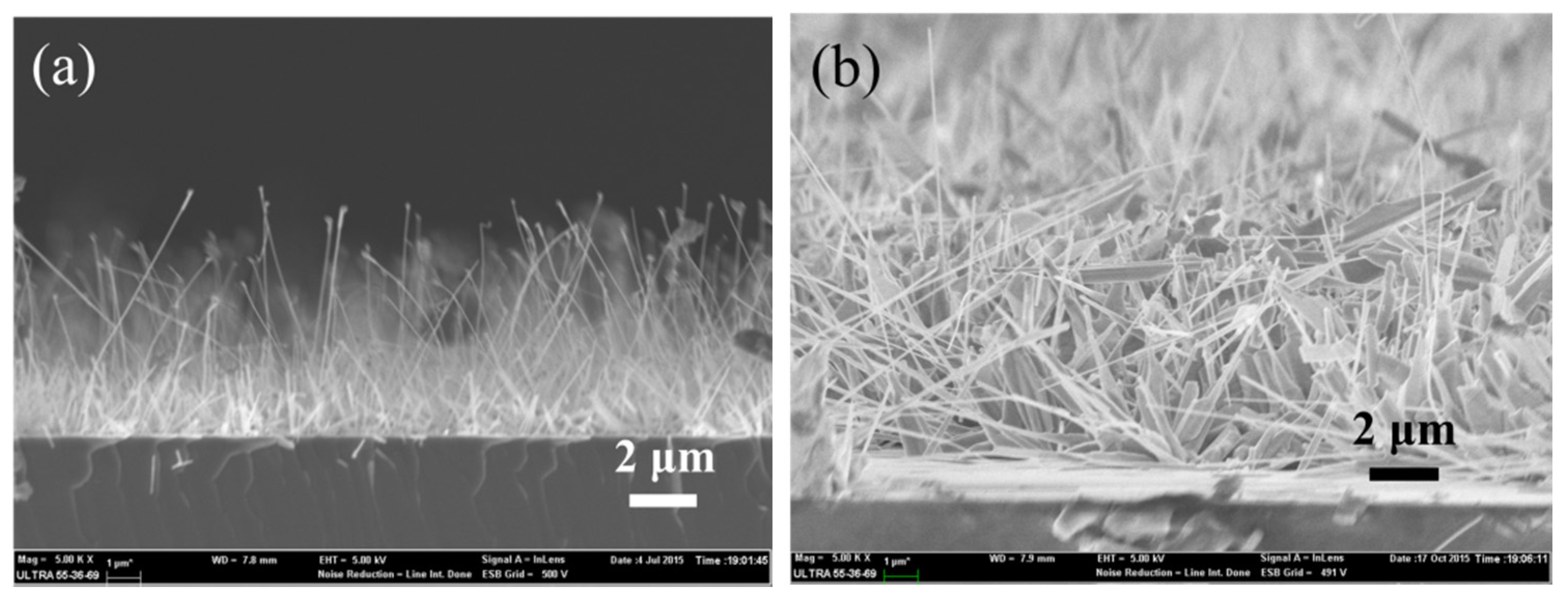
2.4. Defects in the ZnO NWs
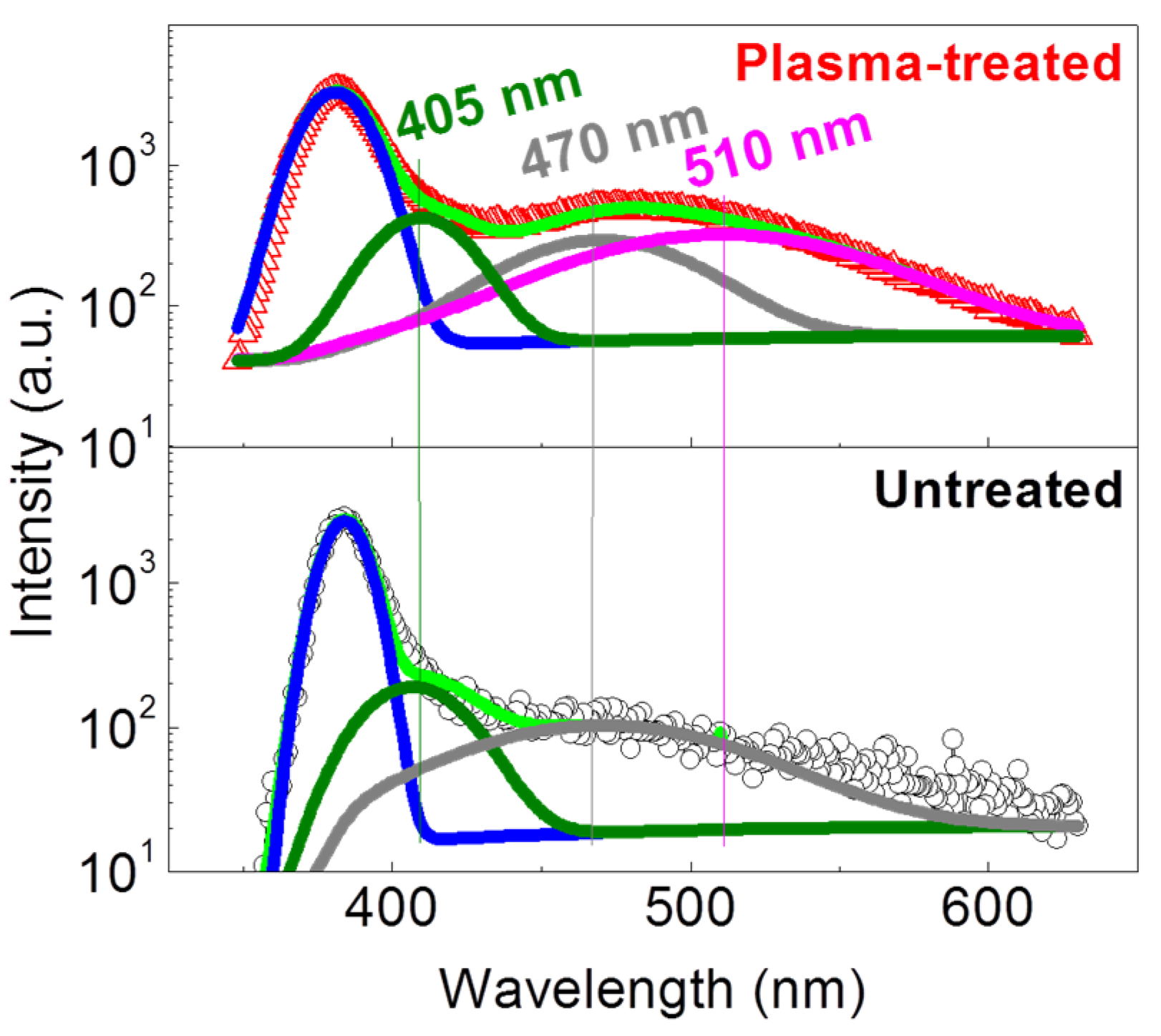
3. Experimental Section
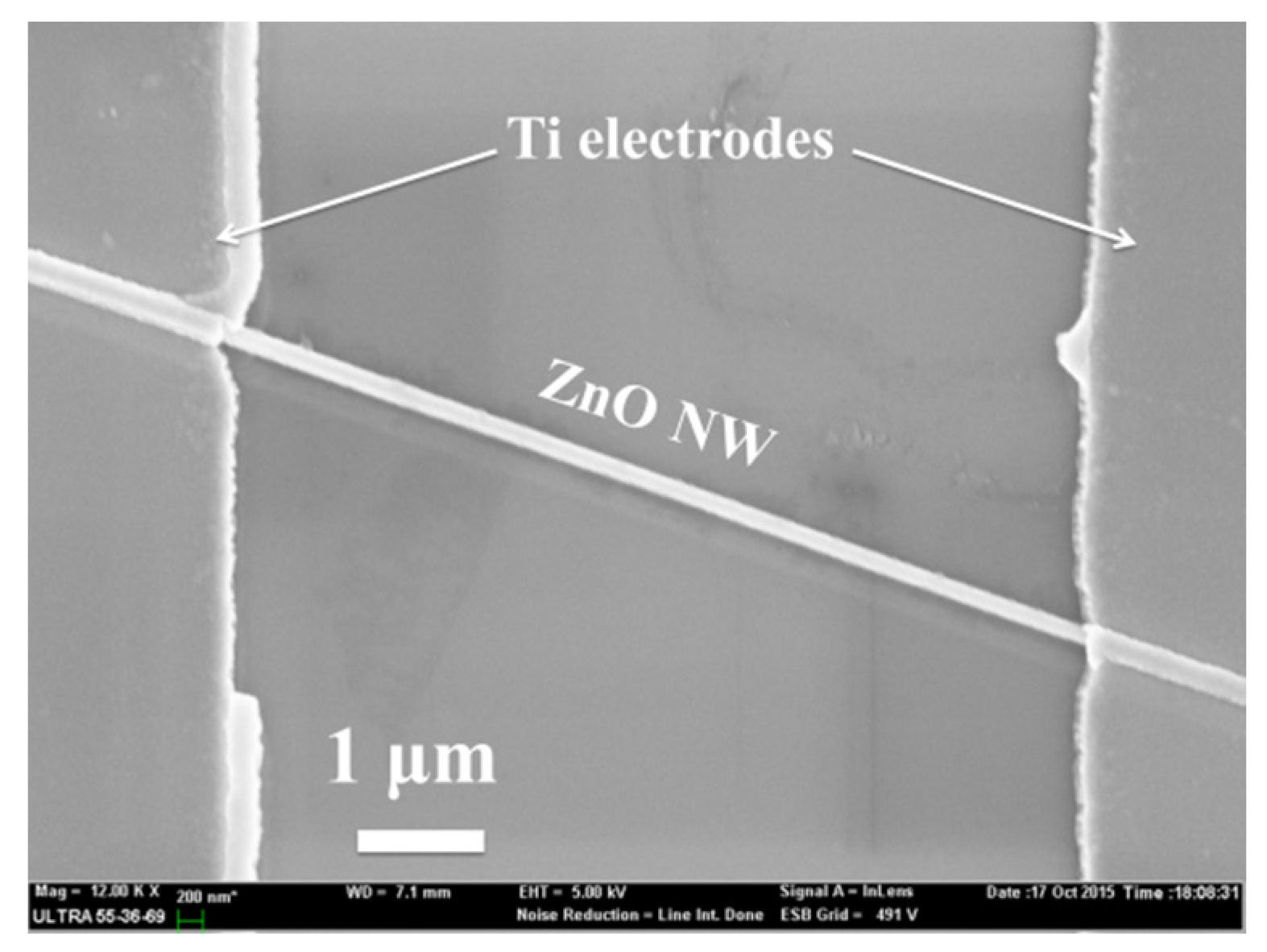
4. Conclusions
Acknowledgments
Author Contributions
Conflicts of Interest
References
- Pan, F.; Gao, S.; Chen, C.; Song, C.; Zeng, F. Recent progress in resistive random access memories: materials, switching mechanisms, and performance. Mater. Sci. Eng. R 2014, 83, 1–59. [Google Scholar] [CrossRef]
- Waser, R.; Dittmann, R.; Staikov, G.; Szot, K. Redox-based resistive switching memories-nanoionic mechanisms, prospects, and challenges. Adv. Mater. 2009, 21, 2632–2663. [Google Scholar] [CrossRef]
- Waser, R.; Aono, M. Nanoionics-based resistive switching memories. Nat. Mater. 2007, 6, 833–840. [Google Scholar] [CrossRef] [PubMed]
- Liang, L.; Li, K.; Xiao, C.; Fan, S.; Liu, J.; Zhang, W.; Xu, W.; Tong, W.; Liao, J.; Zhou, Y.; et al. Vacancy Associates-Rich Ultrathin Nanosheets for High Performance and Flexible Nonvolatile Memory Device. J. Am. Chem. Soc. 2015, 137, 3102–3108. [Google Scholar] [CrossRef] [PubMed]
- Qian, M.; Pan, Y.M.; Liu, F.Y.; Wang, M.; Shen, H.L.; He, D.W.; Wang, B.G.; Shi, Y.; Miao, F.; Wang, X.R. Tunable, ultralow-power switching in memristive devices enabled by a heterogeneous graphene-oxide interface. Adv. Mater. 2014, 26, 3275–3281. [Google Scholar] [PubMed]
- Lai, Y.F.; Xin, P.C.; Cheng, S.Y.; Yu, J.L.; Zheng, Q. Plasma enhanced multistate storage capability of single ZnO nanowire based memory. Appl. Phys. Lett. 2015, 106. [Google Scholar] [CrossRef]
- Yan, X.B.; Hao, H.; Chen, Y.F.; Li, Y.C.; Banerjee, W. Highly transparent bipolar resistive switching memory with In-Ga-Zn-O semiconducting electrode in In-Ga-Zn-O/Ga2O3/In-Ga-Zn-O structure. Appl. Phys. Lett. 2014, 105. [Google Scholar] [CrossRef]
- Kim, A.; Song, K.; Kim, Y.; Moon, J. All solution processed, fully transparent resistive memory devices. ACS Appl. Mater. Interfaces 2011, 3, 4525–4530. [Google Scholar] [CrossRef] [PubMed]
- Cao, X.; Li, X.M.; Gao, X.D.; Liu, X.J.; Yang, C.; Yang, R.; Jin, P. All-ZnO-based transparent resistance random access memory device fully fabricated at room temperature. J. Phys. D 2011, 44. [Google Scholar] [CrossRef]
- Chiang, Y.D.; Chang, W.Y.; Ho, C.Y.; Chen, C.Y.; Ho, C.H.; Lin, S.J.; Wu, T.B.; He, J.H. Single ZnO nanowire memory. IEEE Trans. Electron Devices 2011, 58, 1735–1740. [Google Scholar] [CrossRef]
- Lai, Y.; Wang, Y.; Cheng, S.; Yu, J. Defects and resistive switching of zinc oxide nanorods with copper addition grown by hydrothermal method. J. Electron. Mater. 2014, 43, 2676–2682. [Google Scholar] [CrossRef]
- Qi, J.; Olmedo, M.; Ren, J.J.; Zhan, N.; Zhao, J.Z.; Zheng, J.G.; Liu, J.L. Resistive switching in single epitaxial ZnO nanoislands. ACS Nano 2012, 6, 1051–1058. [Google Scholar] [CrossRef] [PubMed]
- Wang, Y.; Liu, Q.; Lu, H.B.; Long, S.B.; Wang, W.; Li, Y.T.; Zhang, S.; Lian, W.T.; Yang, J.H.; Liu, M. Improving the electrical performance of resistive switching memory using doping technology. Chin. Sci. Bull. 2012, 57, 1235–1240. [Google Scholar] [CrossRef]
- Guan, W.H.; Long, S.B.; Jia, R.; Liu, M. Nonvolatile resistive switching memory utilizing gold nanocrystals embedded in zirconium oxide. Appl. Phys. Lett. 2007, 91. [Google Scholar] [CrossRef]
- Wang, Y.; Liu, Q.; Long, S.; Wang, W.; Wang, Q.; Zhang, M.; Zhang, S.; Li, Y.; Zuo, Q.; Yang, J.; et al. Investigation of resistive switching in Cu-doped HfO2 thin film for multilevel non-volatile memory applications. Nanotechnology 2010, 21. [Google Scholar] [CrossRef]
- Chen, Y.T.; Chang, T.C.; Peng, H.K.; Tseng, H.C.; Huang, J.J.; Yang, J.B.; Chu, A.K.; Young, T.F.; Sze, S.M. Insertion of a Si layer to reduce operation current for resistive random access memory applications. Appl. Phys. Lett. 2013, 102. [Google Scholar] [CrossRef]
- Chen, Y.-S.; Lee, H.-Y.; Chen, P.-S.; Chen, W.-S.; Tsai, K.-H.; Gu, P.-Y.; Wu, T.-Y.; Tsai, C.-H.; Rahaman, S.Z.; Lin, Y.-D.; et al. Novel defects-trapping TaOX/HfOX RRAM with reliable self-compliance, high nonlinearity, and ultra-low current. IEEE Electron Device Lett. 2014, 35, 202–204. [Google Scholar] [CrossRef]
- Kim, S.; Choi, S.; Lu, W. Comprehensive physical model of dynamic resistive switching in an oxide memristor. ACS Nano 2014, 8, 2369–2376. [Google Scholar] [CrossRef] [PubMed]
- Chen, Y.Y.; Goux, L.; Clima, S.; Govoreanu, B.; Degraeve, R.; Kar, G.S.; Fantini, A.; Groeseneken, G.; Wouters, D.J.; Jurczak, M. Endurance/retention trade-off on HfO2/metal cap 1T1R bipolar RRAM. IEEE Trans. Electron Devices 2013, 60, 1114–1121. [Google Scholar] [CrossRef]
- Chen, X.R.; Feng, J.; Bae, D. Drastic reduction of RRAM reset current via plasma oxidization of TaOx film. Appl. Surface Sci. 2015, 324, 275–279. [Google Scholar] [CrossRef]
- Kim, K.M.; Choi, B.J.; Shin, Y.C.; Choi, S.; Hwang, C.S. Anode-interface localized filamentary mechanism in resistive switching of TiO2 thin films. Appl. Phys. Lett. 2007, 91. [Google Scholar] [CrossRef]
- Liu, Q.; Guan, W.H.; Long, S.B.; Jia, R.; Liu, M.; Chen, J.N. Resistive switching memory effect of ZrO2 films with Zr+ implanted. Appl. Phys. Lett. 2008, 92. [Google Scholar] [CrossRef]
- Chen, J.-Y.; Hsin, C.-L.; Huang, C.-W.; Chiu, C.-H.; Huang, Y.-T.; Lin, S.-J.; Wu, W.-W.; Chen, L.-J. Dynamic evolution of conducting nanofilament in resistive switching memories. Nano Lett. 2013, 13, 3671–3677. [Google Scholar] [CrossRef] [PubMed]
- Wedig, A.; Luebben, M.; Cho, D.-Y.; Moors, M.; Skaja, K.; Rana, V.; Hasegawa, T.; Adepalli, K.K.; Yildiz, B.; Waser, R.; et al. Nanoscale cation motion in TaOx, HfOx and TiOx memristive systems. Nat. Nanotechnol. 2016, 11. [Google Scholar] [CrossRef] [PubMed]
- Yu, S.; Chen, H.-Y.; Gao, B.; Kang, J.; Wong, H.S.P. HfOx-based vertical resistive switching random access memory suitable for bit-cost-effective three-dimensional cross-point architecture. ACS Nano 2013, 7, 2320–2325. [Google Scholar] [CrossRef] [PubMed]
- Kim, K.-H.; Gaba, S.; Wheeler, D.; Cruz-Albrecht, J.M.; Hussain, T.; Srinivasa, N.; Lu, W. A functional hybrid memristor crossbar-array/CMOS system for data storage and neuromorphic applications. Nano Lett. 2012, 12, 389–395. [Google Scholar] [CrossRef] [PubMed]
- Chasin, A.; Zhang, L.Q.; Bhoolokam, A.; Nag, M.; Steudel, S.; Govoreanu, B.; Gielen, G.; Heremans, P. High-performance a-IGZO thin film diode as selector for cross-point memory application. IEEE Electron Device Lett. 2014, 35, 642–644. [Google Scholar]
- Li, Y.T.; Lv, H.B.; Liu, Q.; Long, S.B.; Wang, M.; Xie, H.W.; Zhang, K.W.; Huo, Z.L.; Liu, M. Bipolar one diode-one resistor integration for high-density resistive memory applications. Nanoscale 2013, 5, 4785–4789. [Google Scholar] [CrossRef] [PubMed]
- Park, J.B.; Biju, K.P.; Jung, S.; Lee, W.; Lee, J.; Kim, S.; Park, S.; Shin, J.; Hwang, H. Multibit operation of TiOx-based ReRAM by Schottky barrier height engineering. IEEE Electron Device Lett. 2011, 32, 476–478. [Google Scholar] [CrossRef]
- Chu, T.J.; Tsai, T.M.; Chang, T.C.; Chang, K.C.; Pan, C.H.; Chen, K.H.; Chen, J.H.; Chen, H.L.; Huang, H.C.; Shih, C.C.; et al. Ultra-high resistive switching mechanism induced by oxygen ion accumulation on nitrogen-doped resistive random access memory. Appl. Phys. Lett. 2014, 105. [Google Scholar] [CrossRef]
- Vanheusden, K.; Warren, W.L.; Seager, C.H.; Tallant, D.R.; Voigt, J.A.; Gnade, B.E. Mechanisms behind green photoluminescence in ZnO phosphor powders. J. Appl. Phys. 1996, 79, 7983–7990. [Google Scholar] [CrossRef]
- Celano, U.; Goux, L.; Degraeve, R.; Fantini, A.; Richard, O.; Bender, H.; Jurczak, M.; Vandervorst, W. Imageing the three-dimensional conductive channel in filamentary-based oxide resistive switching memory. Nano Lett. 2015, 15. [Google Scholar] [CrossRef] [PubMed]
- Xie, H.W.; Liu, Q.; Li, Y.T.; Lv, H.B.; Wang, M.; Liu, X.Y.; Sun, H.T.; Yang, X.Y.; Long, S.B.; Liu, S.; et al. Nitrogen-induced improvement of resistive switching uniformity in a HfO2-based RRAM device. Semicond. Sci. Technol. 2012, 27. [Google Scholar] [CrossRef]
- Allen, M.W.; Durbin, S.M. Influence of oxygen vacancies on Schottky contacts to ZnO. Appl. Phys. Lett. 2008, 92. [Google Scholar] [CrossRef]
© 2016 by the authors; licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons by Attribution (CC-BY) license (http://creativecommons.org/licenses/by/4.0/).
Share and Cite
Lai, Y.; Qiu, W.; Zeng, Z.; Cheng, S.; Yu, J.; Zheng, Q. Resistive Switching of Plasma–Treated Zinc Oxide Nanowires for Resistive Random Access Memory. Nanomaterials 2016, 6, 16. https://doi.org/10.3390/nano6010016
Lai Y, Qiu W, Zeng Z, Cheng S, Yu J, Zheng Q. Resistive Switching of Plasma–Treated Zinc Oxide Nanowires for Resistive Random Access Memory. Nanomaterials. 2016; 6(1):16. https://doi.org/10.3390/nano6010016
Chicago/Turabian StyleLai, Yunfeng, Wenbiao Qiu, Zecun Zeng, Shuying Cheng, Jinling Yu, and Qiao Zheng. 2016. "Resistive Switching of Plasma–Treated Zinc Oxide Nanowires for Resistive Random Access Memory" Nanomaterials 6, no. 1: 16. https://doi.org/10.3390/nano6010016




