First Principles Study on Electronic Structure and Optical Properties of Ternary GaAs:Bi Alloy
Abstract
:1. Introduction
2. Simulation Method and Theoretical Description
2.1. Simulation Method and Model
2.2. Theoretical Description of Optical Properties
3. Results and Discussion
3.1. Electronic Structure
| Name | The value | |||||
|---|---|---|---|---|---|---|
| X | 0 | 2.1% | 2.5% | 3.1% | 6.3% | 12.5% |
| Eg | 1.419 | 1.390 | 1.385 | 1.362 | 1.342 | 1.208 |


3.2. Optical Properties
3.2.1. Complex Dielectric Function

| Name | The value | |||||
|---|---|---|---|---|---|---|
| X | 0 | 2.1% | 2.5% | 3.1% | 6.3% | 12.5% |
| ε0 | 7.63 | 6.15 | 6.50 | 7.90 | 10.47 | 12.51 |
3.2.2. Absorption Spectra
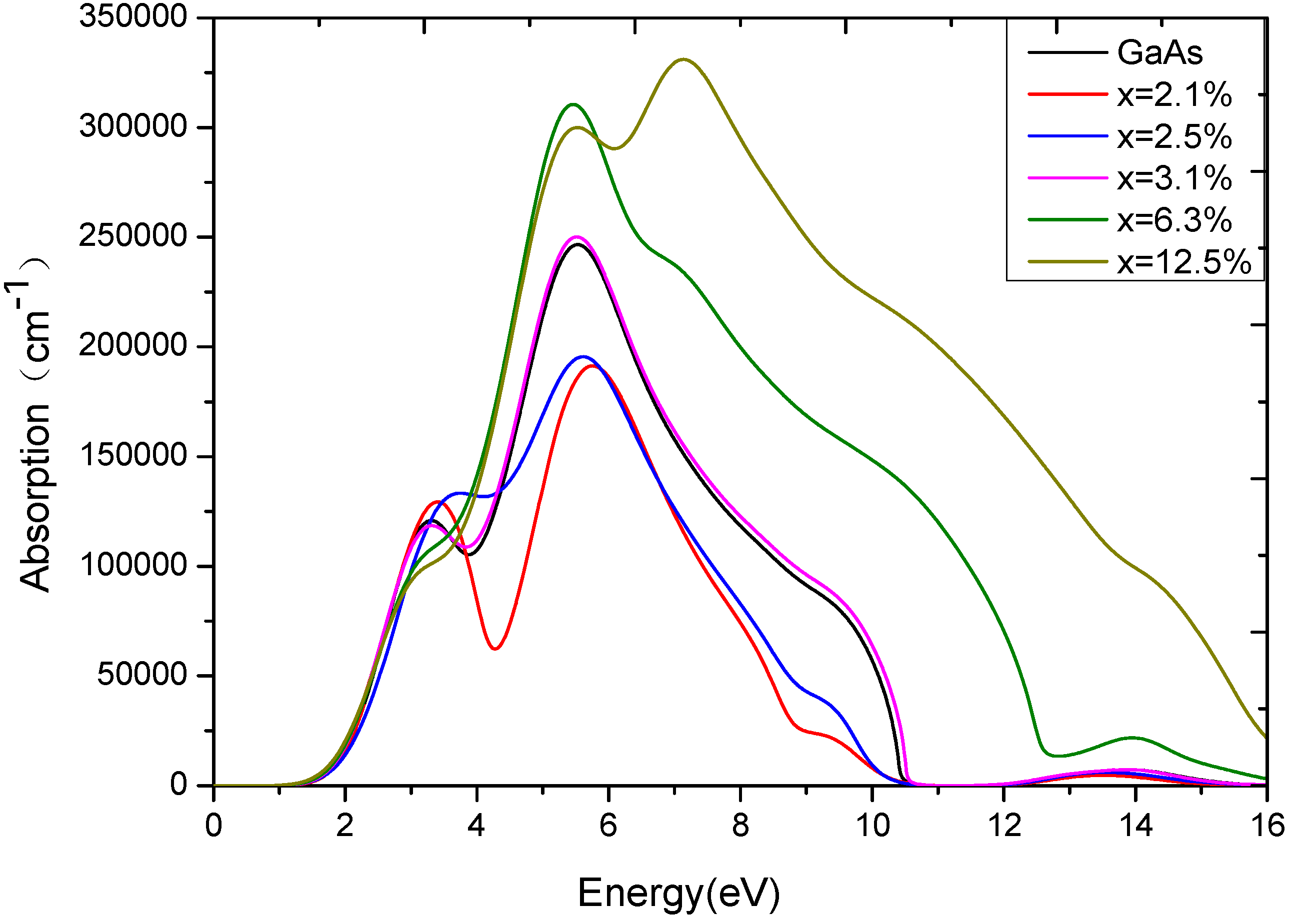
3.2.3. Complex Refractive Index
| Name | The value | |||||
|---|---|---|---|---|---|---|
| X | 0 | 2.1% | 2.5% | 3.1% | 6.3% | 12.5% |
| n(0) | 2.76 | 2.48 | 2.55 | 2.81 | 3.24 | 3.54 |

3.2.4. Optical Conductivity

4. Conclusions
Acknowledgments
References
- Zhang, Z.; Qian, L.; Fan, D.; Deng, X. Gallium arsenide: A new material to accomplish passively modelocked Nd:YAG laser. Appl. Phys. Lett. 1992, 60, 419–421. [Google Scholar] [CrossRef]
- Kajava, T.T.; Gaeta, A.L. Q-switching of a diode-pumped Nd:YAG laser with GaAs. Opt. Lett. 1996, 21, 1244–1246. [Google Scholar] [CrossRef] [PubMed]
- Gu, J.; Zhou, F.; Wan, K.T.; Lim, T.K.; Tam, S.C.; Lam, Y.L.; Xu, D.; Cheng, Z. Q-switching of a diodepumped Nd: YVO4 laser with GaAs nonlinear output coupler. Opt. Lasers Eng. 2001, 35, 299–307. [Google Scholar] [CrossRef]
- Gu, J.; Zhou, F.; Xie, W.; Tam, S.C.; Lam, Y.L. Passive Q-switching of a diode pumped Nd:YAG with GaAs output coupler. Opt. Commun. 1999, 165, 245–249. [Google Scholar] [CrossRef]
- Sharps, P.R.; Comfeld, A.; Stan, M. The future of high efficiency and multi-junction space solar cells. In Proceedings of the Photovoltaic Specialists Conference, 2008. PVSC 08 33rd IEEE, San Diego, CA, USA, 11–16 May 2008.
- Luque, A.; Marti, A.; Stanley, C. General equivalent circuit for intermediate band devices: Potentials, currents and electroluminescence. J. Appl. Phys . 2004, 96, 903–909. [Google Scholar] [CrossRef]
- Oe, K.; Okamato, H. New semiconductor alloy GaAs1−xBix grown by metal organic vapor phase epitaxy. J. Appl. Phys. Part 2 1998, 37, L1283–L1285. [Google Scholar] [CrossRef]
- Oe, K. Characteristics of semiconductor alloy GaAs1−xBix. J. Appl. Phys. Part 1 2002, 41, 2801–2806. [Google Scholar] [CrossRef]
- Francoeur, S.; Seong, M.-J.; Mascarenhas, A.; Tixier, S.; Adamcyk, M.; Tiedje, T. Band gap of GaAs1-xBix, 0 <x <3.6%. Appl. Phys. Lett. 2003, 82, 3874–3876. [Google Scholar] [CrossRef]
- Tixier, S.; Adamcyk, M.; Tiedje, T.; Francoeur, S.; Mascarenhas, A.; Wei, P.; Schiettekatte, F. Molecular beam epitaxy growth of GaAs1−xBix. Appl. Phys. Lett. 2003, 82, 2245–2247. [Google Scholar] [CrossRef]
- Young, E.C.; Whitwick, M.B.; Tiedje, T.; Beaton, D.A. Bismuth incorporation in GaAs1−xBix grown by molecular beam epitaxy with in-situ light scattering. Phys. Stat. Solidi C 2007, 4, 1707–1710. [Google Scholar] [CrossRef]
- Alberi, K.; Dubon, O.D.; Walukiewicz, W.; Yu, K.M.; Bertulis, K.; Krotkus, A. Valence band anticrossing in GaBixAs1−x. Appl. Phys. Lett. 2007, 91, 041903:1–041903:3. [Google Scholar] [CrossRef]
- Pettinari, G.; Polimeni, A.; Capizzi, M.; Blokland, J.H.; Christianen, P.C.M.; Maan, J.C.; Young, E.C.; Tiedje, T. Influence of bismuth incorporation on the valence and conduction band edges of GaAs1−xBix. Appl. Phys. Lett. 2008, 92, 262105:1–262105:3. [Google Scholar] [CrossRef]
- Francoeur, S.; Tixier, S.; Young, E.; Tiedje, T.; Mascarenhas, A. Bi isoelectronic impurities in GaAs. Phys. Rev. B 2008, 77, 085209:1–085209:5. [Google Scholar] [CrossRef]
- Fluegel, B.; Francoeur, S.; Mascarenhas, A.; Tixier, S.; Young, E.; Tiedje, C.T. Giant spin-orbit bowing in GaAs1−xBix. Phys. Rev. Lett. 2006, 97, 067205:1–067205:4. [Google Scholar] [CrossRef]
- Lu, X.F.; Beaton, D.A.; Lewis, R.B.; Tiedje, T.; Zhang, Y. Composition dependence of photoluminescence of GaAs1−xBix alloys. Appl. Phys. Lett. 2009, 95, 051909:1–051909:3. [Google Scholar]
- Janotti, A.; Wei, S.-H.; Zhang, S.B. Theoretical study of the effects of isovalent coalloying of Bi and N in GaAs. Phys. R eV. B. 2002, 65, 115203:1–115203:5. [Google Scholar]
- Zhang, Y.; Mascarenhas, Z.; Wang, L.-W. Similar and dissimilar aspects of III-V semiconductors containing Bi versus N. Phys. Rev. B 2005, 71, 155201:1–155201:4. [Google Scholar]
- Madouri, D.; Boukra, A.; Zaoui, A.; Ferhat, M. Bismuth alloying in GaAs: A first-principles study. Comput. Mater. Sci. 2008, 43, 818–822. [Google Scholar] [CrossRef]
- Segall, M.D.; Lindan, P.; Probet, M.J.; Pickard, C.J.; Hasnip, P.J.; Clark, S.J.; Payne, M.C. First-principles simulation: Ideas, illustrations and the CASTEP code. J. Phys. Condens Matter. 2002, 14, 2717:1–2717:3. [Google Scholar]
- Perdew, J.P.; Burke, K.; Ernzerhof, M. Generalized gradient approximation made simple. Phys. Rev. Lett. 1996, 77, 3865–3868. [Google Scholar] [CrossRef] [PubMed]
- Vanderbilt, D. Soft self-consistent pseudopotentials in a generalized eigenvalue formalism. Phys. Rev. B. 1990, 41, 7892–7895. [Google Scholar] [CrossRef]
- Yao, Q.; Xing, H.; Meng, L. Theoretical calculation of elastic, properties of TiB2 and TiB. Chin. J. Nonferr. Metals 2007, 17, 1297–1301. [Google Scholar]
- Fischer, T.H.; Almlof, J. General methods for geometry and wave-function optimization. J. Phys. Chem. 1992, 96, 9768–9774. [Google Scholar] [CrossRef]
- Li, J.B.; Wei, S.H.; Li, S.S.; Xia, J.B. Design of shallow acceptors in ZnO: First-principles band-structure calculations. Phys. Rev. B 2006, 74, 081201:1–081201:4. [Google Scholar]
- Kurt, A.; Ashcroft, N.W. Corrections to density-functional theory band gaps. Phys. Rev. B 1998, 58, 15548–15556. [Google Scholar] [CrossRef]
- Sheng, X.C. Spectrum and Optical Property of Semiconductor, 3rd ed.; Science Press: Beijing, China, 1992; pp. 76–94. [Google Scholar]
- Li, D.C.; Yang, M.; Zhao, S.Z.; Cai, Y.Q.; Feng, Y.P. First principles study of Bismuth alloying effects in GaAs saturable absorber. Opt. Express. 2012, 20, 11574–11580. [Google Scholar] [CrossRef] [PubMed]
- Mbarki, M.; Rebey, A. First-principles calculation of the physical properties of GaAs1−xBix alloys. Semicond. Sci. Technol. 2011, 26, 105020:1–105020:5. [Google Scholar]
- Usman, M.; Broderick, C.A.; Lindsay, A.; O’Reilly, E.P. Tight-binding analysis of the electronic structure of dilute bismide alloys of GaP and GaAs. Phys. Rev. B. 2011, 84, 245202:1–245202:13. [Google Scholar]
- Aspnes, D.E.; Studna, A.A. Dielectric functions and optical parameters of Si, Ge, GaP, GaAs, GaSb, InP, InAs, and InSb from 1.5 to 6.0 eV. Phys. Rev. B. 1983, 27, 985–1009. [Google Scholar] [CrossRef]
- Mo, S.D.; Ouyang, L.Z.; Ching, W.Y. Interesting Physical properties of the new spinel phase of Si3N4 and C3N4. Phys. Rev. Lett. 1999, 83, 5046–5049. [Google Scholar] [CrossRef]
- Yu, J.Z. Semiconductor Technology, 3rd ed.; Chemical Industry Press: Beijing, China, 2003; pp. 30–32. [Google Scholar]
© 2012 by the authors; licensee MDPI, Basel, Switzerland. This article is an open access article distributed under the terms and conditions of the Creative Commons Attribution license (http://creativecommons.org/licenses/by/3.0/).
Share and Cite
Yu, L.; Li, D.; Zhao, S.; Li, G.; Yang, K. First Principles Study on Electronic Structure and Optical Properties of Ternary GaAs:Bi Alloy. Materials 2012, 5, 2486-2497. https://doi.org/10.3390/ma5122486
Yu L, Li D, Zhao S, Li G, Yang K. First Principles Study on Electronic Structure and Optical Properties of Ternary GaAs:Bi Alloy. Materials. 2012; 5(12):2486-2497. https://doi.org/10.3390/ma5122486
Chicago/Turabian StyleYu, Lifei, Dechun Li, Shengzhi Zhao, Guiqiu Li, and Kejian Yang. 2012. "First Principles Study on Electronic Structure and Optical Properties of Ternary GaAs:Bi Alloy" Materials 5, no. 12: 2486-2497. https://doi.org/10.3390/ma5122486




